多点实时光刻机光源照度均匀度检测系统设计  下载: 1149次
下载: 1149次
1 引言
当前电子行业正在向高精细度、高集成度方向飞速发展[1]。大型集成电路、印刷电路板、液晶面板等是电子产品的核心部分。在它们的制作过程中,光刻机都是不可缺少的重要设备[2]。光刻工艺是一个进行信息传递的过程[3],光源透过掩模板将其上的图形成像到涂覆于硅片表面的光刻胶上,然后通过显影、刻蚀等工艺将图形转移到硅片上[4]。硅片上入射的紫外光与光刻胶发生化学反应,经过显影液的清洗,将发生反应的光刻胶去除,即可在硅片上得到预期的线条图案,完成投影曝光[5]。光刻机的照度均匀度越高,得到的线条图案越好。因此,对光刻机来说,照度均匀度是一个非常重要的指标[6]。
传统的照度均匀性工业检测方法是,利用单一探头光功率计,在照面内采用五点测量法或九点测量法分区域逐块测量对应点的光强大小,计算得到光刻机照面的照度均匀度。这种方法比较耗费时间,而且无法进行实时检测。采用此方法时,光学系统的每一个部分调整后都需要重新测量照度均匀度,安装效率低下。另外,由于LED的发光强度会受到实时温度的影响,非实时的均匀度测量方法会带来检测误差,这就需要一种能够对光刻机照度均匀度进行快速、实时、精确检测的方法,以大大提高光刻机光学系统的装调效率,缩短光刻机的生产周期。军械工程学院提出了一种利用线阵CCD测量照明光场均匀度[7]的方法,利用线阵CCD作为探测器,采用二次机械扫描进行光场均匀度的检测。该方法分两步进行,第一步是利用电机使CCD旋转进行圆周扫描;第二步是利用转台使CCD径向平移扫描。该测量方法使用两种电机进行轴向与镜像扫描,结构复杂且检测的实时性不强。文献[ 8]使用菲涅耳透镜将平行光会聚,利用光电探测器进行探测。在接收装置前放置一个步进平台,在步进平台上放置不同直径的圆柱体,步进平台从左至右移动,圆柱体在探测器前从左至右遮挡入射光。根据探测器探测到的光遮挡情况,计算得到光场均匀分布的情况。该方法需要选用不同直径的圆柱体进行照度均匀性测量,无法进行实时测量。长春光学精密机械与物理研究所采用面阵CCD对光学系统的像面照度进行检测[9]:将标定好的CCD置于光学系统像面,利用图像采集卡将CCD采集到的图像传输至计算机,对图像进行矫正之后,利用检测软件得到系统像面照度均匀度的检测结果。Kang等[10]对该方法进行了改进,增大了其动态探测范围。但以上方法仅限于小尺寸照面的均匀性测量,无法对大尺寸照面、工作距离短的光刻机光源系统的均匀性进行测量。蔡怀宇等[11]提出将GaAsP光电二极管制成线阵器件,利用步进电机进行扫描的方法测量照度均匀度。该方法需要利用步进电机,结构相对复杂,且检测的实时性不高。综上,目前尚没有一种结构简单的能够对光刻机照度均匀度进行实时快速检测的方法或系统,且近期对光刻机照度均匀度的研究也较少。基于此,本文提出了一种多点同时检测光刻机光源照度均匀度的检测方法,并研制出一种光刻机光源照度均匀度多点实时检测系统,所提检测方法简化了检测步骤,提高了检测效率,有效地解决工业光刻机光源照度均匀度检测耗时长的问题。
2 系统检测方法
2.1 系统组成
光刻机光源照度均匀度检测系统构成如
2.2 探测器单元的标定
由于每一个光电二极管的响应度、暗电流、响应时间和线性度参数不一致[15],每一路信号放大模块的电路参数之间的偏差会给测量结果带来误差,因此,在对光刻机光源系统的照度均匀度进行检测之前,需要对每一路探测器单元进行标定。标定的具体步骤:
1) 将标准光功率计的探测器置于光刻机光源照面中心,探测距离满足光刻机光源系统的工作距离。调整光刻机光强的大小,使标准光功率计测到的光刻机光功率值为PIN光电二极管线性工作区的最小光功率值。
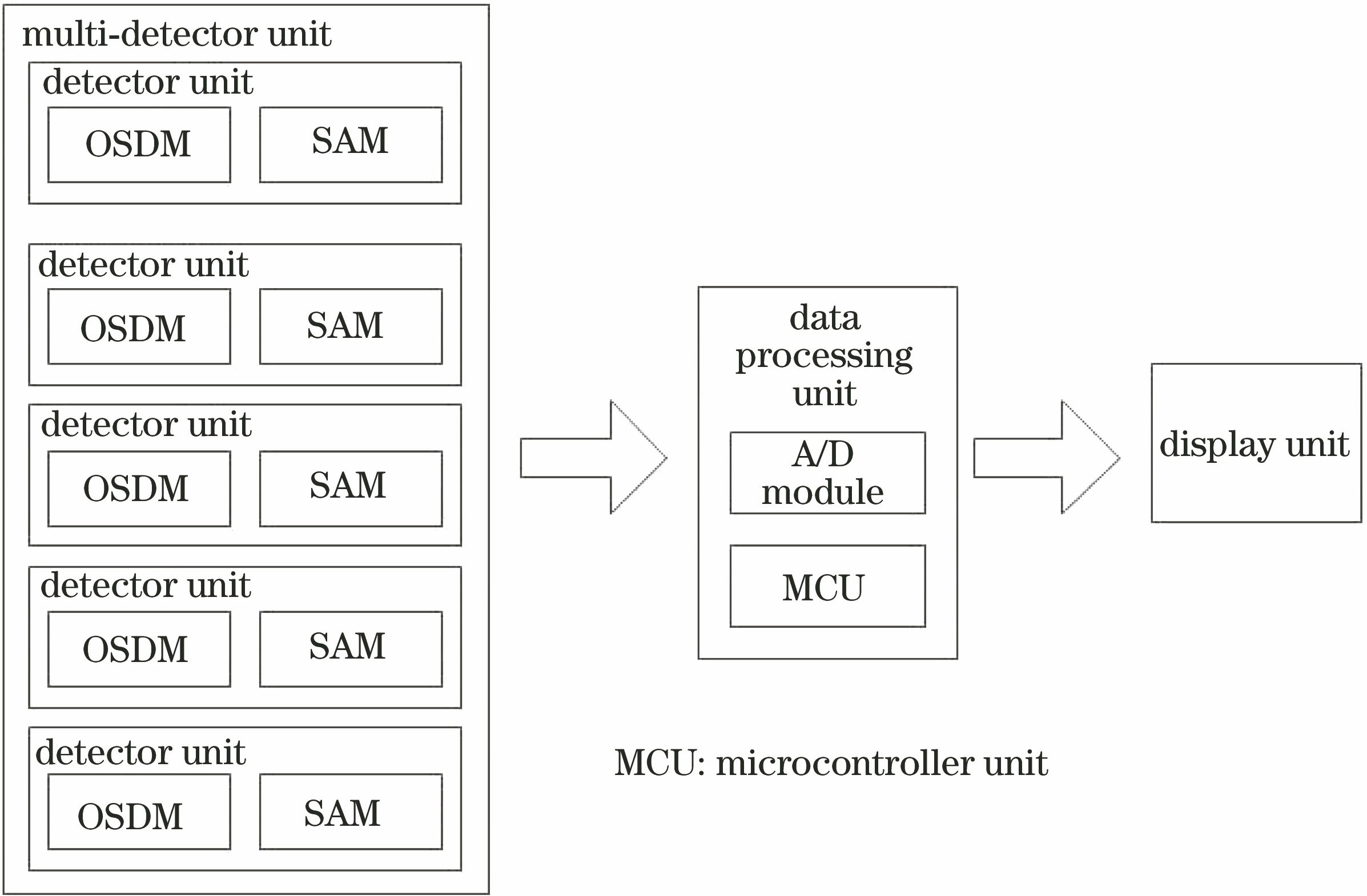
图 1. 照度均匀性检测系统组成示意图
Fig. 1. System structure of the illuminance uniformity detection equipment
2) 移除标准光功率计,将照度均匀度检测系统的探测单元放置在光刻机照面中心,同时探测距离与1)中的工作距离相同。记录此时探测单元的电压值。
3) 重复步骤1)、2),每重复一次,将光刻机光功率值增加0.5 mW/cm2,记录探测单元的电压值,直至光刻机光功率值增至PIN光电二极管线性工作区的最大光功率值。得到探测器单元的光电特性曲线方程。
4) 将每一路探测单元按照1)~3)的方法进行标定,得到每一路探测器单元的光电特性曲线方程。
2.3 测量修正方法
在光电探测器的线性区,探测器单元的光电特性曲线方程满足线性方程:
式中:
由于探测器与电子器件的偏差,每一路探测器单元会具有不同的增益和零点,导致每一路探测器单元的测量结果不一致。为保证每一路探测器单元测量的一致性,通过修正算法[16]可以使它们的增益和零点修正到一致。修正时,以第一路探测器单元作为标准,根据标定的数据,设第一路探测器单元测得的三个光强度
2.4 照度均匀性测试
将标定后的探测器单元依次放置在光刻机照面的指定位置,如
利用多路探测器单元的电压-光强修正结果,根据(2)式计算照度均匀度:
式中:
式中:
由(3)式可以知道,探测器单元检测结果经过修正后,仅根据探测器单元的输出电压与标准探测器单元的增益与零点,即可得到光刻机光源系统照面不均匀度。
3 检测结果与讨论
利用该检测系统对光源进行照面均匀度检测实验。实验采用波长为365 nm、照面尺寸为5 inch×5 inch(1 inch=2.54 cm)的光刻机照明系统作为探测光源。实验前,利用探测尺寸为10 mm×10 mm的工业用标准光功率计,采用传统逐点照度均匀性检测方法对照度均匀度进行检测,检测结果为96.7%。为与测得的照度均匀度进行对比,检测系统光信号探测模块选用探测尺寸为10 mm×10 mm的紫外增强型PIN光电二极管对光源进行照面均匀度检测。检测实验如
检测前,按照第二部分标定方法对检测系统探测器单元进行光电特性标定,标定结果见

图 6. 探测器单元的光电特性标定曲线
Fig. 6. Photoelectric characteristic calibration curve of detector unit

图 7. 修正后的探测器单元的光电特性标定曲线
Fig. 7. Calibration curves of photoelectric characteristic of the detector unit after correction
为保证测量一致性,利用第2节所述的修正算法修正探测器单元的增益,使之和零点一致。
探测器单元重复性影响了检测系统对照度均匀度检测的重复性。为验证其检测重复性,在光刻机中心照面光功率分别在9.6,12.5,15.5 mW/cm2下,对每一路探测器单元每隔30 s测量一次输出电压值,测量5组,结果如
表 1. 中心照面光功率为9.6 mW/cm2的探测器单元输出电压的重复性
Table 1. Repeatability of output voltage of detector units with the luminous power of 9.6 mW/cm2
| |||||||||||||||||||||||||||||||||||||||||
对检测系统进行准确度实验,每隔30 s检测一次照度均匀度,测量5组。实验结果如
表 2. 中心照面光功率为12.5 mW/cm2的探测器单元输出电压的重复性
Table 2. Repeatability of output voltage of detector units with the luminous power of 12.5 mW/cm2
| |||||||||||||||||||||||||||||||||||||||||
表 3. 中心照面光功率为15.5 mW/cm2的探测器单元输出电压的重复性
Table 3. Repeatability of output voltage of detector units with the luminous power of 15.5 mW/cm2
| |||||||||||||||||||||||||||||||||||||||||
表 4. 检测系统的准确度
Table 4. Accuracy of the detection system
|
由结果可得,照度均匀度检测准确度小于0.2%。与传统方法检测结果96.7%相比,实际误差小于1%,符合工业检测要求。
4 结论
通过分析和实验检测,证明了所提方法可以实现对光刻机照度均匀度的高精度检测。通过采用多路检测方法达到了实时检测的目的。采用了修正算法对探测器单元进行了一致性修正,实现了对照面照度均匀度的定量测量。最终的检测结果表明,检测的照度均匀性符合要求。在波长为365 nm、照度均匀度为96.7%的光刻机光源系统下,检测绝对误差在1%以内,准确度小于0.2%。单点测量重复性控制在0.02 mW/cm2,系统测量一致性小于0.1 mW/cm2,可以用于工业生产中实现光刻机照度均匀度实时在线检测。
[1] 刘鹏飞, 杨波, 陆侃. 紫外曝光机均匀照明系统的设计与研究[J]. 光学仪器, 2012, 34(2): 31-36.
[2] 高轩. UV-LED曝光系统及曝光工艺研究[D]. 北京: 北京交通大学, 2016.
GaoX. The research of UV-LED lithography system and process[D]. Beijing: Beijing Jiaotong University, 2016.
[3] 许爽. 基于成像光强的光刻机像差原位检测理论与方法研究[D]. 武汉: 华中科技大学, 2016.
XuS. Theory and method for in-situ lens aberration measurement in optical lithographic tools based on image intensity[D]. Wuhan: Huazhong University of Science and Technology, 2016.
[4] 王军. 光刻工艺中聚酰亚胺层光阻减量和线宽均匀性研究[D]. 天津: 天津大学, 2012.
WangJ. Litho polyimide layer resist reduction and CD uniformity research[D]. Tianjin: Tianjin University, 2012.
[5] 赵阳. 深紫外光刻复杂照明光学系统设计[D]. 长春: 中国科学院长春光学精密机械与物理研究所, 2010.
ZhaoY. Design of complex illumination optical system for deep ultraviolet lithography[D]. Changchun: Changchun Institute of Optics, Fine Mechanics and Physics, Chinese Academy of Sciences,China, 2010.
[6] 闫建新, 范伟宏, 李立文, 等. 光刻机曝光均匀性在线检测方法[J]. 半导体检测与测试技术, 2012, 37(7): 577-581.
Yan J X, Fan W H, Li L W, et al. On-line monitoring methods for the exposure uniformity of the stepper[J]. Semiconductor Inspection & Testing Technologies, 2012, 37(7): 577-581.
[7] 孙玉杰, 汪岳峰. 利用线阵CCD测量照明光场均匀度[J]. 中国测试技术, 2003( 4): 26- 32.
Sun YJ, Wang YF. Measurement of uniformity of illumination field using linear array CCD[J]. China Measurement Technology, 2003( 4): 26- 32.
[8] 刘新刚, 李仰军, 高健. 激光平行光幕光能分布均匀性测量研究[J]. 光电技术应用, 2010, 25(5): 12-14.
[9] 沈湘衡, 杨亮, 贺庚贤, 等. 光电测量设备光学系统的像面照度均匀性检测[J]. 光学精密工程, 2008, 16(12): 2531-2536.
Shen X H, Yang L, He G X, et al. Measurement of image plane illumination non-uniformity of optical system in photoelectric equipment[J]. Optics and Precision Engineering, 2008, 16(12): 2531-2536.
[10] KangD, YangH, ShaD, et al. Measurement of image plane illumination uniformity of photoelectric imaging system[C]. International Symposium on Advanced Optical Manufacturing and Testing Technologies, 2014: 92822O.
[11] 蔡怀宇, 刘铁根, 傅维乔, 等. 一种照相机成像平面照度均匀度检测系统[J]. 光学技术, 2000, 26(5): 392-394.
Cai H Y, Liu T G, Fu W Q, et al. A system for examining the illumination uniformity of camera imaging planes[J]. Optical Technique, 2000, 26(5): 392-394.
[12] 张燕, 曾光宇, 洪志刚. 硅PIN光电二极管探测系统的研究[J]. 核电子学与探测技术, 2008, 20(2): 391-393.
Zhang Y, Zeng G Y, Hong Z G. Research of the silicon PIN diode detecting system[J]. Nuclear Electronics & Detection Technology, 2008, 20(2): 391-393.
[13] GraemeJ. Photodiode amplifiers and OP AMP solutions[M]. Beijing: Science Press, 2012.
GraemeJ. 光电二极管及其放大电路设计[M]. 北京: 科学出版社, 2012.
[15] 徐胜, 徐玉珍, 陈恩果, 等. 大功率LED伏安特性模型研究[J]. 光电子·激光, 2015, 26(11): 2076-2082.
Xu S, Xu Y Z, Chen E G, et al. Study on the new models of high power LED current-voltage characteristics[J]. Journal of Optoelectronics·Laser, 2015, 26(11): 2076-2082.
[16] 刘民, 杨亦强. 均匀性的瞬态测量[J]. 宇航计测技术, 2001, 21(6): 56-61.
Liu M, Yang Y Q. Instant measurement for physical parameter special distribution uniformity[J]. Journal of Astronautic Metrology and Measurement, 2001, 21(6): 56-61.
赵可为, 谭艾英, 尹韶云, 蔡文涛, 杨若夫, 陈建军, 佟首峰. 多点实时光刻机光源照度均匀度检测系统设计[J]. 激光与光电子学进展, 2018, 55(6): 061203. Kewei Zhao, Aiying Tan, Shaoyun Yin, Wentao Cai, Ruofu Yang, Jianjun Chen, Shoufeng Tong. Design of Multi-Point Real-Time Lithography Light Source Uniformity Detection System[J]. Laser & Optoelectronics Progress, 2018, 55(6): 061203.










