半导体所在高质量InAs(Sb)/GaSb核壳异质结垂直纳米线阵列外延生长研究方面取得重要进展
准一维半导体纳米线凭借其优越、独特的电学、光学、力学等特性,在材料、信息与通讯、能源、生物与医学等重要领域展现出广阔的应用前景。尤其是,基于半导体纳米线的晶体管具有尺寸小、理论截止频率高等优点,为未来在微处理器芯片上实现超大规模集成电路开拓了新的方向。在III-V族半导体材料中,InAs具有小的电子有效质量、高的电子迁移率和较大的朗德g因子,是研制高性能场效应电子器件以及量子器件的理想材料;而GaSb具有最高的空穴迁移率,是研制高速p型半导体场效应晶体管的理想材料。此外,InAs、GaSb都有较窄的带隙,且两种材料之间具有II类能带结构和极小的晶格失配度(~0.6%),将这两种半导体材料相结合有可能制备出高质量的核壳异质结纳米线,为许多新型高性能纳米线器件的制备(如:亚阈值摆幅低于CMOS理论极限的低功耗隧穿场效应晶体管)和量子物理的研究提供平台。特别是,为实现与当代CMOS工艺相兼容,及真正实现纳米线器件的集成化,基于Si基的高质量InAs/GaSb核壳异质结纳米线阵列的可控生长将具有更重要的现实意义。

图1. (a) InAs、(b) InAs/GaSb核壳异质结纳米线阵列SEM形貌图和(c)直径统计。

图2. 不同Sb组分对InAs(Sb)纳米线晶格质量的影响。
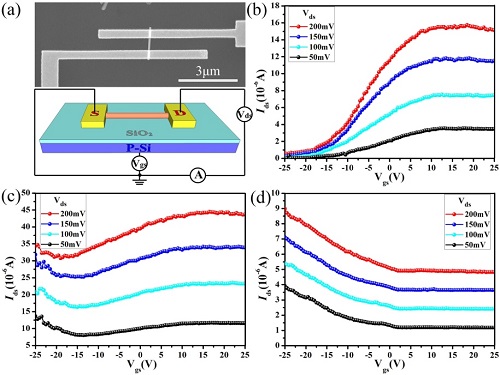
图3. (a) 单根纳米线背栅场效应晶体管示意图;(b-d) InAsSb核和GaSb壳厚分别为~6nm和~13nm的核壳异质结纳米线FET的转移特性曲线。
最近,半导体研究所材料科学重点实验室杨涛研究员课题组的季祥海博士研究生等利用MOCVD技术首次在图形化的Si衬底上外延制备出高成线率、高质量的InAs(Sb)/GaSb核壳异质结纳米线阵列(图1)。通常,沿着<111>方向自催化生长的InAs纳米线含有大量的层错缺陷(因为闪锌矿和纤锌矿的晶格结构在<111>方向上的生长能极其接近),尤其是对于核壳结构生长,这些缺陷将进一步延伸到壳层中,这将大大降低材料的电学和光学性能。为了克服这一材料制备技术上的难点,他们深入详细地研究了锑(Sb)对InAs核纳米线外延生长的影响,并发现引入少量Sb可极大地改善InAs核纳米线的晶格质量,特别是当Sb组分达到9.4%时,纳米线将变为纯相的闪锌矿结构(图2),从而获得高质量的InAsSb/GaSb核壳异质结构纳米线阵列。进一步,电学测试表明InAsSb核和GaSb壳分别具有优异的n型和p型导电性能,并且可以通过GaSb壳层厚度和背部栅压的改变对纳米线的导电类型进行有效调控。图3给出基于不同GaSb壳层厚度的纳米线器件的转移特性曲线,测试结果表明InAsSb核为n型导电;而对于有6nm厚GaSb壳层的InAsSb/GaSb异质结纳米线,由于InAsSb核和GaSb壳层可分别提供电子和空穴的导电沟道,其转移特性曲线呈现出明显的双极性导电特性;对于有13nm GaSb壳的纳米线,由于GaSb层较厚,所加的背部栅压难以对InAsSb核内的电子密度进行有效的调控,其转移曲线仅表现出p型导电特性。
相关成果近期发表在美国化学学会主办的《Nano Letters》上。该研究成果为下一步基于InAs(Sb)/GaSb核壳异质结纳米线阵列的高性能器件的制备打下了重要基础。
该工作得到了国家科技部、国家自然科学基金委的经费支持。
文章链接: http://pubs.acs.org/doi/abs/10.1021/acs.nanolett.6b03429
来源:半导体研究所

