InAs/GaSb II类超晶格材料的Si离子注入研究
1 引言
将红外辐射探测出并将其转化为可测量信号就是红外探测技术。该技术具有隐蔽性好、不受光照条件限制、抗干扰能力强、可实现远距离和全天时工作的优点,在航天、**、科学、医疗以及日常生活等方面得到了广泛应用[1],其中核心的探测芯片就是红外焦平面阵列(FPAs)。
红外焦平面器件经历了三代的发展,当前具有大面阵、高分辨率、多波段、高集成、轻型化等特点[2],主要材料体系包括MCT、超晶格、InGaAs、量子阱等。其中,MCT和超晶格材料可覆盖2-20微米的较宽谱段,是中波、长波红外探测的优选材料[3]。
超晶格材料基于6.1 Å群家族的几种二元化合物(InAs、GaSb和AlSb),具有接近的晶格常数,晶格失配小,因此易于生长高质量的器件结构材料[4]。InAs/GaSb II类超晶格红外材料是一种量子结构材料,采用不同厚度的InAs和GaSb短周期交替生长而成,可以通过厚度的变化对能带结构实现精确调控,满足较高量子效率的同时利用能带剪裁实现低的暗电流[3,5]。
FPAs由于PN结的形成方式不同分为台面型和平面型两种结构。InAs/GaSb II类超晶格焦平面探测器主要是台面型结构,器件结构通过分子束外延(MBE)生长出来,其中PN结通过原位掺杂形成,再通过台面刻蚀形成探测器阵列[6]。
随着探测器水平的发展,FPAs像元尺寸越小,台面型结构由于刻蚀形成台面导致的占空比越低,同时台面尺寸越小,其表面漏电流将成为主导因素,影响探测性能。且超晶格材料并不完全是一种各向同性材料,由于材料能带结构的原因,超晶格横向扩散长度远远高于纵向扩散长度,因此如果通过离子注入实现横向PN结,将可以改善光生载流子的输运,在提高收集效率的同时,制作高密度的平面型阵列。此外,PN结掩埋在体内有望抑制台面结的表面漏电,减小器件钝化的困难[7]。
离子注入在形成掺杂和PN结的同时也会带来材料的损伤。针对GaSb、InAs等体材料的离子注入已经有了一些研究[4,8-10],但从文献调研看,对InAs/GaSb II类超晶格材料在离子注入和退火后特性的研究却鲜有报道。
对于超晶格材料,由于其内部有数千层复杂界面,厘清离子注入对超晶格材料结构的影响是研制平面型器件的基础。在本工作中,我们利用多种材料表征技术,研究了不同Si离子注入条件及退火对超晶格材料结构、光学性能以及电学性能的影响,并且通过与InAs和GaSb注入后材料性能的测试结果进行对比,分析了对材料性能的主要影响机理。
1 实验
由于在热力学平衡生长过程中,任何掺杂离子都倾向于取代材料中更高共价半径的原子[8],因此在材料生长过程中原位Si掺杂,在GaSb中会优先取代Sb原子形成P型,而在InAs中会优先取代In原子形成N型。但如果通过离子注入技术掺杂Si,在GaSb和InAs中导电类型均为N型[4,8,11-12]。这是由于离子注入为非平衡掺杂技术,GaSb中Ga空位的存在增强了注入Si在Ga位点上的占据。因此,注入的Si作为高效供体具有高掺杂激活,并导致GaSb材料的N型掺杂。且Si注入造成的损伤较小,所以我们选用Si离子注入弱P型InAs /GaSb II类超晶格来实现N型掺杂构造PN结。离子注入采用的样品是基于GaSb(0 0 1)衬底生长的60周期(2.55 nm InAs/ 2.1 nm GaSb)超晶格,未进行离子注入的样品标记为A。其余样品在离子注入机中,以
杂质注入后通常会占据材料晶格的间隙位置,为了研究超晶格材料中注入杂质的退火激活和修复损伤,将B、C、D分别切块取样,在氮气环境下300 °C 60 s退火,标记为E、F、G。
为了进行比对,同样的,我们将GaSb和InAs体材料切成小块,分别留下一块用以对照,其余样品在离子注入机中,以
使用布鲁克D8 X射线衍射仪进行HRXRD
2 结果与讨论
HRXRD测试结果如
其中
表 1. 超晶格样品离子注入和退火前后摇摆曲线的相关信息
Table 1. Information about rocking curves of superlattice samples before and after ion implantation and annealing
| ||||||||||||||||||||||||||||||||||||||||||||||||||
表 2. 不同超晶格样品的光致发光谱峰值位置,发光强度以及半高宽的值
Table 2. The peak position of the photoluminescence, luminescence intensity and fullwidthathalfmaximum of different superlattice samples
|
表 3. 不同能量Si注入及退火前后的超晶格薄膜电学特性
Table 3. Electrical properties of superlattice films before and after Si implantation and annealing at different energies
|
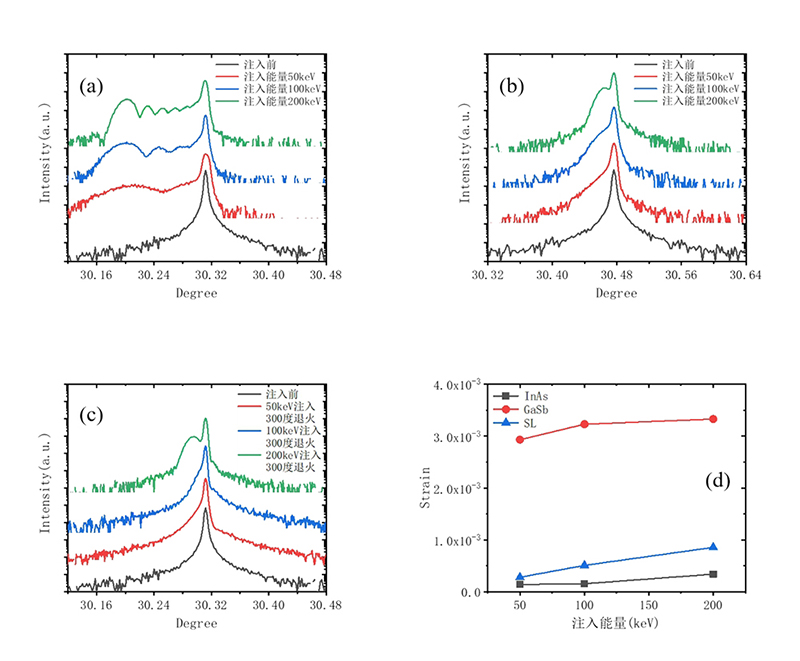
图 1. 不同能量Si注入InAs、GaSb及退火的HRXRD
Fig. 1. HRXRD
衍射摇摆曲线的半峰宽(FWHW)包含了材料的本征半峰宽以及材料应变和材料缺陷导致的展宽,双晶半峰宽越窄,被测材料的晶格完整性也就越好,如

图 2. 不同能量Si注入InAs/GaSb II类超晶格及退火后的HRXRD
Fig. 2. HRXRD
而退火后的结果如
我们还对比了Si注入GaSb和InAs以及超晶格产生的应变随注入能量变化的结果,如
式中
倒易空间二维点图可用来分析材料晶体的应变、晶面效应、晶向效应以及缺陷存在的状态。对于一个理想的体晶材料,其倒易空间二维图将呈现出圆形结构。如果外延超晶格材料完全应变,外延材料倒易点L与衬底材料倒易点S的连线将是平行于(0 0 1)方向;而如果材料完全弛豫,则连线将在[1 1 5]方向上。将(1 1 5)晶面附近的倒易空间区域单独拿出来讨论,可以通过倒易空间图中 L 和 S 的具体位置关系计算出外延材料的应变程度[6]
上式中,β 是 SL 与完全应变线的夹角,φ 是 OS 与(0 0 1)方向之间的夹角,
扫描超晶格(1 1 5)晶面的倒易空间二维点图的结果如

图 3. Si 离子注入前后以及退火后的超晶格的倒易空间二维点图:(a)超晶格材料Si注入前;(b)注入100keV Si的超晶格;(c)注入200keV Si的超晶格;(d)注入200keV Si退火后的超晶格
Fig. 3. Two-dimensional point map of reciprocal space of superlattices before and after Si ion implantation and annealing:(a)Before superlattice material Si injection;(b)Superlattice injected with 100keV Si;(c)Superlattice injected with 200keV Si;(d)Superlattice annealed after implantation of 200keV Si
如
通过PL测试可以判断材料的光学质量,

图 4. 测试温度77 k时,超晶格的光致发光谱:(a)不同能量Si注入以及退火前后的SL;(b)SL中200keV 的Si注入后以及退火后
Fig. 4. Photoluminescence spectra of superlattice and GaSb at 77k:(a)Superlattice with different energy Si implantation and annealing;(b)Superlattice after 200 keV silicon implantation and annealing
二次离子质谱(SIMS)实验能够得到注入杂质在超晶格材料内的分布情况,而SRIM是一种对离子注入进行蒙特卡罗模拟的软件,它可以估计离子的分布和注入后的目标损伤。如

图 5. Si注入超晶格的注入深度和电学特性:(a)注入能量为10keV的Si的超晶格的SIMS的两次测试结果,以及SRIM仿真结果;(b)注入能量与载流子浓度和迁移率的关系
Fig. 5. Depth and electrical properties of Si implanted superlattice:(a)Two SIMS test results and SRIM simulation results of Si superlattice with injected energy of 10 keV;(b)The relationship between injected energy and carrier concentration and mobility
注入的目的就是实现掺杂,霍尔测试能得到掺杂浓度和迁移率。样品超晶格外延层本身厚度较薄,注入能量为100keV及200keV的样品注入层已完全覆盖整个超晶格外延层,注入能量为50keV的样品注入层也超过了外延层厚度的一半,注入层和未注入层具有相反的导电性类型,且注入区有远高于初始材料的掺杂浓度,在霍尔测试中起主要贡献;此外,针对两层不同导电类型材料,界面处的p-n结耗尽区通常会对这两个区域形成电隔离[25],[26],因此可以对注入区的浓度和迁移率进行直接霍尔测量。实验结果显示,在10 K的测试温度下,注入前的超晶格材料为P型,载流子浓度为
3 结论
在室温下注入剂量为
[1] 郝晓剑, 李仰军刘吉, 赵辉,等. 光电探测技术与应用[M]. 国防工业出版社, 2009.
[2] ROGALSKI A. Recent progress in third generation infrared detectors[J]. Journal of Modern Optics, 2010, 57(18): 1716-30.
[3] ROGALSKI A. Infrared detectors: an overview[J]. Infrared Physics & Technology, 2002, 43(3-5): 187-210.
[4] PANDEY R K, MISHRA P, PANDEY A, et al. Effects of Si ion implantation on the surface and electrical characteristics of epitaxial GaSb[J]. Vacuum, 2022, 198(198): 198.
[5] ROGALSKI A, ANTOSZEWSKI J, FARAONE L. Third-generation infrared photodetector arrays[J]. Journal of Applied Physics, 2009, 105(9): 4-348.
[6] 周易. InAs/GaSb Ⅱ类超晶格红外探测器材料与器件研究[D]. 中国科学院研究生院, 2012.
[7] 李海燕, 杜红艳, 赵建忠. 锑化铟离子注入退火技术研究[J]. 激光与红外, 2013, 43(12): 4.
[8] PANDEY R K, MISHRA P, KAUSHIK J K, et al. Higher electrical activation of ion-implanted Si over S in GaSb epitaxial layers[J]. Materials Science in Semiconductor Processing, 2020, 115: 105107.
[9] PANDEYS D, DUBEYS K. Annealing behavior of cadmium ion implanted GaSb; proceedings of the American Institute of Physics, F, 2013 [C].
[10] PEARTON S J, VONNEIDA A R, BROWN J M, et al. Ion-Implantation Damage and Annealing in Inas, Gasb, and Gap[J]. Journal of Applied Physics, 1988, 64(2): 629-36.
[11] PANDEY R K, MISHRA P, PANDEY A, et al. Silicon-ion implantation induced doping and nanoporosity in molecular beam epitaxy grown GaSb epitaxial films[J]. J Vac Sci Technol A, 2021, 39(4): 39.
[12] DECOSTER S, VANTOMME A. Implantation-induced damage in Ge: strain and disorder profiles during defect accumulation and recovery[J]. J Phys D Appl Phys, 2009, 42(16): 165404.
[13] BAUSELLS J, BADENES G, LORATAMAYO E. Calculation of Channeling Effects in Ion-Implantation[J]. Nucl Instrum Meth B, 1991, 55(1-4): 666-70.
[14] KATSIKINI M, PINAKIDOU F, PALOURA E C, et al. Modification of the N bonding environment in GaN after high-dose Si implantation: An x-ray absorption study[J]. Journal of Applied Physics, 2007, 101(8): 35202-10.
[15] 李超. GaN基异质结材料应变分析及电学特性研究[D]. 电子科技大学, 2009.
[16] TOULEMONDE M, DUFOUR C, PAUMIER E. Transient thermal process after a high-energy heavy-ion irradiation of amorphous metals and semiconductors[J]. Phys Rev B Condens Matter, 1992, 46(22): 14362-9.
[17] PAINE B M, HURVITZ N N, SPERIOSU V S. Strain in GaAs by low‐dose ion implantation[J]. Journal of Applied Physics, 1987, 61(4): 1335-9.
[18] ZHAO Y, TENG Y, MIAO J-J, et al. Mid-Infrared InAs/GaSb Superlattice Planar Photodiodes Fabricated by Metal–Organic Chemical Vapor Deposition*[J]. Chinese Physics Letters, 2020, 37(6): 4.
[19] QADRI S B, YOUSUF M, KENDZIORA C A, et al. Structural modifications of silicon-implanted GaAs induced by the athermal annealing technique[J]. Applied Physics A, 2004, 79(8): 1971-7.
[20] PAULINGL, PAULINGP. Chemistry [M]. WH Freeman San Francisco, 1975.
[21] HUHEEY J E, KEITER E A, KEITER R L. Inorganic Chemistry: Principles of Structure and Reactivity[J], 1993.
[22] WANG S Q, YE H Q. First-principles study on elastic properties and phase stability of III–V compounds[J]. physica status solidi (b), 2003, 240(1): 45-54.
[23] ROBINS L H, BERTNESS K A, BARKER J M, et al. Optical and structural study of GaN nanowires grown by catalyst-free molecular beam epitaxy. II. Sub-band-gap luminescence and electron irradiation effects[J]. Journal of Applied Physics, 2007, 101(11): 113505.
[24] 陈熙仁. 红外调制光谱研究Ⅲ-Ⅴ族窄禁带锑化物与稀铋半导体电子能带结构[D]. 中国科学院研究生院(上海技术物理研究所).
[25] MayerJ. W., ErikssonL., and DaviesJ. A., Ion Implantation in Semiconductors. New York: Academic Press, 1970, pp. 186-193.
[26] Larrabee R.D, Thurber, et al. Theory and application of a two-layer Hall technique[J]. Electron Devices, 1980, 27(1): 32-36.
何苗, 周易, 应翔霄, 梁钊铭, 黄敏, 王志芳, 朱艺红, 廖科才, 王楠, 陈建新. InAs/GaSb II类超晶格材料的Si离子注入研究[J]. 红外与毫米波学报, 2024, 43(1): 15. Miao He, Yi Zhou, Xiang-Xiao Ying, Zhao-Min Liang, Min Huang, Zhi-Fang Wang, Yi-Hong Zhu, Ke-Cai Liao, Nan Wang, Jian-Xin Chen. Si Ion Implantation Study of InAs/GaSb Type II superlattice Materials[J]. Journal of Infrared and Millimeter Waves, 2024, 43(1): 15.


