阴离子改性抛光剂对磷酸盐激光钕玻璃抛光的影响  下载: 889次
下载: 889次
1 引言
磷酸盐钕玻璃是惯性约束核聚变系统中不可缺少的增益介质[1],常用于高功率和大能量激光装置,需要非常高的表面质量和良好的面形精度来减小激光器的能量损耗[2-3],方均根粗糙度一般要求在0.5~1.5 nm以内。但磷酸盐钕玻璃化学稳定性较差,易腐蚀,比普通玻璃如石英玻璃、K9玻璃加工难度大[4-5],适用于普通光学玻璃加工的抛光液并不一定适用于钕玻璃的加工。
应用于光学玻璃元件抛光的比较成熟的方法有很多,其中最常用的方法有化学机械抛光、浴法抛光、离子束抛光、计算机控制小磨头抛光等[6-9]。而化学机械抛光技术是现在最主要的可以提供全局平面化的表面精加工技术。影响抛光效果的因素很多,其中一个重要因素是磨料的粒径与抛光液的成分。抛光磨料的粒径直接影响玻璃的抛光速率和表面质量。由于氧化铈(CeO2)抛光液具有高选择性和抛光过程可自动停止的特性,是钕玻璃抛光中最常使用的抛光液。氧化铈粒径大多在纳米量级,很容易产生团聚,从而对被加工的钕玻璃表面产生划痕,影响表面质量[10]。
目前,很多研究在抛光液中添加表面活性剂,但是已有的改性抛光液并不适合于钕玻璃的抛光,比如阴离子活性剂梅迪兰、N-月桂酰基氨基酸钠[11],溶于水时呈碱性,用于钕玻璃抛光时,会损伤沥青抛光盘表面,这是因为沥青抛光盘是由抛光胶浇注而成,抛光胶的主要成分是沥青和松香,松香在碱性环境容易发生皂化或酸碱中和反应[12-13];而且研究表明,抛光液的pH大于9时,会使沥青胶盘老化,光泽变暗,从而影响钕玻璃抛光的效率[14]。为了在抑制氧化铈的纳米团聚,提高钕玻璃的抛光效率的同时不损伤抛光盘表面,本课题组找到了一种合适的阴离子表面活性剂——雷米邦A来抑制氧化铈颗粒的纳米团聚,同时通过调节抛光液的pH值来提高钕玻璃的抛光效率。雷米邦A的化学成分为酸酰胺基酸钠,它的羧基能与氧化铈颗粒表面的羟基发生酯化反应,将分子长链通过化学键合接枝到纳米氧化铈颗粒表面,从而改变氧化铈的表面性质,使其由亲水性变为疏水性,并抑制纳米团聚。本文研究了雷米邦A质量分数对氧化铈抛光液中粒子粒径、分散性,以及钕玻璃抛光效果的影响,并分析了不同pH值下改性抛光液的性能。
2 实验条件与过程
2.1 抛光液的制备
配制8份质量分数为3 %的纯氧化铈悬浮液,分散剂为去离子水。然后添加质量分数分别为0.05%、0.10%、0.15%、0.20%、0.25%、0.30%、0.35%的雷米邦A(雷米邦A从麦卡希化工有限公司采购,纯度为98%),并用盐酸和氢氧化钠调节悬浮液的pH值。将混合液超声分散30 min,取出后置于超声波清洗机中超声分散10 min,在一定温度下加热搅拌一段时间后取出,冷却后再调节抛光液pH值至7。
2.2 化学机械抛光实验
利用已经配置好的不同雷米邦A质量分数的抛光液、不同 pH值的抛光液抛光直径为80 mm、厚度为8 mm的钕玻璃,钕玻璃统一用W14金刚砂研磨足够厚度,在显微镜下观察,确保每块钕玻璃表面粗糙度和形貌相同。采用最大输出压强1 MPa,最高主轴转速100 r/min,最高摆架转速60 r/min的型号为YP035.2的双轴研磨抛光机,对直径为108 mm的沥青抛光垫进行化学机械抛光实验。抛光时抛光机工作压强为0.1 MPa,主轴转速为70 r/min,摆架转速为30 r/min,控制抛光液的滴加速度不变,抛光液使用量为2 mL/min,抛光时间为4 h,温度为(20±0.5) ℃,空气湿度为50%~60%。
2.3 性能表征
采用Bettersize 2000型激光粒度仪表征抛光液中粒子的粒径分布。采用千分尺测量抛光前、后钕玻璃的厚度,厚度差除以抛光时间得到材料去除率,用材料去除率来表征抛光速率。采用ZYGO粗糙度检测仪检测抛光后钕玻璃的表面形貌和表面粗糙度,扫描区域尺寸为10 μm×10 μm。
3 结果与讨论
3.1 不同质量分数雷米邦A对氧化铈粒子粒径的影响
磨料粒径是抛光过程中一个很重要的影响因素,对于粒径小且粒度分布范围窄的抛光液,其颗粒比表面积大,比表面活性高,实际参与抛光的有效粒子数多,因而具有很高的抛光速率。但纳米量级的抛光粉极易发生团聚,纳米颗粒在水中受到静电引力、范德瓦耳斯力、颗粒毛细管力等的作用,还会引发二次团聚形成更大的颗粒[15],导致粒度分布范围变宽,分散性变差,将严重影响抛光后玻璃的表面质量。
雷米邦A作为改性剂成功地包覆在纳米氧化铈颗粒表面,且与粒子表面发生化学反应而牢固键合,得到表面亲油性粒子。改性效果与改性剂雷米邦A的质量分数有关,雷米邦A的质量分数越大,纳米氧化铈颗粒表面包覆的雷米邦A越多,粒子的亲油性越强,甚至漂浮在水面上。另外,雷米邦A能吸附在氧化铈颗粒表面,使颗粒表面带负电,在静电排斥力的作用下,进一步阻止相邻粒子团聚。
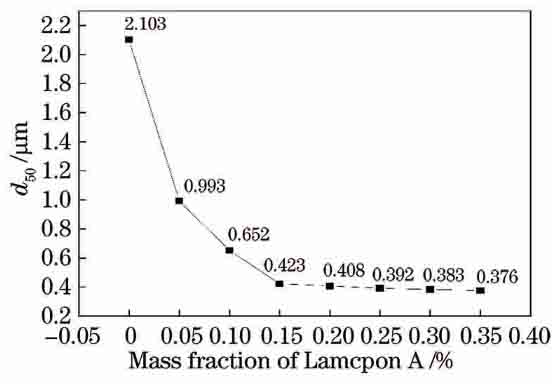
图 1. 抛光液中磨料粒子的中位粒径分布
Fig. 1. Median particle diameter d50 of ceria abrasives in polishing slurry
由此可见,加入阴离子活性剂雷米邦A能够在一定程度上抑制抛光液中氧化铈纳米粒子的团聚,减小氧化铈纳米颗粒的表面能,使整个抛光悬浮液体系更稳定,从而改善抛光液的分散性,提高抛光液的质量。
3.2 不同质量分数雷米邦A对钕玻璃化学机械抛光的影响
用材料去除率表征钕玻璃的抛光速率,雷米邦A的质量分数对抛光速率的影响如

图 2. 雷米邦A质量分数对材料去除率的影响
Fig. 2. Effect of mass fraction of Lamepon A on material removal rate

图 3. 雷米邦A质量分数对钕玻璃表面粗糙度的影响
Fig. 3. Effect of mass fraction of Lamepon A on surface roughness of Nd-glass
由

图 4. 添加不同质量分数的雷米邦A时钕玻璃的抛光质量。(a) 0;(b) 0.20%;(c) 0.35%
Fig. 4. Polishing quality of Nd-glass with different mass fraction of Lamepon A. (a) 0; (b) 0.20%; (c) 0.35%
3.3 不同pH值雷米邦A对钕玻璃化学机械抛光效果的影响
为了进一步探究改性抛光液的最佳性能,基于雷米邦A质量分数为0.3%的抛光液,调节其pH值分别为6、6.5、7、7.5、8,对准备好的5组初始条件相同的钕玻璃抛光4 h,材料去除率随pH值变化的关系如
雷米邦A质量分数为0.3%的抛光液的分散性较好。改变其pH值进行实验研究可以看出,在抛光钕玻璃时,抛光液在中性和偏碱性条件下的抛光效果不如在偏酸性条件下的好。当抛光液的pH为6.5时,抛光速率最快能达到169 nm/min。钕玻璃抛光过程中发生的主要化学反应为钕玻璃表面水解反应。由于抛光液的溶剂为水,在抛光过程中形成H3O+(H+)离子,能够使钕玻璃表面的磷酸盐发生水解反应(P
基于雷米邦A质量分数为0.20%的抛光液,调节其pH值分别为6、6.5、7、7.5、8,对准备好的5组初始条件相同的钕玻璃抛光4 h,表面粗糙度随pH值变化的关系如
4 结论
阴离子表面活性剂雷米邦A可以减少氧化铈抛光液中纳米粒子的团聚,使粒子的中位粒径从2.103 μm减小到0.376 μm,显著提高了粒子的分散性。在合适的雷米邦A的质量分数下,合理地控制抛光液的pH值,可以提高钕玻璃的抛光效率,偏酸性的抛光液性能明显优于中性和碱性的抛光液,并且对沥青抛光盘的损伤很小。
当雷米邦A的质量分数为0.30%,抛光液的pH为6.5时,钕玻璃材料去除率最大,为169 nm/min;当雷米邦A的质量分数为0.20%,抛光液的pH为7时,钕玻璃粗糙度最小,为0.94 nm。本研究对于钕玻璃的化学机械抛光工艺具有指导意义。在钕玻璃抛光的前期,采用质量分数为0.30%的雷米邦A对氧化铈抛光液进行改性,控制抛光液pH为6.5,可以提高抛光速率;在抛光后期采用质量分数为0.20%的雷米邦A对氧化铈抛光液进行改性,并调节抛光液pH至7,可以降低钕玻璃表面粗糙度,获得较好的面型。
[1] Nichols MA. Summary of synthetic lap polishing experiments at LLNL[C]∥3rd American Precision Optical Manufacturer's Association Optical Fabrication Workshop, November 5-6, 2001, Rochester. [S. l.]: [s. n.], 2001: 1- 10.
[2] 汤文龙, 梁尚娟, 焦翔, 等. 抛光过程中光学元件表面划痕的形成和控制[J]. 中国激光, 2019, 46(12): 1202009.
[3] 赖璐文, 刘志刚, 焦翔, 等. 多杆机构复合摆动轨迹抛光方法对光学元件中频误差的抑制[J]. 中国激光, 2019, 46(11): 1102001.
[4] Rambo P, Schwarz J, Kimmel M, et al. Development of high damage threshold laser-machined apodizers and gain filters for laser applications[J]. High Power Laser Science and Engineering, 2016, 4: e32.
[5] 汪山, 程继健, 陈奇. 磷酸盐玻璃型阻垢剂的性能评估及溶解机理研究[J]. 无机材料学报, 2000, 15(6): 987-991.
[6] Peedikakkandy L, Kalita L, Kavle P, et al. Preparation of spherical ceria coated silica nanoparticle abrasives for CMP application[J]. Applied Surface Science, 2015, 357: 1306-1312.
[7] 张杨, 徐清兰, 陈梅, 等. 浴法抛光中抛光粉粒径对去除效果影响的试验研究[J]. 光学技术, 2014, 40(6): 486-491.
[8] Jones R A. Optimization of computer controlled polishing[J]. Applied Optics, 1977, 16(1): 218-224.
[9] SchindlerA, HänselT, FrostF, et al. Ion beam finishing technology for high precision optics production[C]∥Optical Fabrication and Testing, Tucson, Arizona. Washington, D.C.: OSA, 2002: 1- 3.
[10] Hedrick JB, Sinha S P. Cerium-based polishing compounds: discovery to manufacture[J]. Journal of Alloys and Compounds, 1994, 207/208: 377- 382.
[11] 梁尚娟, 汤文龙, 焦翔, 等. 改性抛光剂对光学玻璃抛光质量的影响[J]. 中国激光, 2017, 44(12): 1203001.
[12] DeGrooteJ, Jacobs SD, Gregg LL, et al. A data base for the physical properties of optical polishing pitch[C]∥Optical Fabrication and Testing, Tucson, Arizona. Washington, D.C.: OSA, 2002: 55- 59.
[13] Xie Y S, Bhushan B. Effects of particle size, polishing pad and contact pressure in free abrasive polishing[J]. Wear, 1996, 200(1/2): 281-295.
[14] 张宝安, 朱健强, 樊全堂. 磷酸盐激光玻璃的化学机械抛光[J]. 中国激光, 2007, 34(8): 1151-1154.
[15] Asghar K, Qasim M, Nelabhotla D M, et al. Effect of surfactant and electrolyte on surface modification of c-plane GaN substrate using chemical mechanical planarization (CMP) process[J]. Colloids and Surfaces A: Physicochemical and Engineering Aspects, 2016, 497: 133-145.
Article Outline
刘伯勋, 焦翔, 谭小红, 朱健强. 阴离子改性抛光剂对磷酸盐激光钕玻璃抛光的影响[J]. 中国激光, 2020, 47(10): 1003001. Liu Boxun, Jiao Xiang, Tan Xiaohong, Zhu Jianqiang. Effect of Anionic Modified Polishing Agent on Nd-Doped Phosphate Laser Glass Polishing[J]. Chinese Journal of Lasers, 2020, 47(10): 1003001.








