
Author Affiliations
Abstract
1 Department of Engineering “Enzo Ferrari”, University of Modena and Reggio Emilia, Modena 41125, Italy
2 Department of Information Engineering, University of Padova, Padova 35131, Italy
3 Department of Sciences and Methods for Engineering (DISMI), University of Modena and Reggio Emilia, Reggio Emilia 42122, Italy
4 EN & TECH Center, University of Modena and Reggio Emilia, Reggio Emilia 42122, Italy
5 Advanced Technologies and Micro Systems Department, Robert Bosch GmbH, Renningen 71272, Germany
Vertical GaN power MOSFET is a novel technology that offers great potential for power switching applications. Being still in an early development phase, vertical GaN devices are yet to be fully optimized and require careful studies to foster their development. In this work, we report on the physical insights into device performance improvements obtained during the development of vertical GaN-on-Si trench MOSFETs (TMOS’s) provided by TCAD simulations, enhancing the dependability of the adopted process optimization approaches. Specifically, two different TMOS devices are compared in terms of transfer-curve hysteresis (H) and subthreshold slope (SS), showing a ≈ 75% H reduction along with a ≈ 30% SS decrease. Simulations allow attributing the achieved improvements to a decrease in the border and interface traps, respectively. A sensitivity analysis is also carried out, allowing to quantify the additional trap density reduction required to minimize both figures of merit.
vertical GaN trench MOSFET SiO2 interface traps border traps hysteresis BTI Journal of Semiconductors
2024, 45(3): 032501
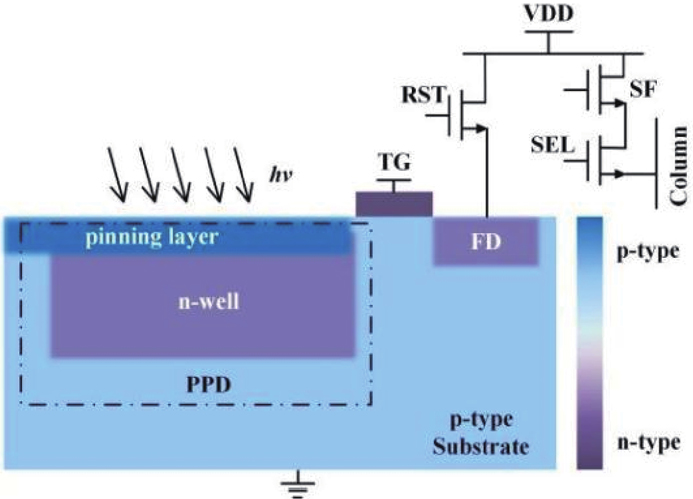
Author Affiliations
Abstract
1 School of Electronics and Information, Hangzhou Dianzi University, Hangzhou 310018, China
2 Tianjin Key Laboratory of Imaging and Sensing Microelectronic Technology, School of Microelectronics, Tianjin University, Tianjin 300072, China
3 Chongqing Optoelectronics Research Institute, Chongqing 400060, China
CMOS image sensors produced by the existing CMOS manufacturing process usually have difficulty achieving complete charge transfer owing to the introduction of potential barriers or Si/SiO2 interface state traps in the charge transfer path, which reduces the charge transfer efficiency and image quality. Until now, scholars have only considered mechanisms that limit charge transfer from the perspectives of potential barriers and spill back effect under high illumination condition. However, the existing models have thus far ignored the charge transfer limitation due to Si/SiO2 interface state traps in the transfer gate channel, particularly under low illumination. Therefore, this paper proposes, for the first time, an analytical model for quantifying the incomplete charge transfer caused by Si/SiO2 interface state traps in the transfer gate channel under low illumination. This model can predict the variation rules of the number of untransferred charges and charge transfer efficiency when the trap energy level follows Gaussian distribution, exponential distribution and measured distribution. The model was verified with technology computer-aided design simulations, and the results showed that the simulation results exhibit the consistency with the proposed model.
CMOS image sensor charge transfer interface state traps Journal of Semiconductors
2023, 44(11): 114104

Author Affiliations
Abstract
1 State Key Laboratory of Electronic Thin Films and Integrated Devices, University of Electronic Science and Technology of China, Chengdu 610054, China
2 School of Microelectronics, University of Science and Technology of China, Hefei 230026, China
A NiO/β-Ga2O3 heterojunction-gate field effect transistor (HJ-FET) is fabricated and its instability mechanisms are experimentally investigated under different gate stress voltage (VG,s) and stress times (ts). Two different degradation mechanisms of the devices under negative bias stress (NBS) are identified. At low VG,s for a short ts, NiO bulk traps trapping/de-trapping electrons are responsible for decrease/recovery of the leakage current, respectively. At higher VG,s or long ts, the device transfer characteristic curves and threshold voltage (VTH) are almost permanently negatively shifted. This is because the interface dipoles are almost permanently ionized and neutralize the ionized charges in the space charge region (SCR) across the heterojunction interface, resulting in a narrowing SCR. This provides an important theoretical guide to study the reliability of NiO/β-Ga2O3 heterojunction devices in power electronic applications.
NiO/β-Ga2O3 heterojunction FET NBS instability bulk traps interface dipoles Journal of Semiconductors
2023, 44(7): 072803

Author Affiliations
Abstract
1 Department of Physics, School of Natural Science, University of Petroleum and Energy Studies, Bidholi, Dehradun - 248007, India
2 Inter University Accelerator Centre, Aruna Asaf Ali Road, Vasantkunj, New Delhi - 110067, India
3 Solid State Physics Laboratory, DRDO, Timarpur, New Delhi - 110054, India
Trap characterization on GaN Schottky barrier diodes (SBDs) has been carried out using deep-level transient spectroscopy (DLTS). Selective probing by varying the ratio of the rate window values (r) incites different trap signatures at similar temperature regimes. Electron traps are found to be within the values: 0.05–1.2 eV from the conduction band edge whereas the hole traps 1.37–2.66 eV from the valence band edge on the SBDs. In the lower temperature regime, the deeper electron traps contribute to the capacitance transients with increasing r values, whereas at the higher temperatures >300 K, a slow variation of the trap levels (both electrons and holes) is observed when r is varied. These traps are found to be mainly contributed to dislocations, interfaces, and vacancies within the structure.Trap characterization on GaN Schottky barrier diodes (SBDs) has been carried out using deep-level transient spectroscopy (DLTS). Selective probing by varying the ratio of the rate window values (r) incites different trap signatures at similar temperature regimes. Electron traps are found to be within the values: 0.05–1.2 eV from the conduction band edge whereas the hole traps 1.37–2.66 eV from the valence band edge on the SBDs. In the lower temperature regime, the deeper electron traps contribute to the capacitance transients with increasing r values, whereas at the higher temperatures >300 K, a slow variation of the trap levels (both electrons and holes) is observed when r is varied. These traps are found to be mainly contributed to dislocations, interfaces, and vacancies within the structure.
deep traps Pt-SBD DLTS rate window defects Journal of Semiconductors
2023, 44(4): 042802
中国海洋大学信息科学与工程学部物理与光电工程学院, 山东青岛 266100
相比于传统的破坏型应力发光材料, 陷阱控制型应力发光材料在应力发光过程中具有良好的结构完整性和应力发光可重复性等优势, 已在应力传感器、应力驱动的照明和显示器等领域展现出应用潜力, 高性能陷阱控制型应力发光材料的开发对推动应力发光的应用进程具有重要意义。本工作研究了新型陷阱控制型应力发光材料 Ca2Ga2GeO7:Pr3+, 通过测量 XRD谱、漫反射光谱、荧光衰减曲线、发射光谱、应力发光光谱和热释光图谱对其发光特性进行了研究。 Ca2Ga2GeO7:Pr3+的光致发光谱和应力发光光谱均具有位于 488、610 nm和 648 nm的发射峰, 分别对应于 Pr3+从 3H4→3P0、3H4→1D2和 3F2→3P0的能级跃迁。我们发现在连续摩擦刺激下其应力发光强度表现出缓慢衰减特性, 并且应力发光强度与应力强度还满足线性增长趋势。基于热释光测试的陷阱属性分析表明: Ca2Ga2GeO7:Pr3+缓慢衰减的应力发光特性主要来源于材料中深陷阱的存在, 即在连续应力刺激过程中, 深陷阱不断地向浅陷阱提供电子补充, 使应力发光表现出缓慢衰减特性。这为高性能陷阱控制型应力发光材料的开发和应用提供了材料和实验基础。
应力发光 陷阱 可重复性 缓慢衰减 mechanoluminescence traps repeatability slow-decaying

Author Affiliations
Abstract
1 Guangxi Key Laboratory of Optoelectronic Information Processing, School of Optoelectronic Engineering, Guilin University of Electronic Technology, Guilin 541004, China
2 School of Electronic Information and Electrical Engineering, Huizhou University, Huizhou 516000, China
Optical line tweezers have been an efficient tool for the manipulation of large micron particles. In this paper, we propose to create line traps with transformable configurations by using the transverse electromagnetic mode-like laser source. We designed an optical path to simulate the generation of the astigmatic beams and line traps with a series of lenses to realize the rotational transformation with respect to the rotation angle of cylindrical lenses. It is shown that the spherical particles with diameters ranging from 5 μm to 20 μm could be trapped, aligned, and revolved in experiment. The periodical trapping forces generated by transformable line traps might open an alternative way to investigate the mechanical properties of soft particles and biological cells.
optical line tweezers transformable line traps optical manipulation Chinese Optics Letters
2022, 20(5): 053801
1 中国科学院 计算数学研究所,北京100190
2 四川师范大学 数学科学学院,四川 成都610066
针对半导体器件中的氧化物由于辐射电离损伤所产生的界面陷阱和体缺陷的模型,采用向后欧拉方法处理时间离散,采用线性化的方法处理带反应项的非线性漂移扩散反应方程,完成了氧化金属–绝缘层–半导体结构(MIS)中二氧化硅层产生界面缺陷和体缺陷的数值模拟。该算法在三维并行自适应有限元软件平台(PHG)上编程实现,模拟的数值结果与电离损伤实验中所出现的低剂量增强效应和在不同氢气浓度条件下的数据相符合。针对模拟结果给出了对应模型的结果分析。
电离损伤效应 氧化物缺陷 界面缺陷 并行有限元 ionizing dose effect oxide traps interface traps parallel finite element 太赫兹科学与电子信息学报
2021, 19(6): 1126
山西大学 理论物理研究所,山西 太原 030006
本文用虚时演化方法和时间劈裂傅里叶谱方法研究了幂律势阱中玻色-爱因斯坦凝聚体的基态涡旋分布特征,具体讨论了不同幂律值、旋转角频率以及粒子间相互作用强度对涡旋分布的影响。当旋转角频率和粒子间相互作用强度不变时,随着幂律值的增大,玻色-爱因斯坦凝聚体的基态涡旋分布呈现如下特征:单量子化涡旋开始以三角晶格排列出现,随后凝聚体中心区域密度逐渐减小至零,出现中心洞,继而转变为巨涡旋结构。当相互作用强度一定时,随着幂律值越来越大,凝聚体中出现涡旋与形成巨涡旋的临界旋转角频率都随之越来越小。而当幂律值和旋转角频率一定时,逐渐增强粒子间相互作用强度,凝聚体中涡旋结构由巨涡旋转变成了三角晶格结构。
玻色-爱因斯坦凝聚体 涡旋结构 巨涡旋 幂律势阱 Bose-Einstein condensates vortex structure giant vortex power-law traps
1 西安电子科技大学 物理与光电工程学院,陕西 西安 710071
2 中国空空导弹研究院 红外探测器航空科技重点实验室, 河南 洛阳 471009
基于Silvaco二维数值仿真研究了界面陷阱对背照式p-on-n台面型InSb光伏红外探测器串音和量子效率的影响,通过分析探测器中复合率分布、空穴电流密度分布、电场分布等与界面陷阱的空间分布及浓度的相关性,揭示了界面陷阱影响探测器的稳态性能的内在物理机制.研究结果表明,N-型InSb有源区与钝化层界面处的陷阱和像元台面间的界面陷阱都会在提高串音性能的同时降低量子效率,但由于两者作用区域不同,所以对两种性能的影响程度不同.
界面态 陷阱 InSb光伏型红外探测器 量子效率 串音 interface state traps a photovoltaic InSb infrared detector quantum efficiency crosstalk
1 厦门理工学院 材料科学与工程学院, 福建省功能材料及应用重点实验室, 福建 厦门 361021
2 中国科学院 城市环境研究所, 福建 厦门 361021
采用高温固相法制备了SrLaGa3O7∶xSm3+长余辉材料,通过XRD、荧光光谱、热释光谱分别对样品的结构以及发光性能进行了研究,探究了Sm3+掺杂浓度对样品自身长余辉发光性能的影响。研究结果表明:样品在254 nm紫外光照射后,SrLaGa3O7∶xSm3+在386 nm有明显的长余辉发光,可持续60 min,主要是由于样品中空位引起的发光。随着掺杂Sm3+浓度的增加,样品的发射光谱和余辉强度先增强后减弱,并出现明显的红移现象,这与Sm3+掺杂所造成的空位浓度密切相关。当Sm3+的摩尔分数达到0.5%时,样品在420 nm处展现最佳的长余辉性质。热释光谱表明掺杂后的样品中存在两种不同的陷阱,分别是由氧空位和锶空位引起的,这两种陷阱不仅影响样品的发光强度,而且充当俘获中心从而影响样品的余辉性能。
长余辉性能 光致发光 热释发光 陷阱能级 SrLaGa3O7∶Sm3+ SrLaGa3O7∶Sm3+ long afterglow properties photoluminescence thermoluminescence traps





