用于光刻调焦调平的反射式投影光学系统设计  下载: 1352次
下载: 1352次
1 引言
调焦调平系统是光刻机关键分系统之一[1],用于对硅片表面高度形貌进行测量。随着光刻关键尺寸的减小,光刻机焦深控制范围越来越小。焦深控制精度是光刻机投影物镜、工件台、调焦调平等相关分系统共同影响的结果。例如,光刻机焦深控制精度要达到110 nm[2],需要调焦调平系统的测量精度小于10 nm。
目前,国际主流光刻机供应商ASML、Nikon、Canon的调焦调平系统均基于光学三角法测量原理[3-6]实现。调焦调平投影光学系统根据光线传输方式可分为透射式和反射式,其中Nikon IC光刻机中采用透射式投影光学系统[4],ASML早期单工件台光刻机采用透射式双远心投影光学系统[7],后期XT/NXT等系列双工件台光刻机则采用反射式双远心投影系统[8]。
国内一些单位对调焦调平技术进行了研究,2007年华中科技大学李小平等[6]在分析调焦调平传感器时使用了简化模型,将投影成像系统视为等大小倒立实像;2014年中国科学院光电技术研究所Yan等[9]研究了调焦调平系统的投影成像系统采用4f透射式双远心系统;2016年中国科学院微电子研究所孙裕文等[10]开展了一种基于空间分光的纳米级调焦调平测量技术研究;2017年上海交通大学庄亚政等[11]开展基于扫描反射镜调制的调焦调平系统测试方法研究,其投影光学系统采用向甫鲁(SC)双远心成像系统,该系统由十几个透镜组件组成,像差较大,在量程两端存在较大非线性。综上所述,调焦调平系统的相关研究主要基于透射式投影系统,尚未见针对反射式投影光学系统的相关报道。
调焦调平投影光学系统要求在较宽光谱范围内,具有较小的畸变、较大的景深,传统的透射式成像系统,往往需要较多镜片,优化及安装调试都相对复杂。而Offner系统作为反射式成像系统,自身无色差,仅由两个反射镜构成,结构简单,易于集成,在光谱仪系统中已得到应用[12]。基于以上考虑,本文在给出一种用于光刻调焦调平的反射式投影光学结构的基础上,根据调焦调平系统测量原理与像差理论,分析得到投影系统光学指标对调焦调平系统测量精度的影响规律,以典型的Offner光学系统为基础,设计完成了应用于光刻调焦调平传感器的反射式光学投影系统,并对其进行了像质评价和公差分析。
2 一种用于光刻调焦调平传感器的反射式光学结构
作为调焦调平传感器的核心,投影系统的成像质量直接影响测量精度。待测表面形貌是根据投影光栅像与探测光栅所形成的莫尔条纹进行测量得到,投影系统畸变将直接导致探测光栅像畸变,从而造成莫尔条纹变化,引起测量误差。为保证投影光学系统在测量范围内都能够对投影光栅进行清晰成像,要求投影系统具有较大的景深。另外,传感器需满足光刻工艺适应性,调焦调平测量系统需采用宽光谱光源,带宽一般大于300 nm[7]。研究设计具有小畸变、大景深、小色差的投影成像系统是提高调焦调平传感器性能的一个途径,也是调焦调平传感器测量精度的保障。
本文设计了一种用于光刻调焦调平传感器的反射式光学系统,结构示意图如
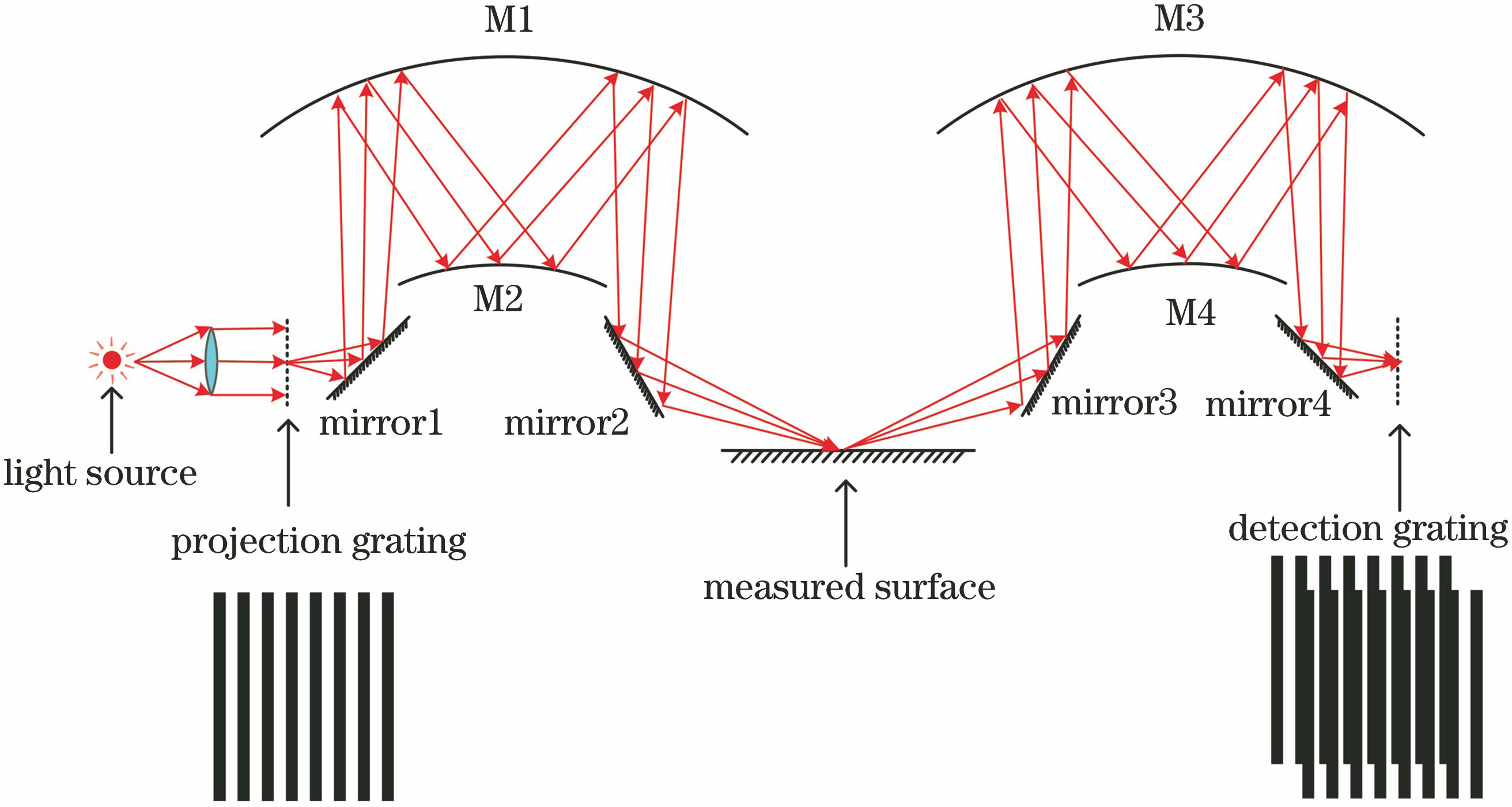
图 1. 反射式调焦调平传感器光学系统示意图
Fig. 1. Schematic of focusing and leveling sensor with reflective optical design
3 反射式投影光学系统设计
透射式双远心投影系统一般由多个透镜组成[11],为满足色差等条件需要大量优化设计,并且机械安装也相对复杂。Offner反射式双远心投影系统光学结构无色差,系统结构简单,仅由两个球面反射镜和两个平面反射镜组成,后期优化设计与工程实现相对容易。本文优选反射式投影系统,原理如
投影系统成像质量影响系统的测量精度,其中放大倍率、畸变、远心度直接影响投影光栅像的周期、成像相对位置,分辨率影响投影光栅像的对比度,也将对系统的测量精度产生影响,为满足测量精度的要求,需要研究像差对测量精度影响规律,建立理论模型进行分析。
表 1. 系统性能指标要求
Table 1. Requirement for system performance index
|
表 2. 系统结构参数
Table 2. Structure parameter of the system
|
根据文献[ 10]中调焦调平传感器测量原理,推导出高度测量公式为
式中:P为投影光栅周期;h为测量面实际相对高度;hm为系统测量高度;G为比例系数;α为测量面光线入射角度。
根据SEMI MF657-0707E标准,300 mm标准硅片厚度变化范围为-1.25 ~1.25 μm,将该范围作为调焦调平传感器的测量范围,并由此得到光栅的周期,取(1)式中类正弦曲线零点附近幅值±50%范围作为线性区间,即
又因0≤sin α≤1,因此P≥30 μm,并且光栅周期越小,测量分辨率越高,因此选择投影光栅和探测光栅周期为30 μm。拟采用振幅型光栅为投影光栅,其复振幅透过率为
式中:a为光栅狭缝宽度;L为光栅宽度;x为垂直光栅线栅方向;y为平行光栅线栅方向。
照明光源照射到投影光栅,投影光栅经过投影系统后,投影光栅像复振幅为
放大倍率将改变光栅周期P与光栅宽度L,当放大倍率为β时,根据(4)式可知,投影光栅像复振幅为
远心度将改变光栅像大小,当远心度为α,离焦量为d时,根据(4)式可知,投影光栅像复振幅为
此外,为产生畸变,设置畸变矩阵对光栅图像进行处理,通过修改矩阵参数,得到不同畸变的像;为实现分辨率改变,设置不同的数字滤波器,通过改变数字滤波器参数得到不同分辨率的光栅像。分别仿真计算出不同像差条件下投影光栅像,如

图 3. 模拟投影光栅与不同像差条件下投影光栅的像。(a)投影光栅;(b)无像差的像;(c)放大倍率为0.95时的像;(d)远心度为5 mrad时的像;(e)畸变为0.08时的像;(f)调制传递函数(MTF)值为0.70时的像
Fig. 3. Simulated projection grate and its imaging with different aberrations. (a) Projection grate; (b)imaging with no aberration; (c) imaging with 0.95 magnification; (d)imaging with 5 mrad tele-centricity; (e) imaging with 0.08 distortion; (f) imaging with 0.70 modulation transfer function (MTF)
调焦调平传感器采用莫尔条纹与光学三角法的测量原理,探测部分采用空间分光技术[10]。投影光栅的像与探测光栅形成莫尔条纹,再经分光系统后得到两组莫尔条纹,最终根据莫尔条纹的光强通过多项式拟合得到测量高度。采用文献[
10]中测量高度方法进行测量误差分析,当测量高度为1.25 μm时,测量误差随各像差的变化曲线如

图 4. 系统测量精度随不同像差的变化曲线。 (a)放大倍率;(b)远心度;(c)畸变;(d) MTF值
Fig. 4. Measurement accuracy of system with different aberrations. (a) Magnification; (b) tele-centricity; (c) distortion; (d) MTF value
根据放大倍率、畸变、远心度、分辨率与调焦调平传感器测量精度关系的仿真结果,参考光刻机焦深控制预算分配方式[14],为满足调焦调平传感器测量精度小于10 nm,确定相关参数如下:放大倍率为1.001,测量误差δ1=1.789 nm;远心度为0.2 mrad,测量误差δ2=2.691 nm;畸变为0.01%,测量误差δ3=2.471 nm;MTF@33 lp/mm为0.60,测量误差δ4=1.932 nm;总测量误差为δ=2·
将
4 反射式投影光学系统性能评估及公差分析
4.1 反射式投影光学系统成像性能评估
点列图是通过光学系统物点像的光线集中度来研究系统成像质量,根据调焦调平系统所采用的投影光栅结构,将视场设置为(-1.5,-13)、(-1.5,13)、(-1.5,5.9)、(-1.5,-5.9)、(0,0)、(1.5,5.9)、(1.5,-5.9)、(1.5,13)、(1.5,-13),投影系统点列图如
4.2 投影系统公差分析
光学系统公差主要有制造公差、机械装配公差,根据调焦调平传感器测量精度指标要求,对光学的公差进行分配,如
以MTF@33 lp/mm处值作为标准,对该成像系统进行敏感度分析。影响投影系统光学传递函数MTF@33 lp/mm处值的前10个公差如
表 3. 反射式投影系统公差分配
Table 3. Tolerances distribution of the reflection projection system
|
表 4. 公差对MTF的影响
Table 4. Effect of tolerances on MTF
|
4.3 光学零件可制造性和装配过程
本文投影光学系统中核心零件是两个球面镜反射镜,其中球面镜M2有效口径相对较小,为40 mm,零件加工能够满足表面不规则度小于0.1个光圈,曲率半径公差0.1 mm的指标要求。球面镜M1要求口径140 mm范围内,表面不规则度小于0.1个光圈,曲率半径公差0.1 mm,相对来说加工难度较大,但目前国内的加工水平也可以达到。
投影光学系统中光学元件精密装配,通过机械镜筒加工精度保证。为保证光机装配后两球面镜件距离小于0.1 mm,要求机械镜筒在筒长193 mm范围内公差控制在±0.05 mm。同时,为保证光机装配后两球面镜偏心和倾斜满足指标,要求机械镜筒上与球面接触处圆弧跳动公差小于10 μm。以上提到的机械镜筒加工精度可通过精密联动数控机床保证。其次,装配过程中借助于Leitz超高精密三坐标测量机,其测量精度小于1 μm,对系统中光学元件安装位置进行在线测量,实时进行精细调整,以进一步提高元件装配精度以及最终系统成像性能。
最后,采用蒙特卡罗分析方法对公差进行评价,对反射式投影系统进行综合性能分析,计算分析了100个样本,每个样品作为一个实际加工并装调后的反射式投影系统模拟,得到MTF统计结果如
表 5. 蒙特卡罗分析结果
Table 5. Monte Carlo analysis results
|
5 结论
本文根据调焦调平测量原理与像差理论,分析了像差与测量精度之间的关系,得到了满足测量精度小于10 nm的调焦调平传感器的投影光学系统性能指标,设计了一种用于光刻调焦调平传感器的反射式投影光学系统。通过Zemax软件进行优化后,该系统放大率为1.000,工作波长600~1000 nm,视场3 mm×26 mm范围内弥散斑均方根半径小于0.189 μm,调制传递函数MTF@33 lp/mm为0.74,最大畸变为0.0008%,远心度为0.04 mrad,满足设计要求。该光学系统中的投影成像系统只有两个球面反射镜与两个平面反射镜组成,具有结构简单、无色差、畸变小等优点。通过公差分析,结合目前的光机制造和装配能力,可工程化实现,为高精度光刻调焦调平传感器提供了一种光学设计方法。
[1] Fontaine B M L, Hauschild J, Dusa M V, et al. Study of the influence of substrate topography on the focusing performance of advanced lithography scanners[J]. Proceedings of SPIE, 2003, 5040: 570-581.
[2] Boeij W P D, Pieternella R, Bouchoms I, et al. Extending immersion lithography down to 1x nm production nodes[J]. Proceedings of SPIE, 2013, 8683: 86831L.
[3] Kerr PB, FuchsJ, Crouch R T . internet based method and system for worldwidepromoting and offering for sale or license patent rights and patent application rights:US20180158160[P]. 2018-06-07.
[4] HidakaY, Ishikawa M . Surface position detecting apparatus, exposureapparatus, surface position detectingmethod, device manufacturing method:US8223345[P]. 2012-07-17.
[5] KobayashiT, Kosugi Y. Surface position measuring method and apparatus:US7668343[P]. 2010-02-23.
[6] 李小平, 陈飞彪. 投影光刻机硅片调焦调平测量模型[J]. 光学学报, 2007, 27(11): 1987-1991.
[7] . Optical focus and level sensor for wafer steppers[J]. Journal of Vacuum Science & Technology B, 1992, 10(2): 735-740.
[8] Jasper J CM, Loopstra ER, Modderman TM, et al. 2004-04-29.
[9] Yan W, Yang Y, Chen W F, et al. Moiré-based focusing and leveling scheme for optical projection lithography[J]. Applied Optics, 2010, 49(31): 5959-5963.
[10] 孙裕文, 李世光, 宗明成. 基于空间分光的纳米级调焦调平测量技术[J]. 光学学报, 2016, 36(5): 0512002.
[11] 庄亚政, 齐景超, 陈小娟. 基于扫描反射镜调制的调焦调平系统测试方法研究[J]. 传感器与微系统, 2017, 36(10): 45-47.
Zhuang Y Z, Qi J C, Chen X J. Research on test method of focusing and leveling system based on scanning mirror modulation[J]. Transducer and Microsystem Technologies, 2017, 36(10): 45-47.
[12] 朱雨霁, 尹达一, 陈永和, 等. 高光谱分辨率紫外Offner成像光谱仪系统设计[J]. 光学学报, 2018, 38(2): 0222001.
[13] 黄元申, 倪争技. 同心三反射镜光学系统研究[J]. 光学仪器, 2005, 27(2): 42-46.
Huang Y S, Ni Z J. Research of the concentric three-reflection optical system[J]. Optical Instruments, 2005, 27(2): 42-46.
[14] Jang J H, Park T, Park K D, et al. Focus control budget analysis for critical layers of flash devices[J]. Proceedings of SPIE, 2014, 9050: 90502F.
Article Outline
孙生生, 王丹, 齐月静, 宗明成. 用于光刻调焦调平的反射式投影光学系统设计[J]. 光学学报, 2020, 40(15): 1522002. Shengsheng Sun, Dan Wang, Yuejing Qi, Mingcheng Zong. Design of Reflective Projection Optics Used in Lithographic Focusing and Leveling System[J]. Acta Optica Sinica, 2020, 40(15): 1522002.










