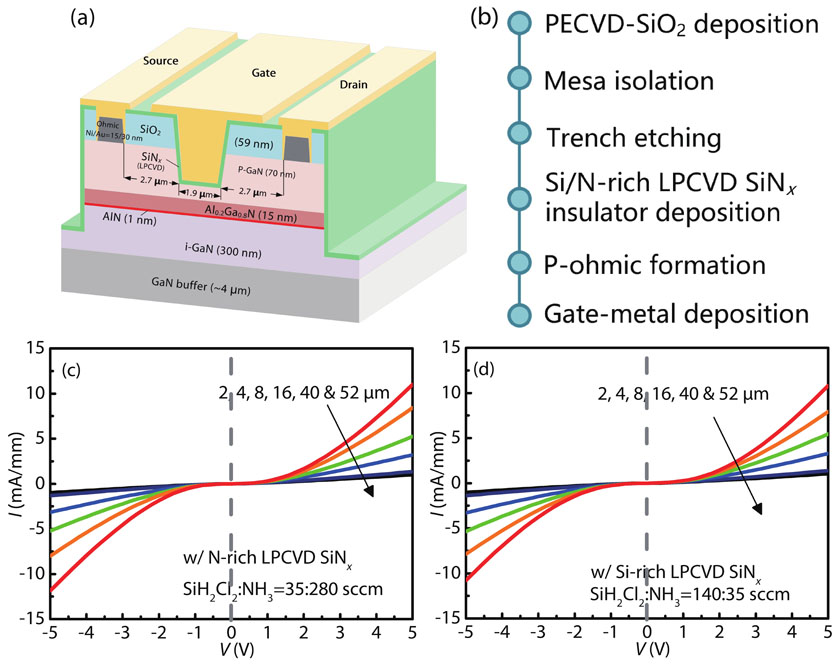
Author Affiliations
Abstract
1 State Key Laboratory of Electronic Thin Films and Integrated Devices, University of Electronic Science and Technology of China, Chengdu 610054, China
2 Key Laboratory of Nanodevices and Applications, Suzhou Institute of Nano-tech and Nano-bionics, CAS, Suzhou 215123, China
3 Institute of Electronic and Information Engineering, University of Electronic Science and Technology of China, Dongguan 523808, China
In this work, the GaN p-MISFET with LPCVD-SiNx is studied as a gate dielectric to improve device performance. By changing the Si/N stoichiometry of SiNx, it is found that the channel hole mobility can be effectively enhanced with Si-rich SiNx gate dielectric, which leads to a respectably improved drive current of GaN p-FET. The record high channel mobility of 19.4 cm2/(V?s) was achieved in the device featuring an Enhancement-mode channel. Benefiting from the significantly improved channel mobility, the fabricated E-mode GaN p-MISFET is capable of delivering a decent-high current of 1.6 mA/mm, while simultaneously featuring a negative threshold-voltage (VTH) of –2.3 V (defining at a stringent criteria of 10 μA/mm). The device also exhibits a well pinch-off at 0 V with low leakage current of 1 nA/mm. This suggests that a decent E-mode operation of the fabricated p-FET is obtained. In addition, the VTH shows excellent stability, while the threshold-voltage hysteresis ΔVTH is as small as 0.1 V for a gate voltage swing up to –10 V, which is among the best results reported in the literature. The results indicate that optimizing the Si/N stoichiometry of LPCVD-SiNx is a promising approach to improve the device performance of GaN p-MISFET.
p-channel GaN p-FET LPCVD channel mobility hole mobility enhancement-mode Journal of Semiconductors
2023, 44(8): 082801
青海黄河上游水电开发有限责任公司西安太阳能电力分公司,西安 710100
本文主要对低压化学气相沉积(LPCVD)法制备N型高效晶硅隧穿氧化层钝化接触(TOPCon)电池工艺进行研究。分析LPCVD法制备隧穿氧化层及多晶硅层的影响因素,研究了不同氧化层厚度、多晶硅厚度及多晶硅层中P掺杂量对太阳能电池转换效率的影响。结果表明:当隧穿氧化层厚度在1.55 nm时,钝化效果最佳;多晶硅层厚度120 nm时Voc达到最高值;多晶硅层厚度在90 nm时Eff最高。当P掺杂量为3.0×1015 cm-2时可获得较高的Voc,原因是随着P掺杂量的增加,多晶硅层场钝化效果提高。
TOPCon电池 隧穿氧化层 多晶硅层 钝化 掺杂 TOPCon cell LPCVD LPCVD tunnel oxide layer polycrystalline silicon layer passivation doping
PCM(Process Control Monitor)是一种反映生产线工艺状况的质量监控技术。文章围绕影响电荷耦合器件(CCD)工艺中PCM测试结果的工艺因素展开研究, 并对PCM测试结果进行统计分析, 以达到测试结果用于工艺改进的目的, 并最终获取最佳工艺条件。结果表明: 低压化学气相沉积(LPCVD)温度为700℃、膜厚为580nm时的方块电阻为18Ω/□; 孔工艺采用干法刻蚀CF4流量为15cm3/min、CHF3流量为45cm3/min下的接触电阻为7Ω; 栅下埋沟注入磷离子能量为250keV、剂量为2.5×1012atom/cm2时, MOS管阈值电压为-8.5V; 二次铝刻蚀主刻蚀采用Cl2流量为90cm3/min, BCl3流量为45cm3/min, N2流量为30cm3/min可有效避免因残留物引起的金属同层漏电。
电荷耦合器件 干法刻蚀 埋沟注入 二次铝刻蚀 PCM PCM CCD LPCVD LPCVD dry etching buried channel implantation secondary aluminum etching
1 中国科学院半导体研究所 半导体材料科学重点实验室, 北京100083
2 国网智能电网研究院, 北京 100192
3 东莞天域半导体科技有限公司, 广东 东莞 523000
利用课题组自主研发的热壁低压化学气相沉积(HWLPCVD)系统, 在朝[11-20]方向偏转4°的(0001)Si面4H-SiC衬底上进行快速同质外延生长, 研究了生长温度及氯硅比(Cl/Si比)对外延生长速率的影响机理。研究发现, 外延生长速率随生长温度的提高呈线性增加, 而Cl/Si比的改变对生长速率的影响不大。文章进一步探究了Cl/Si比对4H-SiC外延层表面缺陷的影响。较低的Cl/Si比(0.4~2)可以减少或消除三角缺陷, Cl/Si比较高(大于5)时, 表面质量反而下降, 因而, 适当的Cl/Si比对于获得表面形貌良好的4H-SiC外延层至关重要。
碳化硅 低压化学气相沉积 同质外延 生长温度 SiC LPCVD homoepitaxy growth temperature
1 重庆光电技术研究所, 重庆 400060
2 中国国防科技信息中心, 北京 100142
采用表面光电压技术研究了低压化学气相淀积(LPCVD)法氮化硅淀积工艺的Fe离子沾污。研究表明, 在氮化硅淀积工艺中, NH3和SiH2Cl2气体是Fe离子沾污的主要来源。通过对氮气进一步纯化处理、提高NH3和SiH2Cl2气体纯度和更换传输气体的金属管路等措施, 氧化工艺Fe离子沾污减少了一个数量级。
铁离子沾污 氮化硅 低压化学气相淀积 表面光电压 iron contamination nitride LPCVD SPV
中国科学院半导体研究所 材料中心, 北京 100083
利用自主研发的热壁低压化学气相沉积(HWLPCVD)系统,在5.08cm(2英寸)4°偏轴4H-SiC衬底上生长4H-SiC同质外延膜。讨论了4H-SiC同质外延层中的两种扩展缺陷——彗星缺陷和胡萝卜缺陷,研究了这两种缺陷的起源与消除方法。研究发现采用化学机械抛光(CMP)方法可以有效去除扩展缺陷,提高外延膜的质量。另外,提高衬底质量和优化生长条件也可以消除这两种扩展缺陷。
碳化硅 低压化学气相沉积 同质外延 扩展缺陷 SiC LPCVD homoepitaxy extended defect
西安理工大学 电子工程系, 陕西 西安 710048
利用低压化学气相淀积工艺在6H-SiC衬底成功制备了SiCGe薄膜。通过光致发光(PL)谱研究了生长温度对SiCGe薄膜发光特性的影响。结果表明:生长温度为980,1 030,1 060 ℃的SiCGe薄膜的室温光致发光峰分别位于2.13,2.18,2.31 eV处;通过组分分析和带隙计算,认定该发光峰来自于带间辐射复合,证实了改变生长温度对SiCGe薄膜带隙的调节作用。同时,对SiCGe薄膜进行了变温PL测试,发现当测试温度高于200 K时,发光峰呈现出蓝移现象。认为这是不同机制参与发光所造成的。
SiCGe薄膜 低压化学气相沉积 生长温度 光致发光 SiCGe LPCVD growth temperature photoluminescence
中国工程物理研究院,电子工程研究所,四川,绵阳,621900
以二氯甲硅烷和氨气分别作为低压化学气相淀积(LPCVD)氮化硅(Si3N4)薄膜的硅源和氨源,以高纯氮气为载气,在热壁型管式反应炉中反应生成Si3N4薄膜.考察了工作压力、反应温度、气体原料组成等因素对Si3N4薄膜淀积速率的影响.结果表明:Si3N4薄膜的生长速率随着工作压力的增大单调增大,随着原料气中氨气和二氯甲硅烷的流量之比的增大单调减小.随着反应温度的升高,淀积速率逐渐增加,在840 ℃附近达到最大,随后迅速降低.在适当的工艺条件下,制备的Si3N4薄膜均匀、平整.较低的薄膜淀积速率有助于提高薄膜的均匀性,降低薄膜的表面粗糙度.
SiH2CL2-NH3-N2体系 氮化硅薄膜 淀积速率 LPCVD
中国工程物理研究院,电子工程研究所,传感器研究中心,四川,绵阳,621900
介绍了利用SiH2Cl2-NH3-N2体系LPCVD制备Si3N4薄膜的工艺,借助椭圆偏振仪研究了薄膜的厚度及折射率.结果表明:当原料气中氨气与二氯甲硅烷的流量之比(R)较小时(R≤2),获得富Si的Si3N4薄膜,折射率较高.当氨气远远过量时(R>4),折射率处于1.95~2.00之间.在适当的工艺条件下,获得的Si3N4薄膜表面均匀、平整,折射率达到理想值.
二氯甲硅烷-氨体系 氮化硅薄膜 折射率 LPCVD





