单根镓掺杂氧化锌微米线异质结基高亮黄光发光二极管
1 引言
半导体可见光光源具有绿色环保、节能降耗以及寿命长等优点,广泛应用于照明、背光、显示、农业、医疗、通信等领域。但在可见光范围内,人眼较为敏感的黄绿光波段的发光材料与器件一直受限于“Green/yellow gap”和“Efficiency droop”[1-5]。目前,有机和无机直接带隙半导体已经广泛应用于构筑InGaN基量子阱发光二极管、钙钛矿发光二极管、有机发光二极管等黄绿光发光器件[6-11]。以InGaN量子阱黄绿色发光二极管为例,为了实现黄光发射,需要增加InGaN量子阱材料中In的组分。但是,高In组分带来的InGaN量子阱的强压电场和较差的晶体质量又会导致光发射效率降低、半峰宽变宽以及发光颜色改变等[12-14];此外,由于应变极化电场的存在,InGaN基发光二极管的性能还会受到量子斯塔克效应的影响[15-17]。此外,基于有机/无机量子点(包括有机发光二极管(Light-emitting diode,LED)、无机量子点LED、有机/无机钙钛矿量子点,或纳米晶材料等)构筑的黄绿光发光器件[18-19],其性能严重受限于差的稳定性、低亮度和小尺寸发光器件所带来的发光效率急剧降低等因素[20-23]。
近年来,低维微纳米级光源在超高分辨率移动显示器、生物医学传感和细胞生物成像、定向靶向诊断与治疗等低维尺度上的需求引起人们广泛关注和研究[24-26]。然而,设计和构筑的低维发光器件存在表面复合、俄歇复合、载流子外溢、电极损耗等,极大地影响低维黄绿光发光器件的量子效率。且随着器件尺寸的减小,器件的性能出现急剧的衰减[27-32]。由InGaN基微/纳米结构(如纳米线、微米线、纳米线阵列等)制成的黄绿光发光器件虽然已被广泛报道,但它们需要使用昂贵的高温高真空生长设备、光刻设备和技术平台,以及复杂的后处理设备和技术等,这些关键因素极大地限制了InGaN基低维可见光光源的器件化和应用化。因此,开发低价且易于操作的材料和器件结构以实现低维微纳结构基黄绿光发光器件仍然是一个挑战[33-35]。
本文在实验上采用碳热还原反应法生长单根镓掺杂氧化锌(ZnO∶Ga)微米线(MW),选择p型InGaN衬底做空穴注入层,构筑了n-ZnO∶Ga MW/p-InGaN异质结黄光发光二极管。在正向偏压驱动下,制备的器件发射黄光,相应发光峰的峰位位于580 nm左右,半峰宽大约为50 nm。随着注入电流的增加,n-ZnO∶Ga MW/p-InGaN异质结发光器件的色坐标始终位于黄光色域范围。且随着注入电流的增加,该器件的发光中心波长和半峰宽几乎没有任何变化,说明器件发光较为稳定。另外,基于能带模型详细阐述了n-ZnO∶Ga MW/p-InGaN异质结结构的电致发光机理,黄光的光发射来自于n-ZnO∶Ga/p-InGaN异质结结区界面,即ZnO∶Ga微米线注入的电子和InGaN衬底注入的空穴在两者结区界面的耗尽层辐射复合,这也是器件发光光谱随注入电流的增加没有发生变化的根本原因。该异质结发光器件的耗尽层分布在结区界面处,而不是InGaN衬底中,有效降低了衬底中高In组分导致的较高缺陷密度和更大的极化电场所带来的“Green/yellow gap”和“Efficiency droop”。该实验结果为制备高性能、低维可见光发光器件提供了一种全新的实验方案。
2 实验
2.1 材料生长
实验上采用碳热还原反应方法制备单根镓掺杂氧化锌(ZnO∶Ga)微米线[36]。首先将质量比为9∶1∶10的高纯度ZnO、氧化镓(Ga2O3)和碳(C)粉末经研磨之后充分混合,作为生长微米线结构的前驱体材料。然后,将混合物粉末放入刚玉舟(长×宽×高为4 cm×3.5 cm×2 cm)中,舟的上面放置一纯硅晶片(尺寸为3.5 cm×3.5 cm),硅晶片距离舟内反应源的垂直距离约1.55 cm。刚玉舟放置在水平管式炉内石英管中最高温区域。在材料生长过程中,石英管中通入高纯氩气体作为保护性气体,气体流量为125 mL/min,生长温度为1 100 ℃,反应时间为1 h。反应结束后待管式炉自然冷却,取出刚玉舟,便可在Si衬底上沉积大量的、单根的ZnO∶Ga微米线。通过改变刚玉舟中反应源的量、气流量和反应时间可实现ZnO∶Ga微纳结构的表面形貌、尺寸等可控制备。其中微米线的最大长度可达2.0 cm,直径范围为1~30 µm。
2.2 器件制备
选择单根ZnO∶Ga微米线,结合商业化的p型InGaN作为空穴注入层,制备单根微米线异质结电致发光器件,器件制备过程如
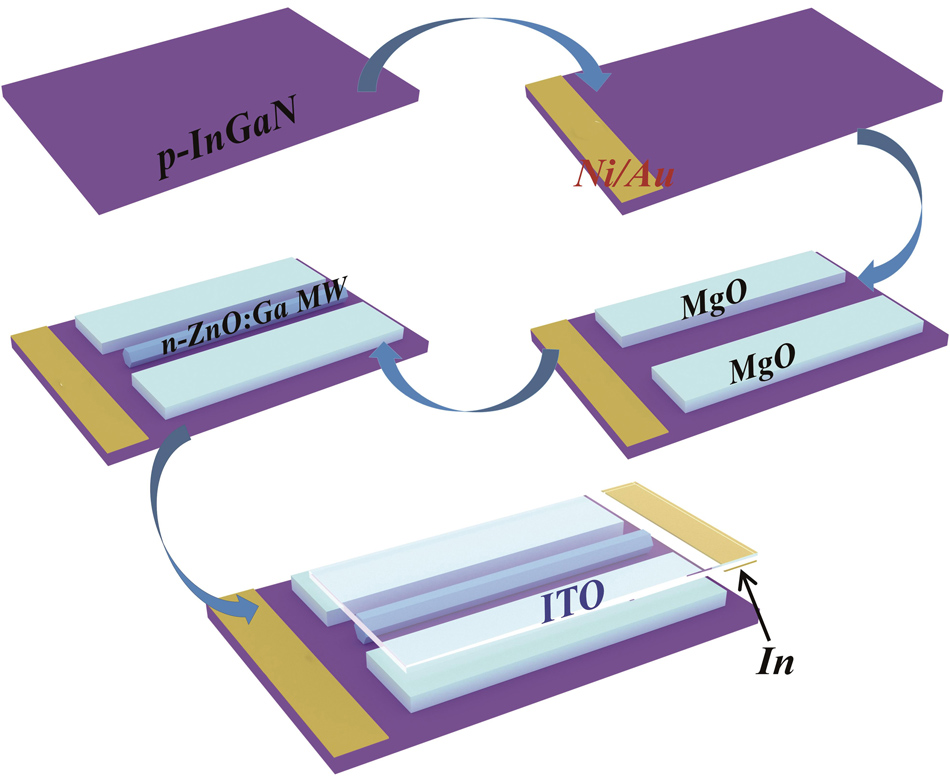
图 1. 基于n-ZnO∶Ga MW/p-InGaN异质结制备黄光发光二极管器件流程图
Fig. 1. The fabrication process of n-ZnO∶Ga MW/p-InGaN heterojunction yellow light-emitting device
2.3 表征与测试
使用扫描电子显微镜(SEM)表征单根ZnO∶Ga微米线的形貌。采用Keysight B1500A测量单根ZnO∶Ga微米线、InGaN衬底以及制备的n-ZnO∶Ga MW/p-InGaN异质结器件的电学特性。采用ANDOR探测器(CCD-13448)和Omni-λ 500光谱仪组成的微光谱检测系统测量器件的电致发光特性,发光器件的电致发光图像在光学显微镜下观察和拍摄。单根ZnO∶Ga微米线的光致发光(PL)、InGaN衬底的PL光谱使用He-Cd激光(激发波长为325 nm)作为激发光源,采用LabRAM-UV Jobin-Yvon光谱仪进行光致发光光谱测试。
3 结果与讨论
采用扫描电子显微镜(SEM)对生长的单根ZnO∶Ga微米线进行表征,

图 2. (a)单根ZnO∶Ga微米线的SEM图,插图为微米线的六边形横截面;(b)ZnO∶Ga微米线的XRD图谱;(c)单根ZnO∶Ga微米线的EDS元素分析,表明Zn、Ga和O三种元素均匀分布在微米线中;(d)单根ZnO∶Ga微米线的高分辨TEM图;(e)单根ZnO∶Ga微米线的PL光谱;(f)单根ZnO∶Ga微米线的I⁃V曲线。
Fig. 2. (a)SEM image of a ZnO∶Ga MW,and the diameter is evaluated to about 10 μm.(b)XRD result of the as-synthesized ZnO∶Ga samples.(c)EDS elemental mapping of a ZnO∶Ga,illustrating its uniform composition of Zn,Ga and O species.(d)HRTEM picture of a ZnO∶Ga wire.(e)PL result of a ZnO∶Ga MW.(f)I⁃V characteristic curve of an individual ZnO∶Ga MW.
接下来,我们采用p型InGaN衬底作为空穴注入层,结合单根ZnO∶Ga微米线构筑可见光发光二极管,制备了单根微米线n-ZnO∶Ga/p-InGaN异质结发光器件,Ni/Au电极作为正电极,ITO作为负电极。针对制备的n-ZnO∶Ga MW/p-InGaN异质结进行相应的电学性质测试。Ni/Au电极接正极,ITO导电玻璃接负极,在n-ZnO∶Ga MW/p-InGaN异质结发光器件的电致发光测试过程中,电子从ZnO∶Ga 微米线一侧注入,空穴由p-InGaN的另一侧注入。当施加的正向电压超过一定值时,异质结器件被点亮,可以观察到明亮的黄光发射现象,

图 3. (a)基于n-ZnO∶Ga/p-InGaN异质结制备的单根微米线黄光发光二极管发光照片;(b)单根ZnO∶Ga微米线和p型InGaN衬底的I⁃V曲线;(c)单根微米线n-ZnO∶Ga/p-InGaN异质结的I⁃V曲线;(d)单根微米线n-ZnO∶Ga/p-InGaN异质结发光二极管的EL光谱;(e)单根微米线异质结发光二极管的EL光谱积分强度随注入电流的变化关系;(f)单根微米线异质结发光二极管EL峰位和半峰宽随注入电流的变化关系。
Fig. 3. (a)Photograph of a working n-ZnO∶Ga MW/p-InGaN heterojunction device at an input current of 1.5 mA.(b)Electrical properties viaI⁃V curves of individual ZnO∶Ga MW and p-InGaN template,indicating that Ohmic contacting behaviors of In-ZnO∶Ga and Ni/Au-InGaN are formed.(c)Electrical characterization viaI⁃V curve of the fabricated n-ZnO∶Ga MW/p-InGaN heterojunction.(d)EL spectra of n-ZnO∶Ga MW/p-InGaN heterojunction device was measured by varying current in the range of 0.5-3.0 mA.(e)Variation of the integrated EL intensity versus different injection current.(f)Variations of the peak positions and line width as functions of different input current.
为了证明实验上制备的n-ZnO∶Ga MW/p-InGaN异质结可用于实现微米级黄光发光二极管,我们首先对单根ZnO∶Ga微米线和p-InGaN衬底进行电学特性测试。
制备的单根微米线n-ZnO∶Ga/p-InGaN异质结发光器件在正向偏压下,器件发出较为明亮的黄光。
实验上采用光学显微镜和CCD相机对器件的发光现象进行拍摄,进一步测试了单根微米线异质结LED的黄光发射现象。

图 4. n-ZnO∶Ga MW/p-InGaN异质结发光二极管的光学发光图像。(a)n-ZnO∶Ga MW/p-InGaN异质结发光器件的光学图像;异质结发光二极管在注入电流为0.5 mA(b)、0.8 mA(c)、1.0 mA(d)、1.5 mA(e)、2.0 mA(f)、2.2 mA(g)、2.5 mA(h)、3.0 mA(i)时的发光图像,图中的尺度为30 μm。
Fig. 4. Series of optical microscope EL images of the as-constructed n-ZnO∶Ga MW/p-InGaN heterojunction LED were captured when the device operated under different currents.(a)Optical microscope image of a single MW placed on p-InGaN substrate.(b)0.5 mA.(c)0.8 mA.(d)1.0 mA.(e)1.5 mA.(f)2.0 mA.(g)2.2 mA.(h)2.5 mA.(i)3.0 mA. The scale bar is 30 μm.
采用能带结构分析n-ZnO∶Ga MW/p-InGaN异质结基发光器件的黄光发射的物理机制。首先使用激发波长为325 nm 的He-Cd激光器作为激发光源,对单根ZnO∶Ga微米线和p-InGaN衬底进行光致发光测试。

图 5. (a)p型InGaN衬底的光学发光图像;(b)p型InGaN衬底的归一化PL光谱和n-ZnO∶Ga MW/p-InGaN异质结发光二极管归一化EL光谱;(c)n-ZnO∶Ga MW/p-InGaN异质结发光二极管的能带结构图;(d)n-ZnO∶Ga MW/p-InGaN异质结发光二极管的EL光谱对应的色坐标;(e)n-ZnO∶Ga MW/p-InGaN异质结发光二极管的相对外量子效率;(f)n-ZnO∶Ga MW/p-InGaN异质结发光二极管在注入电流为1.6 mA和2.0 mA时EL光谱的峰值随时间的变化关系。
Fig. 5. (a)Optical microscope PL image of p-type InGaN layer.(b)Comparison of normalized PL emission of p-type InGaN template and EL spectrum of the fabricated n-ZnO∶Ga MW/p-InGaN heterojunction LED.(c)The energy band diagram of the n-ZnO∶Ga MW/p-InGaN heterojunction LED under the operation of forward-biasing condition.(d)A set of CIE-1931 color coordinates converted from the obtained EL spectra. Inset:the enlarged area of the color coordinates for the single MW yellow LED by varying the input current of 0.3-5.7 mA. The coordinate of the red pentacle is the color coordinate of pure yellow light-emitting according to the Rec. 2020 standard.(e)Variation of the ηREQE as a function of various injection current.(f)Time-dependent EL intensity of the n-ZnO∶Ga MW/p-InGaN LED measured at the input current of 1.6 mA and 2.0 mA,respectively. The as-fabricated devices are in storage in the lab via indoor air environment for about 12-month.
此外,从测得的电致发光光谱中可以看出,光谱的发光中心波长和半峰宽随着注入电流的增加并没有发生明显的变化,即便是在较大的电流注入情况下,依然如此。这一发光特征表明,异质结器件中的发光耗尽层不会因为注入电流的增加而发生改变。为进一步研究n-ZnO∶Ga MW/p-InGaN异质结发光器件中载流子的传输过程和电致发光的物理机制,我们采用Anderson 能带模型给出了器件在外加正向驱动偏压下的能带结构图,如
根据n-ZnO∶Ga MW/p-InGaN异质结发光二极管的EL光谱,可以计算出制备的单根ZnO∶Ga微米线异质结发光器件在不同注入电流下的色坐标,如
为了更好地证明器件在高电流下的稳定性和发光性能,我们引入了器件的外量子效率(ηEQE),计算公式为
4 结论
本文结合单根ZnO∶Ga微米线和p型InGaN衬底实现了n-ZnO∶Ga MW/p-InGaN低维黄光发光二极管。在正向驱动电流注入下,器件的发光中心波长始终位于580 nm附近,光谱半峰宽约为50 nm,相应的色坐标位于黄色色域,且色坐标值随注入电流的增加变化幅度较小,表明我们制备的n-ZnO∶Ga MW/p-InGaN黄光发光二极管较为稳定。本工作利用ZnO低维微纳结构结合p型InGaN衬底构筑了低维可见光发光器件,为micro-LED和nano-LED的可见光发射器件的设计和发展提供了新思路。
本文专家审稿意见及作者回复内容的下载地址:http://cjl.lightpublishing.cn/thesisDetails#10.37188/CJL.20220171.
[5] 江风益, 刘军林, 张建立, 等. 半导体黄光发光二极管新材料新器件新设备[J]. 物理学报, 2019, 68(16): 168503-1-9.
[6] 赵芳, 张运炎, 宋晶晶, 等. 具有三角形InGaN/GaN多量子阱的高内量子效率的蓝光LED[J]. 发光学报, 2013, 34(1): 66-72.
[17] 郭亮, 郭亚楠, 羊建坤, 等. 量子垒高度对深紫外LED调制带宽的影响[J]. 发光学报, 2022, 43(1): 1-7.
[20] 刘威, 李竹新, 王俊洁, 等. Er3+掺杂对ZnO/GaN发光二极管电致发光性能的调控[J]. 发光学报, 2021, 42(6): 863-870.
[26] PARBROOK P J, CORBETT B, HAN J, et al. Micro-light emitting diode: from chips to applications[J]. Laser Photonics Rev., 2021, 15(5): 2000133-1-18.
[31] 王玮东, 楚春双, 张丹扬, 等. 俄歇复合、电子泄漏和空穴注入对深紫外发光二极管效率衰退的影响[J]. 发光学报, 2021, 42(7): 897-903.
[32] 王润, 贾亚兰, 张月, 等. 基于激子阻挡层的高效率绿光钙钛矿电致发光二极管[J]. 物理学报, 2020, 69(3): 038501-1-10.
徐海英, 刘茂生, 姜明明, 缪长宗, 王长顺, 阚彩侠, 施大宁. 单根镓掺杂氧化锌微米线异质结基高亮黄光发光二极管[J]. 发光学报, 2022, 43(8): 1165. Hai-ying XU, Mao-sheng LIU, Ming-ming JIANG, Chang-zong MIAO, Chang-shun WANG, Cai-xia KAN, Da-ning SHI. High-brightness Yellow Light-emitting Diode in A Single Ga-doped ZnO∶Ga Microwire Heterojunction[J]. Chinese Journal of Luminescence, 2022, 43(8): 1165.



