用于层间耦合的绝热光学倒锥工艺研究
0 引言
硅材料在室温条件下对光具有高的折射率(n=3.42),以硅材料制备的线波导对光有很强的限制作用,使得集成光路的密度得以增加,同时,硅材料具备成熟的制备工艺.因此,硅基集成光路拥有广泛的应用前景.当线波导直接与外部光学元件连接时,线波导与外部元件之间存在有效折射率失配的问题,导致光耦合效率较低.倒锥形绝热耦合器是解决这种光耦合效率较低问题的一种有效手段.这种耦合器要求倒锥的尖端小于100 nm,绝热条件即可实现高效的耦合.MCNAB S J等[1]在2003年,TSUCHIZAWA T等[2]在2005年均成功使用电子束光刻(Electron Beam Lithography,EBL)制备出窄尖端宽度的倒锥结构.但电子束光刻存在成本高、制作周期长和不能满足大规模生产的缺点,严重限制了这种窄尖端宽度倒锥结构的实际应用,因此,如何利用传统光刻的微制造技术制备出这种窄尖端倒锥结构对推动其实际应用具有重要意义.由于传统紫外光刻的分辨率限制,采用传统光刻技术制备100 nm的尖端结构具有很大的挑战性.2012年,TAKEI R等[3]提出了一种使用i-line步进式光刻机经过两次对光刻胶进行图案化的方式,得到了尖端宽度远小于100 nm的锥形结构,经过测试得出传输损耗仅为0.55 dB.2015年,MAEGAMI Y等[4]提出了在Si线波导和SiON二次波导之间插入SiO2间隔物的锥形结构模斑尺寸转换器(Spot-Size Converters,SSC),通过SSC实现了TE模式1.45 dB和TM模式1.50 dB的低损耗,以及光纤到芯片耦合的偏振相关.
Ⅲ/Ⅴ材料在硅材料上的集成一直以来都是一个活跃的研究领域,因为它可以将低损耗的硅无源器件与直接带隙的有源器件(如激光器、探测器和光放大器)相结合,并异质集成和兼容了有源无源芯片本身的材料的优势发挥器件性能的最大化.研究结果表明,异质集成有源器件的性能相比单独的有源器件性能更为优异,因此该技术是解决目前微波光子瓶颈的关键技术.为了将光有效的耦合到波导并传播到光电探测器,2012年,WANG Qian等[5]提出并设计了一种新型Si/Ⅲ-Ⅴ异质集成结构,通过将Ⅲ-Ⅴ半导体层直接键合到绝缘衬底上的硅(Silicon-On-Insulator,SOI)层并被蚀刻以形成多个不同的锥形结构,在100 nm厚的有源区中实现了约24%的光限制,进而实现有效的光放大/吸收.2013年,KURCZVEIL G等[6]设计了两种混合硅锥形结构并研究了其光学特性,通过晶圆键合的方法将硅波导与Ⅲ/Ⅴ波导连接,通过这两种结构成功将光学模式从硅波导转换为混合硅-Ⅲ/Ⅴ波导,并测得两种锥形的损耗测量仅为每锥度0.2~0.5 dB.2016年,KO Y H等[7]实现了一种与横向双锥结构集成的波导光电探测器,该器件采用横向锥形结构,使锥形的有效折射率逐渐变化,实现了0.3 dB的低偏振相关损耗和0.7 A/W的高响应度.因此,开展硅基绝热光学倒锥对Ⅲ/Ⅴ材料在硅材料上的集成具有重要意义和广泛的应用前景.
本文介绍了一种利用步进式光刻机曝光原理,借助回流、干法刻蚀手段,突破光刻机的光刻分辨率极限(500 nm),制备出满足绝热条件、侧壁形貌平整、尖端接近50 nm的短长度光学倒锥结构.
1 层间耦合绝热光学锥理论
光从一个波导向另一个波导传递时,若要得到100%的功率传输,需要完美的光模式匹配,这便要求两个波导的有效折射率相同,且耦合长度恰好等于完成100%功率传输的距离,但实际上耦合长度难以准确确定,而倒锥形绝热耦合器可以很好地解决该问题.倒锥形绝热耦合器无需定义精确功率传输长度,只需要足够的长度来保证绝热条件[8-11].
1.1 光模式匹配原理
对于由两种不同材料组成的传统定向耦合器,由于不同材料的有效折射率不同而导致两个波导的折射率不匹配,因此需要精确设计两个波导的尺寸,从而达到波导之间折射率匹配的目的.但在实际生产中,尺寸稍有变化就会导致折射率匹配无法实现.倒锥形具有较小的线性斜率可使波导宽度缓慢减小,以确保光学模式的绝热演变,随着波导宽度的减小,有效折射率会减小[12-15].
当在波导1中引入一个锥形结构,随着波导宽度的减小有效折射率n1随之减小,并与波导2的有效折射率n2在某一点处相等,如
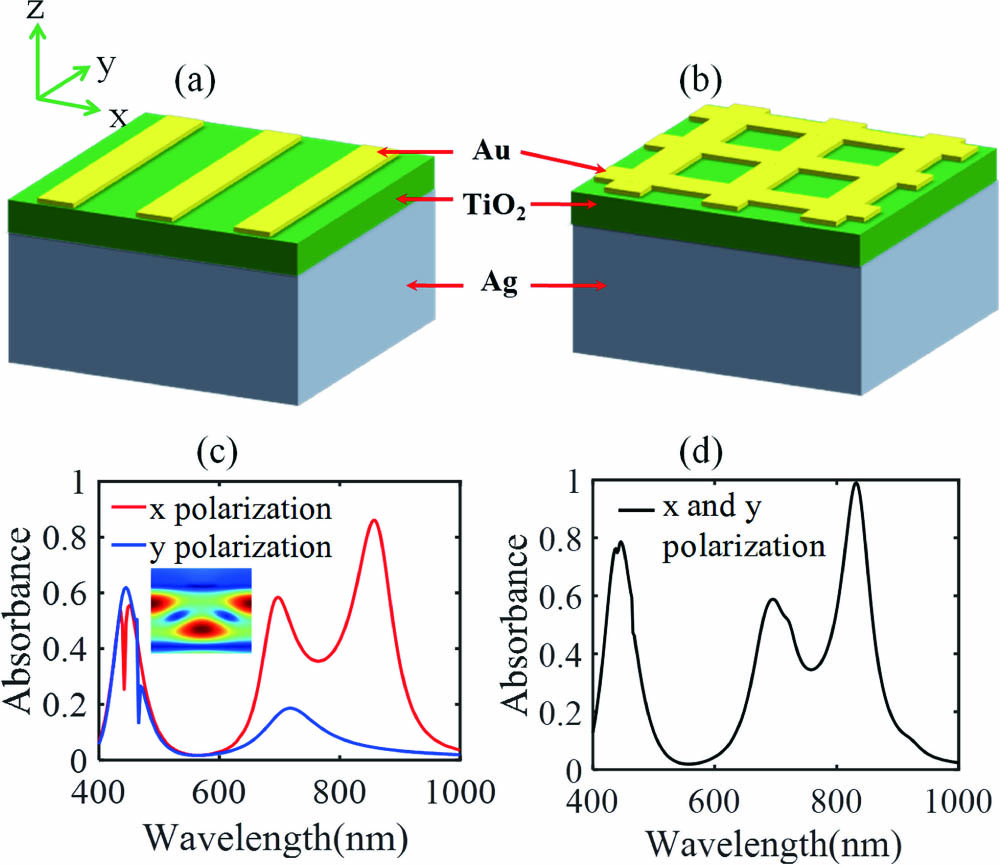
图 1. 有效折射率随波导宽度变化Effective refractive index varies with waveguide width
Fig. 1. 有效折射率随波导宽度变化Effective refractive index varies with waveguide width
1.2 光学绝热条件
满足绝热条件的锥形结构可以改变光学模式的尺寸和形状,使两个具有不同横截面的波导之间实现高效率的耦合.绝热条件要求锥形横截面的尺寸非常缓慢地增加/减小,因此绝热锥形通常都有较长的长度,而较长的锥形会降低设备密度并导致更多的传输损耗.为了实现光子芯片低损耗、高密度的集成,有效地压缩光学倒锥的长度十分关键.
实现短长度的绝热锥形需要满足条件[16]
式中,α为引入的一个常数,θ为锥形尖端的半角(θ<90°),λ0为真空中的波长,neff为模式的有效指数,W为锥形的宽度.当1≤α≤1.4时,锥形可以实现98%以上的高透射率.并且当锥形的宽度W固定,随着α的增大,锥形的半角θ也会增大,因此锥形的长度会随之逐渐减小.
用于层间耦合的光学倒锥不但需要满足绝热条件,尖端的宽度同样也需要注意.在两层结构中存在过渡损耗和交叉串扰,低的过渡损耗需要两个波导彼此接近,而低的交叉串扰则需要两个波导尽量远离,因此难以选择适当的层间距离.但拥有窄尖端的光学倒锥可以有效地避免串扰,从而有效降低层间距离,因此更适合当前高度集成化的要求.此外窄尖端的光学倒锥还可以有效减少回波的产生,提供高效、偏振不敏感和宽带宽的光学耦合.
基于上述理论,倒锥形绝热耦合器可以简单而又高效地实现层间耦合.因此对于尖端小于100 nm,横截面尺寸为4 μm×0.22 μm的锥形,其长度为50 μm时,即可满足绝热条件.
2 实验方案
本实验中选用步进式I7光刻机进行最小线宽接近50 nm的倒锥结构的光刻,光刻后采用深硅干法刻蚀对SOI片进行刻蚀制备出倒锥结构,这种制备方法具有成低本、制作周期短、可大规模制备等优势,对窄尖端倒锥结构的应用有推动作用.
选用S1805型光刻胶以旋涂的方式作为掩膜层.由于所制备的锥形尖端宽度接近50 nm,而常见的AZ系列光刻胶最小厚度均在1 μm以上,过大的纵横比会对后续工艺产生不利影响.而S1805型光刻胶在经过前烘后最低厚度可以达到500 nm以下,适合于本实验.
本实验利用步进式I7光刻机的步进功能通过两次对光刻胶进行图案化得到所需锥形.首先对掩膜版进行对准,将掩膜版固定在掩膜台上,掩膜台带动掩膜版进行移动,通过同轴对位系统与掩膜版上的标记信号,掩膜版的中心与投影镜头中心同轴对准,并且之后掩膜版不再移动.其次将旋涂好光刻胶的SOI片送入光刻设备,样品会低速旋转,通过机械和激光来定位样品中心及切边的位置,再送入到样品台,使样品与投影镜头中心同轴对准.经过光刻板与样品分别对准后,开始进行曝光实验,步骤如下:1)设定如
![Schematic pattern and experimental flow diagram [Fig.(g)~(i)corresponds to Fig.(d)~(f)side view (only shows tip changes)]](/NV_LEGCY/images/figure.jpg)
图 2. Schematic pattern and experimental flow diagram [Fig.(g)~(i)corresponds to Fig.(d)~(f)side view (only shows tip changes)]
Fig. 2. Schematic pattern and experimental flow diagram [Fig.(g)~(i)corresponds to Fig.(d)~(f)side view (only shows tip changes)]
为探究分析倒锥结构的制备结果,利用扫描电子显微镜(Scanning Electron Microscope,SEM)对锥形结构进行观察并对刻蚀结果进行分析.
3 结果与分析
3.1 光学倒锥的侧壁形貌研究
在光子学中平滑的侧壁通常被用于低损耗波导中.在光刻工艺后,光刻胶侧壁的不平滑会对下一步的刻蚀工艺带来不利影响[17-19].通过短时间热回流处理的方法,可以实现平滑的侧壁.光刻胶回流处理是针对粘弹性材料的粘度随时间-温度而改变的特性所提出的处理方法,该过程可理解为光刻胶的蠕变过程,蠕变由能量的不平衡而驱动.重力和光刻胶表面张力,导致了尖角、不平整的产生,热回流处理打破了光刻胶内部最初的能量平衡状态,迫使其发生蠕动来消除尖角,使其表面变得更加圆润从而达到降低表面粗糙度的作用.在经过回流处理后,光刻胶不均匀处将会变得平整.但过度的回流会导致光刻胶结构变形,因此设置合理的回流温度和时间极为重要.通过设计不同回流温度和时间的4组实验,对回流时间与温度对光刻胶的不平整以及分层的影响进行研究,所设计4组实验参数如
表 1. 所选实验参数
Table 1. Selected experimental parameters
|
不同回流温度和回流时间对光刻胶几何形状的影响,可以通过分层现象的缓解程度以及边缘平滑度的变化来判断.通过SEM对样品进行观察,
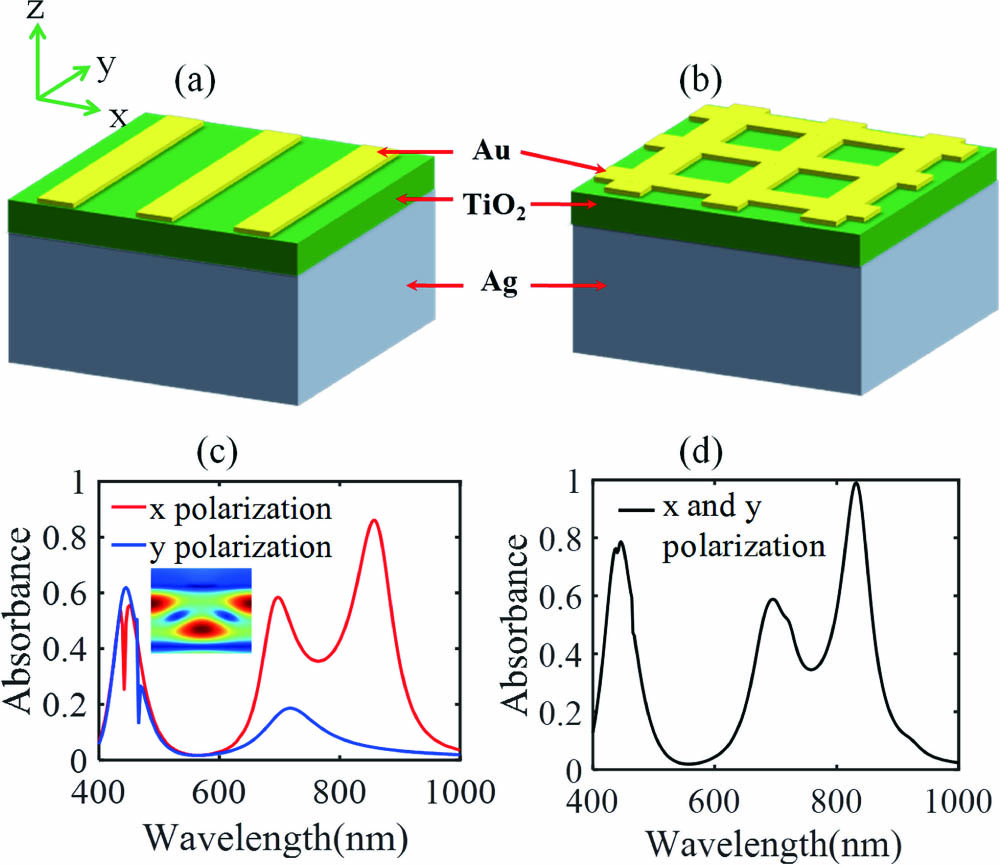
图 3. 不同回流温度、回流时间对光刻胶的影响(每组显示锥形尖端部和末尾部的分层现象)Effect of different reflow temperatures and reflow times on the photoresist (Each group shows the stratification of the tapered tip and tail)
Fig. 3. 不同回流温度、回流时间对光刻胶的影响(每组显示锥形尖端部和末尾部的分层现象)Effect of different reflow temperatures and reflow times on the photoresist (Each group shows the stratification of the tapered tip and tail)
从
3.2 光学倒锥尖端宽度
对经回流处理的样品采用深硅刻蚀,将光刻胶上图案转移到SOI片上.深硅刻蚀具有污染小、刻蚀损伤小、精度高、均匀性好、陡直度好、刻蚀断面轮廓可控性高和刻蚀表面平整光滑等优势.其基本原理是,在真空低气压下,ICP射频电源产生的射频输出到环形耦合线圈,以一定比例的混合刻蚀气体经耦合辉光放电产生高密度的等离子体;在下电极的RF射频作用下,这些等离子体对基片表面进行轰击,使基片图形区域的半导体材料的化学键被打断,并与刻蚀气体生成挥发性物质,以气体形式脱离基片,从真空管路被抽走[20-23].
为实现较好平整度的光学倒锥结构的制备,刻蚀气体选择SF6、C4F8、O2.刻蚀气体中SF6是主要的刻蚀气体,C4F8可以在SOI片表面产生保护层,有效降低刻蚀侧壁的粗糙度O2为辅助刻蚀气体,对图案化效果、刻蚀选择比会产生影响.
SEM测试结果如
4 结论
窄尖端的光学倒锥可有效地降低过渡损耗和交叉串扰带来的损耗,并提供高效、偏振不敏感和宽带宽的光学耦合,但光学倒锥窄尖对制备工艺是一个极大的挑战.本文中使用步进式光刻机,通过两次对同一光刻胶进行图案化处理,突破其500 nm的分辨率极限,得到了接近50 nm的超窄尖端.在进行SEM观察时,发现光刻胶发生分层以及形貌不平整现象,采用160 ℃持续105 s的热回流处理手段,成功解决了该问题,并使锥形平整性得到了改善.在深硅刻蚀过程中,通过对不同气体流量调控,选定合适的刻蚀选择比,使刻蚀结果实现了较好的平整性和均匀性,制备出了尖端接近50 nm的短长度绝热光学倒锥.该研究解决了传统电子束光刻的制作周期长、成本高、不易大量生产等问题,为更高效地实现层间耦合奠定基础.
[7] KO Y H, CHOE J S, HAN W S, et al. Low polarization dependent loss of InPbased waveguide photodetect integrated with spotsize converter f 100Gbs coherent receiver[C]. Optical Components Materials XIII, International Society f Optics Photonics, 2016, 9744: 16.
[15] HOFRICHTER J, CZNOMAZ L, HST F, et al. A modeengineered hybrid ⅢⅤonsilicon photodetect[C]. 2015 European Conference on Optical Communication (ECOC), IEEE, 2015, 7341915: 13.
[22] BELLEGARDE C, PARGON E, SCIANCALEPE C, et al. Improvement of sidewall roughness of submicron silicononinsulat waveguides f lowloss onchip links[C]. Silicon Photonics XII, International Society f Optics Photonics, 2017, 10108: 16.
刘俊成, 孙天玉, 贾慧民, 王筱, 唐吉龙, 房丹, 方铉, 王登魁, 张宝顺, 魏志鹏. 用于层间耦合的绝热光学倒锥工艺研究[J]. 光子学报, 2019, 48(12): 1223003. Jun-cheng LIU, Tian-yu SUN, Hui-min JIA, Xiao WANG, Ji-long TANG, Dan FANG, Xuan FANG, Deng-kui WANG, Bao-shun ZHANG, Zhi-peng WEI. Process Research of Optical Inverted Cone for Interlayer Coupling[J]. ACTA PHOTONICA SINICA, 2019, 48(12): 1223003.



