基于差分进化算法的光刻机匹配方法  下载: 1394次
下载: 1394次
1 引言
光刻机是极大规模集成电路制造的关键设备[1]。光刻分辨率是光刻机的关键技术指标之一[2]。分辨率增强技术(RET)是增强光刻机分辨率的有效手段,其中光学邻近效应校正(OPC)、亚分辨率辅助图形(SRAF)、光源掩模联合优化(SMO)是常用的光刻机分辨率增强技术[2]。为降低成本、缩短研发周期,在工艺研发阶段,通常只针对一台参考光刻机利用RET获得实际生产所需要的掩模图形、照明光源、光刻机参数、工艺参数等配置。完成工艺验证后,将优化后的掩模及对应的工艺参数应用到整个生产过程中[3]。在实际生产过程中,一种工艺通常由多台甚至是多种型号的光刻机共同参与完成[4]。不同光刻机的光学临近效应(OPE)存在差异,这些差异导致关键尺寸均匀性(CDU)降低并使得工艺窗口(PW)缩小[5]。而针对每台光刻机单独应用RET成本太高,因此需要对光刻机的曝光系统进行匹配,即通过对光刻机可调参数的微调,保证多台光刻机曝光性能一致。通过光刻机匹配,在使用针对参考光刻机的RET方案生成的掩模时,多台光刻机曝光后图形的关键尺寸(CD)与参考光刻机保持一致。
光刻机匹配技术分为基于CD测量的匹配技术和基于模型的匹配技术[6]。基于CD测量的光刻机匹配技术采用测量的硅片上光刻胶CD数据(临近效应曲线,即线宽随周期变化的曲线)表征光刻机之间的差异,并计算CD对光刻机可调参数的灵敏度及调整值。该技术需要占用较多的光刻机时间和测量时间。基于模型的匹配技术利用光刻机模型与工艺模型计算光刻机差异。He等[7]提出基于光学模型的光刻机匹配技术。基于光学模型的匹配技术利用光刻机光学模型进行可调参数的计算,不需要耗时的CD测量,避免了测量噪声和光刻胶模型标定误差对匹配精度的影响,是大规模生产环境中常用的技术。匹配中可调参数项主要包括数值孔径(NA)、曝光剂量、离焦量、照明光源和波像差,其中照明光源具有较大的优化自由度。基于微反射镜阵列(MMA)的光刻照明系统提供了低成本、可编程的自由照明光源,已应用于ASML公司NXT系列机型中[8],因此光源优化成为了光刻机匹配的重要技术[9]。但当现有光源优化技术直接应用于光刻机匹配时,匹配算法输出光源后还需采用镜片分配算法(MAA)计算照明系统的参数,该过程会引入额外误差,降低了匹配效果[10]。此外,匹配算法计算梯度较为困难,高精度的光源模型参数较多,对光源优化算法提出了一定要求。其中基于遗传算法(GA)和粒子群优化(PSO)算法的光源优化技术[11-12]虽然可以直接应用于光刻机匹配,但仍存在优化结果较差或收敛速度较慢的问题。
本文提出一种光刻机匹配方法,采用差分进化(DE)算法对基于MMA模型的光源进行优化,实现光刻机的匹配。将MMA生成过程添加至匹配方法中,通过直接优化MMA照明系统参数能有效减小MMA产生照明光源的过程导致的匹配误差,提高了光刻机匹配的精度。此外将DE算法应用于匹配问题,无需参数转换与编码、计算梯度和海森矩阵,进化方法明确,能进一步改善优化结果,提高收敛速度。本文分别在四极照明和自由照明条件下,针对一维线空图形的匹配进行数值仿真,验证了本文方法的有效性。
2 基本原理
2.1 自由照明光源模型
基于MMA的光刻照明系统可以实现自由形式的照明[13],为进一步提高光刻机分辨率提供了硬件基础。基于MMA的照明系统的光源调制原理如
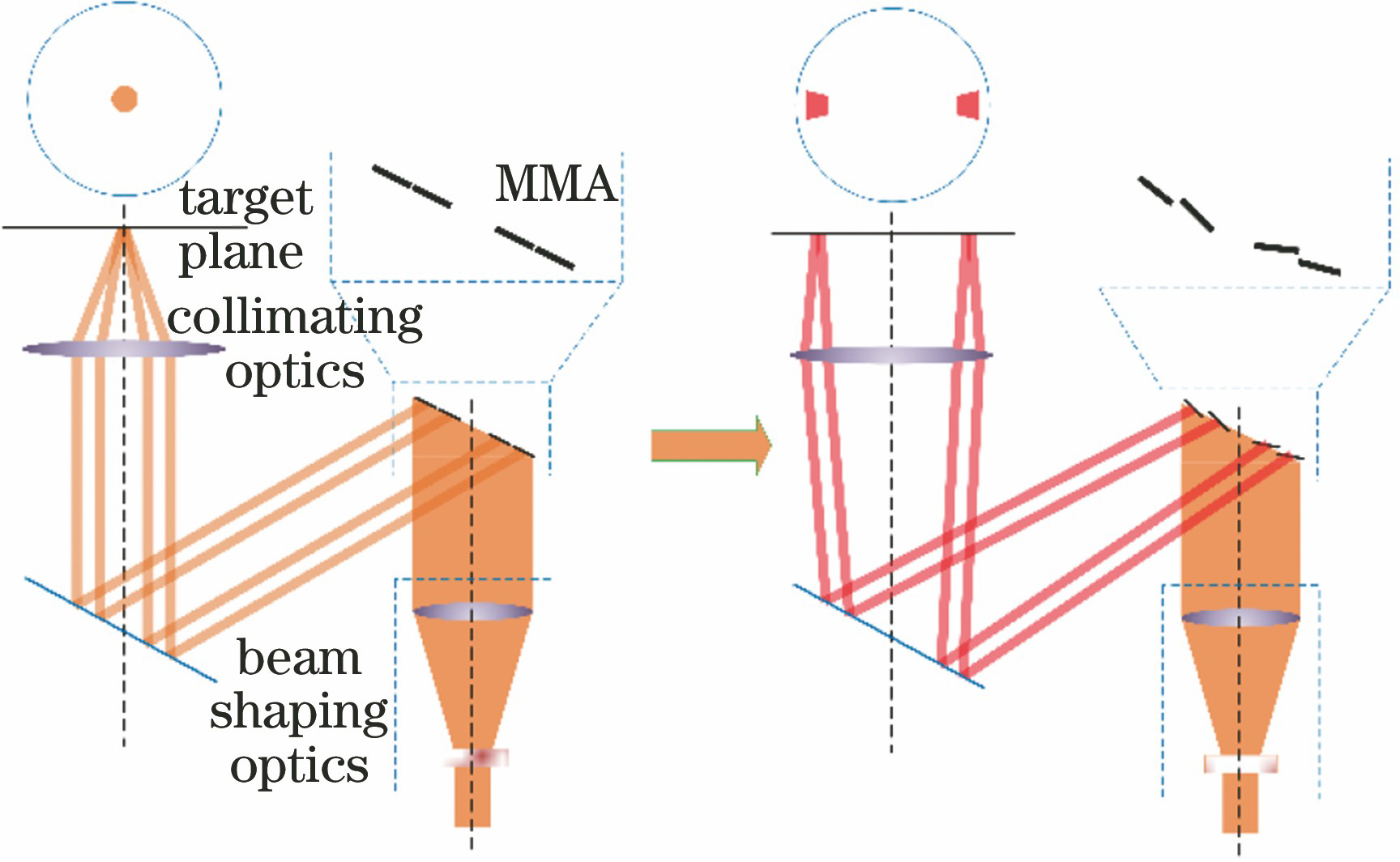
图 1. 基于MMA的自由照明光源系统示意图
Fig. 1. Schematic of freeform illumination source system based on MMA
基于MMA的照明系统光瞳面光强分布可以看作是不同微反射镜产生的光斑叠加,即
式中:(f,g)为归一化空间频率坐标;Nmirror为微反射镜数量;

图 2. 基于MMA的自由照明光源模型示意图。(a)单个微反射镜生成的光斑;(b) MMA生成的理想光源;(c)目标光源
Fig. 2. Schematic of freeform illumination source model based on MMA. (a) Light spot formed by single micro mirror; (b) ideal source formed by MMA; (c) target source
为防止光学元件损伤,光强应受到一定限制,即
式中:Smax为最大强度。对光强进行归一化,即
式中:
式中:P为有效光瞳,即光瞳面上满足f2+g2≤1的区域。将 (3)式代入(4)式可得
由于微反射镜反射形成的光斑强度及分布的调制主要通过调整光源激光器及光束整形单元的参数实现,因此对于单个微反射镜,仅改变微反射镜偏转角度时可认为其反射的总光强不变,则有
式中:Imirror为总光强;
(7)式表明,MMA反射产生的总光强Imirror与PFR线性相关,因此通过改变激光器及光束整形单元参数来调整Imirror,即可有效调整照明系统的PFR。PFR较小的光源引起的热像差较大,会降低成像性能;而PFR较大的光源通常工艺窗口较小,因此在光刻机匹配中应当对待匹配( TBM)光刻机的PFR进行一定的控制[14]。
对于采用MMA的照明系统,为生成指定的光源形状,需要采用镜片分配算法,利用上述模型并根据照明系统光学设计计算每个镜片的倾角。ASML公司采用随机翻转法生成MMA倾角参数[8],Wei等[15]提出基于模拟退火(SA)的镜片分配算法。由于生成的光源与目标光源存在差异,该差异会引入额外的CD误差,影响匹配效果,Flagello等[10]的研究结果表明,光源的差异与CD误差呈正相关。
2.2 差分进化算法
DE算法由Storn等[16]于1996年在电气和电子工程师协会国际进化计算大会上提出,是一种有效的参数全局优化算法。DE算法的基本流程与GA类似,包括种群初始化和迭代进化两部分。初始化完成后,进入迭代流程,迭代流程包括变异、交叉和选择。为提高DE算法的性能,研究人员提出了多种自适应DE算法,其中由Zhang等[17]提出的一种自适应差分进化算法(JADE)是目前公认的性能较好的DE算法,JADE算法的主要步骤如下。
1) 变异:对于第w代种群,从该代种群{xi,w|i=1,2,…,Npop}中通过变异算子生成变异向量vi,w,其中x为个体对应的向量,Npop为种群规模,i为种群个体序号。JADE算法提出DE/current-to-p-best/1的变异算子,即
式中:xbestp,w为目标函数F(·)较小的前p×100%的个体中随机选取的个体;r1和r2为随机选取的小于等于Npop的互不相同的正整数;ωi为缩放因子。ωi可表示为
式中:randc(·)为服从柯西分布的随机变量;μω为控制参数。ω>1的部分截断置为1,ω<0的部分重新生成。
2) 交叉:DE算法采用一种二进制的交叉操作算子生成测试向量ui,w,即
式中:rand(·)为服从均匀分布的随机变量;uj,i,w为向量ui,w的第j个数;jrand=randinti(1,D)为1到D之间随机生成的整数;CR,i∈(0,1]为交叉概率。CR,i可表示为
式中:randn(·)为服从正态分布的随机变量;μCR为控制参数。交叉概率决定了测试向量从变异向量继承的平均块大小,
3) 选择:将父向量xi,w和测试向量ui,w中目标函数F(·)较优的向量作为下一代种群的个体。对于最小化问题,最终选取的子代向量为
并且将该向量作为下一代种群的父向量。如果实验向量ui,w的目标函数优于父向量xi,w,则此时称为成功的更新。
算法控制参数μCR和μω在每代种群迭代完成后进行更新,即
式中:c∈[0,1]为常数;meanA(·) 为算数平均数;SCR为该代种群成功更新的向量对应的参数CR的集合;μCR的初始值为0.5。
式中:Sω为该代种群成功更新的向量对应的参数ω的集合;μω的初值为0.5。meanL(·)为Lehmer平均数,即
2.3 基于差分进化算法的光刻机匹配方法
光刻机匹配[9]定义为
式中:arg
CD差异的最大值为
式中: REF表示参考光刻机;TBM表示待匹配光刻机;CTBM、CREF分别为TBM光刻机和参考光刻机仿真像CD值;Nfeature为匹配的目标掩模数量;j'为掩模序号。
根据2.1节所述,MMA模型的光源可用微反射镜光斑在光瞳的理想强度分布
式中:
式中:
2.3节所述的光源模型无法对光瞳范围内光强最大值直接进行限制,对此本文提出一种惩罚函数项对光强最大值进行限制,即添加了惩罚函数项的目标函数,即
式中:F为(17)式或(18)式所述的目标函数,当光源最大值超过Smax后,惩罚项随光源最大值的增加而迅速增长,因此该项可以有效限制光源的最大值。此外,目标函数中没有需要调整的参数项。
基于DE算法的光刻机匹配流程如

图 3. 基于DE算法的光刻机匹配流程图
Fig. 3. Matching flowchart of lithography machine based on DE algorithm
3 仿真实验
采用光刻机的临近效应曲线验证本文方法的有效性。光刻模拟结果与光刻机曝光实验的CD差异显著小于光刻机差异引起的CD差异[18],表明经过标定后的光刻模型可用于表达光刻机及光刻工艺,因此本节采用数值模拟计算TBM光刻机的光源参数并对结果进行评估。实际匹配流程中需要将生成的TBM光刻机光源参数输入光刻机,采用测试掩模进行曝光实验,进一步验证光刻机匹配的结果,典型的光刻机匹配曝光实验流程如参考文献[ 9]所述。
光刻机的工作波长λ=193.368 nm,投影物镜放大倍率为0.25,数值孔径为1.35,浸液折射率为1.44。参考光刻机采用
表 1. 四极照明匹配模拟结果
Table 1. Simulation results under quasar illumination matching
|
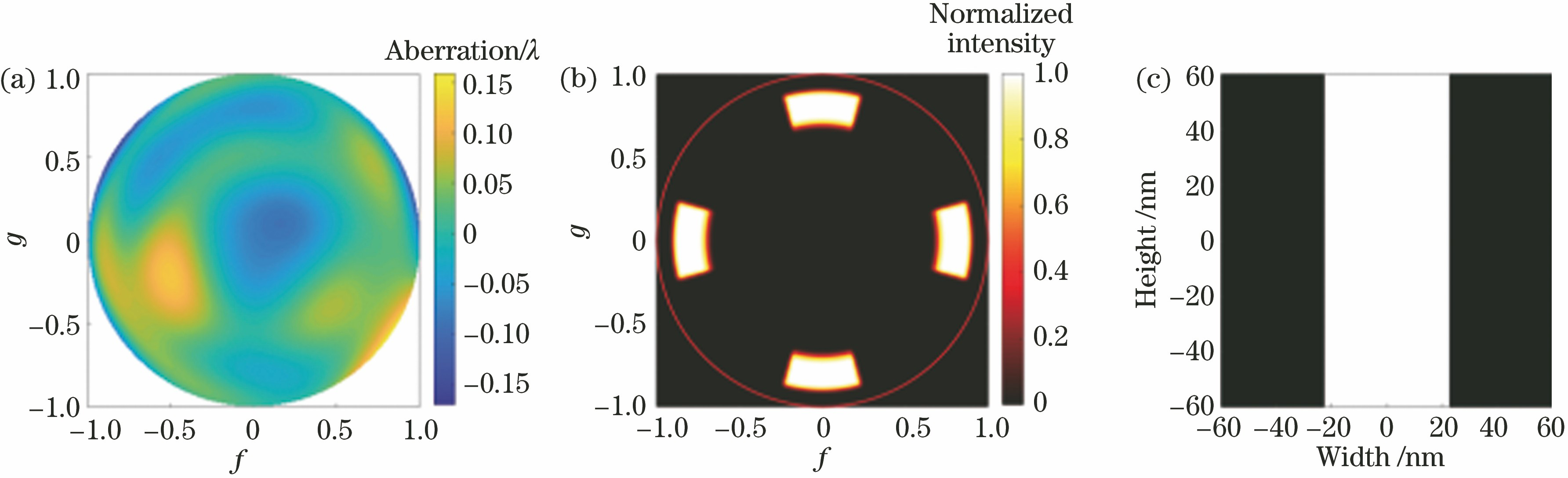
图 4. 光刻机匹配的部分设置。(a) TBM光刻机波像差;(b)四极照明参考光源;(c) CD为45 nm的一维线空掩模
Fig. 4. Partial settings of lithography matching. (a) Wave aberration of TBM lithography; (b) reference source of quasar illumination; (c) one-dimensional line/space mask with 45 nm CD
表 2. 自由照明匹配模拟结果
Table 2. Simulation results under freeform illumination matching
|
引起光刻机成像差异的因素有激光器光谱带宽、投影物镜波像差、振动、剂量、离焦量、光源形状等[9]。其中激光器光谱带宽和振动水平在光刻机投入使用时已经确定,影响较小且长期稳定性较好,因此在仿真中可忽略其影响。剂量和离焦量的影响同样较小,且可单独进行匹配,仿真中采用最佳焦面的归一化光强进行匹配以排除剂量和离焦量的影响。由于投影物镜设计的差异及热效应等因素的影响,波像差对成像的影响较大[9,20]。此外,随着光刻机的使用,投影物镜中光学材料的折射率和镀膜的厚度会发生变化[21],且该现象引起的波像差通常不易补偿。本节仿真通过投影物镜波像差产生光刻机成像之间的差异,用于验证匹配效果。TBM光刻机投影物镜波像差Z5-Z37项在[-30λ×10-3,30λ×10-3]内随机生成,投影物镜光瞳相位分布如
式中:σr=0.03,实际应用中需要根据光刻机照明系统的设计与实测照明光瞳确定光斑函数的具体形式及参数。MAA采用文献[ 15]提出的基于SA的镜片分配算法。MMA重构光源与匹配目标光源的差异采用光源差值的RMS进行描述[10],即
式中:Nsample为光源采样点的数量;Sreal(f,g)、Starget(f,g)分别为实际光源和目标光源强度分布。Imirror的范围设定为参考光源的90%~110%,即匹配后光源的PFR为参考光源的90%~110%。
采用基于PSO-SA的匹配方法生成的光源如

图 5. 基于PSO-SA的匹配方法匹配后的照明光源。(a)经光源优化生成的光源;(b)通过MAA生成参数后重构的光源;(c) SO优化光源和MAA生成光源的差异
Fig. 5. Illumination source after matching based on PSO-SA. (a) Source after source optimization; (b) source reconstructed after generating parameters through MAA; (c) difference between SO optimization source and source generated by MAA

图 6. PSO优化前后CD误差随图形周期的变化曲线
Fig. 6. CD error versus pitch before and after PSO optimization

图 7. 匹配后的照明光源。(a)基于GA-SA匹配后的重构光源;(b)采用本文方法匹配后的光源;(c) MMA理想光源分布
Fig. 7. Illumination source after matching. (a) Source reconstructed by GA-SA matching; (b) source after matching by proposed method; (c) MMA ideal source distribution

图 8. 匹配前后CD误差随图形周期的变化。(a) H方向;(b) V方向
Fig. 8. CD error versus pitch before and after matching. (a) H direction; (b) V direction
由于三种方法具有类似的特性,计算时间主要取决于目标函数的调用次数,且目标函数中成像仿真开销远大于算法本身,因此采用CD误差RMS值与评价函数调用次数的关系分析不同方法的性能。三种匹配方法的光源优化部分的收敛曲线如
为进一步验证本文算法的有效性,采用自由照明光源进行验证,参考自由照明光源采用SMO生成,如

图 10. 匹配前后的光源。(a)自由照明参考光源;(b) GA-SA方法匹配后的光源;(c) PSO-SA方法匹配后的光源;(d)本方法匹配后的光源
Fig. 10. Sources before and after matching. (a) Reference source of freeform illumination; (b) source after matching by GA-SA; (c) source after matching by PSO-SA; (d) source after matching by proposed method
4 结论
提出一种用于含有微反射镜阵列的自由照明系统的光刻机性能匹配方法。与通常用于自由照明系统的光刻机匹配方法相比,本方法能直接优化微反射镜阵列参数,有效减小了在微反射镜阵列产生照明光源的过程中出现的匹配误差。仿真结果表明,四极照明和自由照明条件下,匹配后一维线空图形的CD误差的RMS值分别下降了约90%与80%,且在生成照明系统参数时不引入额外误差。与基于遗传算法和粒子群算法光源优化的匹配方法相比,本文方法在获得更好的匹配效果同时,具有较快的收敛速度。此外,采用本文方法匹配后光源的光瞳填充比例与参考光源一致。
[1] Semiconductor industryassociation. 2015 international technology roadmap for semiconductor (ITRS)[R]. Washington, D.C.: SIA, 2015.
[2] MackC. Fundamental principles of optical lithography[M]. UK: John Wiley & Sons, Ltd, 2007: 419- 449.
[4] Armellin L P, Torsy A, Hernan K, et al. Illumination conditions matching for critical layers manufacturing in a production context[J]. Proceedings of SPIE, 2006, 6154: 61543V.
[9] He Y, Serebryakov A, Light S, et al. A study on the automation of scanner matching[J]. Proceedings of SPIE, 2013, 8683: 86830W.
[12] 王磊, 李思坤, 王向朝, 等. 基于粒子群优化算法的光刻机光源优化方法[J]. 光学学报, 2015, 35(4): 0422002.
[13] Zimmermann J, Gräupner P, Neumann J T, et al. Generation of arbitrary freeform source shapes using advanced illumination systems in high-NA immersion scanners[J]. Proceedings of SPIE, 2010, 7640: 764005.
[14] Lai K, Rosenbluth A E, Bagheri S, et al. Experimental result and simulation analysis for the use of pixelated illumination from source mask optimization for 22 nm logic lithography process[J]. Proceedings of SPIE, 2009, 7274: 72740A.
[16] StornR, PriceK. Minimizing the real functions of the ICEC'96 contest by differential evolution[C]//Proceedings of IEEE International Conference on Evolutionary Computation, May 20-22, 1996, Nagoya, Japan. New York: IEEE, 1996: 842- 844.
[17] Zhang JQ, Sanderson AC. JADE: self-adaptive differential evolution with fast and reliable convergence performance[C]//2007 IEEE Congress on Evolutionary Computation, September 25-28, 2007, Singapore. New York: IEEE, 2007: 2251- 2258.
[19] Wong A KK. Optical imaging in projection microlithography[M]. Bellingham: SPIE Press, 2005: 151- 155.
茅言杰, 李思坤, 王向朝, 韦亚一. 基于差分进化算法的光刻机匹配方法[J]. 光学学报, 2019, 39(12): 1222002. Yanjie Mao, Sikun Li, Xiangzhao Wang, Yayi Wei. Lithographic Tool-Matching Method Based on Differential Evolution Algorithm[J]. Acta Optica Sinica, 2019, 39(12): 1222002.









