有源区Be掺杂对1.3 μm InAs量子点激光器性能的影响
1 引言
自组织量子点具有与原子近似的分立能级和类δ函数的态密度,表现出独特的光学和电学特性,近年来受到人们的广泛关注[1-3]。量子点激光器具有低阈值电流密度、高特征温度、高增益分布、大调制带宽和长寿命等优点,展现出比量子阱激光器更加优越的性能[4-10]。与量子阱相比,量子点对位错的敏感度也大大降低。位错在穿透量子阱或块状材料时,容易产生大量的非辐射复合中心。然而,对于量子点而言,穿透位错只能破坏几个量子点而不影响其他量子点,因此基于量子点器件的性能不会显著降低[11-13]。InAs/GaAs量子点激光器是目前研究最为广泛的半导体量子点发光器件之一,它可以实现不含磷化物、氮化物和锑化物的1.3 μm重要光纤通信窗口的激射,在光通讯应用中具有很大潜力。InAs和GaAs两种单晶的晶格失配为7.2%,因此在GaAs上生长InAs易于实现 Stranski-Krastanov(SK)生长模式[14],并且InAs量子点材料与GaAs材料体系的兼容性好。自1994年第一个基于应变自组装生长模式的 InAs/GaAs量子点激光器研制成功以来[15],在器件性能和工作波长范围的研究都取得了长足的进步。近年来,InAs量子点在单光子领域的应用也取得了重要进展[16]。
利用分子束外延(MBE)技术在GaAs上直接生长InAs量子点很难把量子点发光波长拓展至1.3 μm[17]。有源区采用InAs DWELL(dot-in-well)结构减小了量子点周围的势垒和应力分布,可以将InAs量子点的发光波长拓展至1.3 μm。InAs量子点激光器的性能受到很多方面的影响,因此对生长条件的优化是很重要的一环。目前对不同的生长温度、量子点厚度、有源区层数、In生长速率等已经有了很多的研究[18-20],但是对有源区掺杂的研究还较少。有源区掺杂对激光器性能有很大影响,对其进行细致研究很有必要。
本文利用分子束外延技术在GaAs衬底上生长了不同的InAs DWELL量子点激光器结构。研究有源区Be掺杂对激光器性能的影响,结果表明对有源区进行Be掺杂可以有效降低InAs量子点激光器的阈值电流密度,提升激光器的输出功率,增加激光器的温度稳定性。
1 实验
使用DCA固态源III-V分子束外延系统在4英寸n+ GaAs(100)衬底上生长了InAs量子点激光器结构,激光器结构示意图如
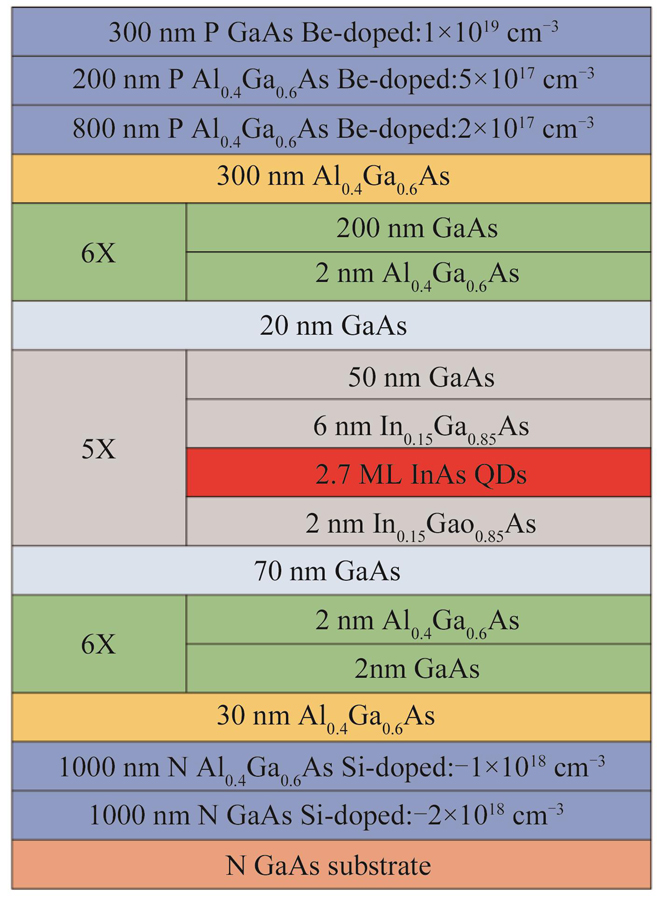
图 1. GaAs基InAs量子点激光器结构示意图
Fig. 1. The schematic diagram of GaAs based InAs quantum dot laser structure
GaAs基InAs量子点激光器的工艺采用标准的光刻和刻蚀工艺。刻蚀至有源区上层的GaAs波导层制作脊条,然后沉积200 nm的SiNx。继续在脊条上的上电极GaAs接触层用反应离子刻蚀(RIE)去掉SiNx开好窗口,沉积Ti/Pt/Au形成P型欧姆接触,然后将GaAs衬底减薄至150 μm,沉积GeAu/Ni/Au后退火形成N型欧姆结接触。
2 结果与讨论
GaAs基未掺杂和Be掺杂InAs量子点激光器材料的光致荧光谱(PL)测试结果如

图 3. GaAs基未掺杂和Be掺杂InAs量子点激光器的PL光谱,插图:InAs量子点2×2 µm2 AFM图像
Fig. 3. The PL spectra of GaAs-based undoped and Be-doped InAs quantum dot lasers,Inset:a 2×2 µm2 AFM image of InAs quantum dots
为了检验生长的量子点结构的质量,我们在生长量子点激光器材料时生长了InAs量子点结构测试片,测试片在生长 InAs DWELL结构后,在表面沉积了一层InAs 量子点用于原子力显微镜(AFM)的测试。有源区Be掺杂对表面的量子点影响不大,量子点形貌与大小没有明显区别,
典型GaAs基未掺杂和Be掺杂InAs量子点激光器的IVP曲线如
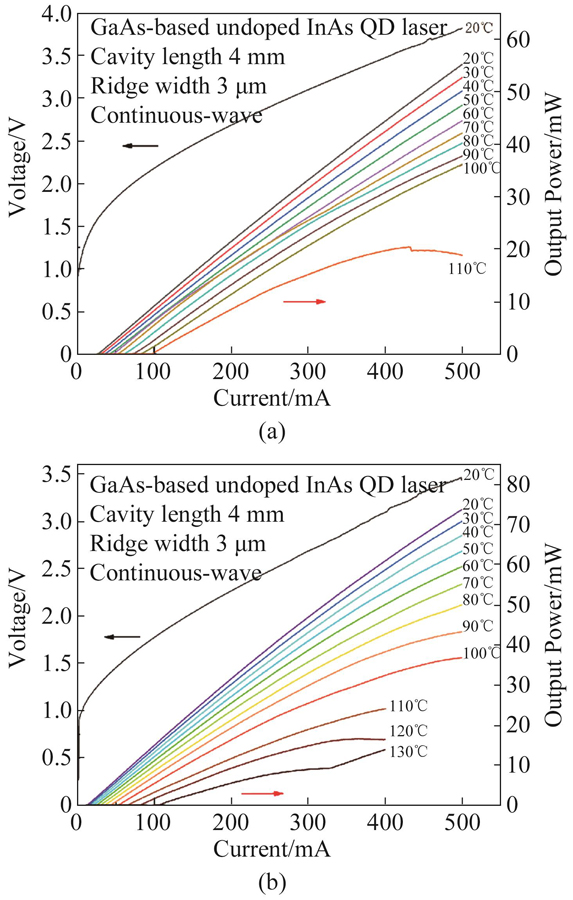
图 4. 连续工作模式下GaAs基InAs量子点激光器的IVP特性曲线:(a)未掺杂,(b)Be掺杂
Fig. 4. The IVP characteristic curves of GaAs-based InAs quantum dot laser in CW mode:(a)undoped,(b)Be-doped
对腔长为4 mm,脊条宽度分别为10 μm和50 μm的两种不同的激光器进行了最大输出功率的测试,测试结果如
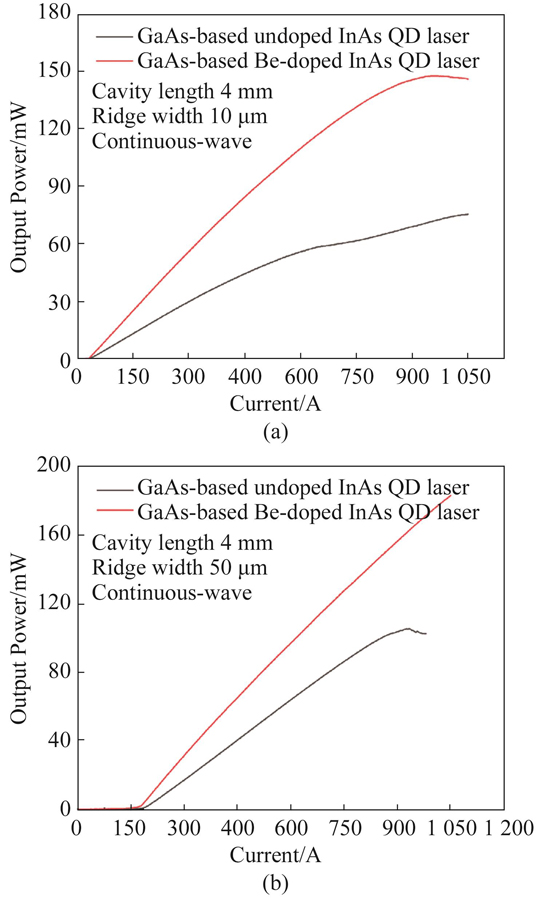
图 5. 连续工作模式下不同条宽GaAs基InAs量子点激光器的IP特性曲线:(a)10 μm,(b)50 μm
Fig. 5. The IP characteristic curves of GaAs-based InAs quantum dot laser with different ridge widths in CW mode:(a)10 μm,(b)50 μm
InAs量子点激光器具有良好的温度稳定性,在温度20 ℃下激光器发射光谱随注入电流的变化如
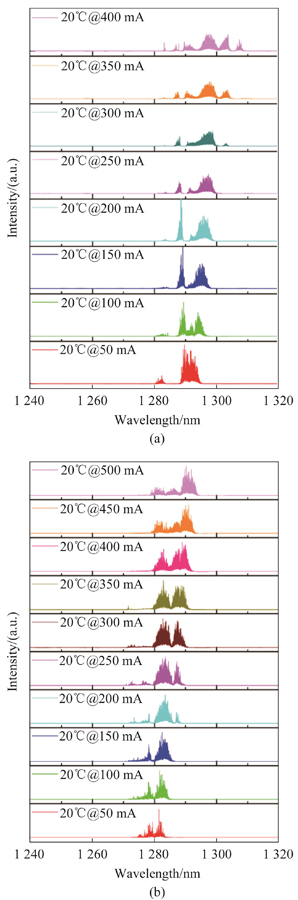
图 6. 20 ℃时GaAs基InAs量子点激光器发射光谱随注入电流的变化:(a)未掺杂,(b)Be掺杂
Fig. 6. The emission spectra of GaAs-based InAs QD laser with different injection currents at the temperature of 20 ℃:(a)undoped,(b)Be-doped
在注入电流为350 mA时量子点激光器的发射光谱随温度的变化如
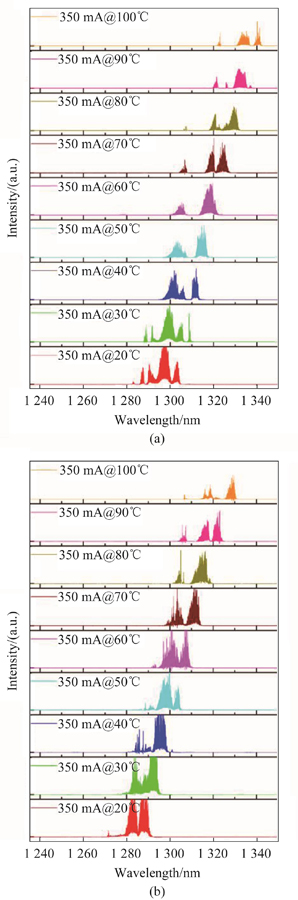
图 7. 注入电流350 mA时GaAs基InAs量子点激光器发射光谱随温度的变化:(a)未掺杂,(b)Be掺杂
Fig. 7. The emission spectra of GaAs-based InAs QD laser with different temperatures at the same injection current of 350 mA:(a)undoped,(b)Be-doped
激光器的温度稳定性是衡量激光器性能的重要指标之一。半导体激光器的阈值电流与温度成指数关系[24]:
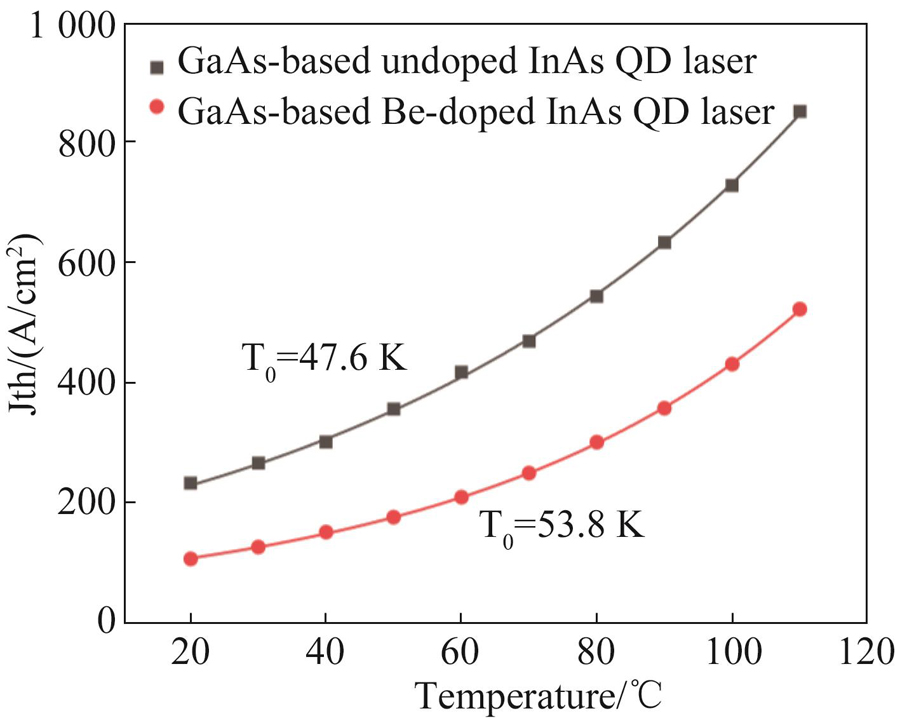
图 8. GaAs基InAs量子点激光器特征温度的变化曲线
Fig. 8. The characteristic temperature curves of GaAs-based InAs quantum dot laser
3 结论
利用分子束外延技术在GaAs(100)衬底上成功制备了1.3 μm波段的 InAs/GaAs量子点激光器。在室温连续工作模式下,对未掺杂和Be掺杂InAs量子点激光器的输出性能、光谱性能和温度稳定性进行了测试分析与比较。与未掺杂的激光器相比,Be掺杂可以有效地降低激光器的阈值电流密度到100 A/cm2,增大激光器的输出功率到183 mW,最高工作温度可以提高到130 ℃,激光器具有更好的温度稳定性。这对InAs量子点激光器在高速光纤通信领域的应用具有重要意义。
[1] Wang Z, Qi W, Feng Q, et al. InAs/GaAs quantum dot single-section mode-locked lasers directly grown on Si (001) with optical self-injection feedback[J]. Optics Express, 2020, 29(2): 674-683.
[3] Yang J, Liu Z, Jurczak P, et al. All-MBE grown InAs/GaAs quantum dot lasers with thin Ge buffer layer on Si substrates[J]. Journal of Physics D Applied Physics, 2020, 54(3): 035103.
[4] Jung D, Norman J C, Kennedy M J, et al. High efficiency low threshold current 1.3 μm InAs quantum dot lasers on on-axis (001) GaP/Si[J]. Applied Physics Letters, 2017, 111(12): 122107.
[6] KageyamaT, NishiK, YamaguchiM, et al. Extremely High Temperature (220°C) Continuous-Wave Operation of 1300-nm-range Quantum-Dot Lasers[C]. 2011 Conference on Lasers and Electro-Optics Europe and 12th European Quantum Electronics Conference (CLEO EUROPE/EQEC). IEEE2011.
[7] Ruiz-Marin N, Reyes D F, Stanojevic L, et al. Effect of the AlAs capping layer thickness on the structure of InAs/GaAs QD[J]. Applied Surface Science: A Journal Devoted to the Properties of Interfaces in Relation to the Synthesis and Behaviour of Materials, 2022(Jan. 30): 573.
[10] Alexander R R, Agarwal H, Groom K M, et al. Systematic study of the effects of modulation p-doping on 1.3-μm quantum-dot lasers[J]. IEEE Journal of Quantum Electronics, 2007, 43(12): 1129-1139.
[11] Qi W, Zhang J, Wang J H, et al. Phosphorus-free 151 μm InAs quantum-dot microdisk lasers on metamorphic InGaAs/SOI platform[J]. Optics Letters, 2020, 45(7): 2042-2045.
[12] Mi Z, Bhattacharya P, Yang J, et al. Room-temperature self-organised In0.5Ga0.5As quantum dot laser on silicon[J]. Electronics Letters, 2005, 41(13): 742-744.
[13] Chen S, Chen S, Li W, et al. Electrically pumped continuous-wave III-V quantum dot lasers on silicon[J]. Nature Photonics, 2016, 10(5): 307-311.
[14] Ray S K, Choi T L, Groom K M, et al. High-Power 1.3-μm Quantum-Dot Superluminescent Light-Emitting Diode Grown by Molecular Beam Epitaxy[J]. Photonics Technology Letters IEEE, 2007, 19(2): 109-111.
[15] Mukai K, Ohtsuka N, Sugawara M, et al. Self-Formed In0.5Ga0.5As Quantum Dots on GaAs Substrates Emitting at 1.3μm[J]. Japanese Journal of Applied Physics, 1994, 33(12A): L1710-L1712.
[16] Stephan D, Bhattacharyya J, Huo Y H, et al. Inter-sublevel dynamics in single InAs/GaAs quantum dots induced by strong terahertz excitation[J]. Applied Physics Letters, 2016, 108(8): 082107.1-082107.4.
[17] Gong Q, Notzel R, Hamhuis G J, et al. Leveling and rebuilding: An approach to improve the uniformity of (In,Ga)As quantum dots[J]. Applied Physics Letters, 2002, 81(10): 1887-1889.
[18] Joyce P B, Krzyzewski T J, Bell G R, et al. Effect of growth rate on the size, composition, and optical properties of InAs/GaAs quantum dots grown by molecular-beam epitaxy[J]. Physical Review B Condensed Matter, 2000, 62(16): 10891-10895.
[19] Wang T, Lee A, Tutu F, et al. The effect of growth temperature of GaAs nucleation layer on InAs/GaAs quantum dots monolithically grown on Ge substrates[J]. Applied Physics Letters, 2012, 100(5): 4600.
[20] Salhi A, Fortunato L, Martiradonna L, et al. Enhanced modal gain of multilayer InAs/InGaAs/GaAs quantum dot lasers emitting at 1300 nm[J]. Journal of Applied Physics, 2006, 100(12): 1915.
[21] Cao Q, Yoon S F, Liu C Y, et al. Effects of rapid thermal annealing on optical properties of p-doped and undoped InAs/InGaAs dots-in-a-well structures[J]. Journal of Applied Physics, 2008, 104(3): 20.
[22] Kumagai N, Watanabe K, Nakata Y, et al. Optical properties of p-type modulation-doped InAs quantum dot structures grown by molecular beam epitaxy[J]. Journal of Crystal Growth, 2007, 301–302: 805-808.
[23] Li Q, Wang X, Zhang Z, et al. Development of Modulation p-Doped 1310 nm InAs/GaAs Quantum Dot Laser Materials and Ultrashort Cavity Fabry-Perot and Distributed-Feedback Laser Diodes[J]. ACS PHOTONICS, 2017: acsphotonics, 5(3): 7b01355.
[24] Yue L, Gong Q, Cao C, et al. High-performance InAs/GaAs quantum dot laser with dot layers grown at 425℃[J]. Chinese Optics Letters, 2013, 11(6): 39-42.
[25] Fathpour S, Mi Z, Bhattacharya P, et al. The role of Auger recombination in the temperature-dependent output characteristics (T0=∞)of p-doped 1.3 μm quantum dot lasers[J]. Applied Physics Letters, 2004, 85(22): 5164-5166.
杜安天, 曹春芳, 韩实现, 王海龙, 龚谦. 有源区Be掺杂对1.3 μm InAs量子点激光器性能的影响[J]. 红外与毫米波学报, 2023, 42(4): 450. An-Tian DU, Chun-Fang CAO, Shi-Xian HAN, Hai-Long WANG, Qian GONG. Effect of Be doping in active regions on the performance of 1.3 μm InAs quantum dot lasers[J]. Journal of Infrared and Millimeter Waves, 2023, 42(4): 450.