扫描干涉场曝光系统光斑尺寸与光路设计  下载: 865次
下载: 865次
1 引言
扫描干涉场曝光(SBIL)技术可用于制作全息光栅,其原理是让两束高斯激光通过一定的光学系统后在束腰处相叠加并形成干涉条纹,再通过二维精密工作台以步进扫描的方式将该干涉条纹记录于涂有光刻胶的基底上,从而制作出大面积的光刻胶光栅掩模[1-3]。SBIL技术在一定程度上融合了全息光栅[4-5]与机械刻划光栅[6-8]的特点,可以一次性曝光出多条干涉条纹并对这些干涉条纹进行精确拼接。
SBIL技术在制作光栅时不仅要考虑静态全息曝光技术中的光束波前和能量分布等因素,还需要考虑条纹扫描拼接的精度,其中干涉条纹非线性误差、刻线误差和曝光对比度是3个非常关键的参数。Chen等[9]针对SBIL系统提出了一种利用叠栅条纹测量干涉场相位非线性误差的方法,分析了光束夹角失调与束腰位置失调对干涉条纹非线性误差的影响。姜珊等[10]分析了SBIL系统中周期设定对曝光刻线误差的影响,并建立了相应的扫描拼接模型。
直观上,增大曝光光斑尺寸可以增加步进间隔,减少曝光时间,提高光栅制作效率,但是SBIL系统较为复杂,各参数之间相互影响,需要综合考虑各关键参数对光斑尺寸的要求。本文基于高斯光束的传输规律及扫描拼接的特点,通过数值模拟系统讨论了曝光光斑尺寸对干涉条纹非线性误差、刻线误差和曝光对比度等关键参数的影响,为SBIL光学系统的设计与曝光刻线拼接精度的提高提供了理论依据。针对SBIL光路,设计了优化系统的光学布局,以达到为扫描曝光系统提供高质量干涉场的目的,从而满足系统对干涉场参数调整的需求。
2 干涉场尺寸设计
2.1 光斑尺寸对干涉条纹非线性误差的影响
SBIL系统采用高斯激光束作为曝光光源,根据高斯光束的传播理论[11],沿
式中
SBIL系统采用两束高斯光束相互干涉的方式形成干涉条纹,左、右两侧曝光光路用各自坐标系
式中(
由(1)式可见,高斯光束经过一定的传输距离
式中
对左、右光束相位作差,得到左、右光束相互叠加形成的干涉场相位分布为
标准干涉场的空间相位分布是以坐标原点为零点进行计算的,即叠加形成的相位需要减去干涉场在原点处的相位常数
式中
为了保证曝光时的干涉场质量,在系统两侧光路中设计了空间滤波器,以对光束进行滤波,空间滤波器由聚焦镜、针孔和准直透镜组成。高斯光束经聚焦镜聚焦后经过针孔,光波中的高频分量被截断,光束的光强分布变得平滑,通过针孔后的光束再经过准直透镜后变为平行度好的准直光束。通常认为针孔的位置即为准直前高斯光束束腰的位置,在进行曝光光路设计时要精确计算滤波针孔与准直透镜之间的距离,以保证较好的滤波效果与条纹直线度。高斯光束的传输规律可以采用复参数
首先模拟理想状态下干涉场的光斑束腰半径分别为0.5,1.0,2.0,5.0 mm时干涉条纹的非线性误差,如

图 3. 理想状态下不同束腰半径对应的干涉场非线性误差。(a) 0.5 mm;(b) 1.0 mm;(c) 2.0 mm;(d) 5.0 mm
Fig. 3. Nonlinear error of interference field with different waist radii in ideal condition. (a) 0.5 mm; (b) 1.0 mm; (c) 2.0 mm; (d) 5.0 mm
由

图 4. 存在20 μm失调量时干涉条纹的非线性误差。(a) 0.5 mm;(b) 1.0 mm;(c) 2.0 mm;(d) 5.0 mm
Fig. 4. Nonlinear error of interference fringe with misalignment of 20 μm. (a) 0.5 mm; (b) 1.0 mm; (c) 2.0 mm; (d) 5.0 mm

图 5. 存在100 μm失调量时干涉条纹的非线性误差。(a) 0.5 mm;(b) 1.0 mm;(c) 2.0 mm;(d) 5.0 mm
Fig. 5. Nonlinear error of interference fringe with misalignment of 100 μm. (a) 0.5 mm; (b) 1.0 mm; (c) 2.0 mm; (d) 5.0 mm
由
由上述分析可以看出,当准直透镜的轴向装调误差相同时,随着干涉场束腰半径的增大,干涉场束腰半径内的非线性误差变大,即大尺寸干涉场不利于条纹非线性误差的调整。综合考虑装调难度,所设计的曝光
表 1. 不同失调量对干涉条纹非线性误差的影响
Table 1. Effect of misalignment on nonlinear error of interference fringenm
| |||||||||||||||||||||||||||||||||||||||||
光斑半径尺寸不应过大。
2.2 光斑尺寸对刻线误差的影响
结合(1)、(2)式可得左、右光束在束腰位置处叠加形成的干涉场的光强分布为
式中
SBIL技术通过工作台步进扫描的方式将干涉条纹曝光于光栅基底上,假设光斑以速度
在扫描曝光过程中,通过步进拼接的方式将曝光区域扩大,假设相邻步进扫描的间隔为
SBIL系统需要对相邻扫描间的干涉条纹进行精确拼接,理想情况下干涉场的相对移动量应为整数个条纹周期,为此干涉条纹周期的准确测量对SBIL技术至关重要。每次曝光之前需要对干涉条纹周期进行测量,实际测量得到的干涉条纹周期与真实干涉条纹周期之间存在一定误差,假设干涉条纹周期的测量值为
将误差代入(8)式,可得存在干涉条纹周期测量误差时第
式中
经过
式中
在实际曝光过程中,干涉条纹周期的测量精度可达到5×10-5,基于以上模型模拟此时光栅刻线误差

图 6. 光栅刻线误差随干涉场束腰半径的变化
Fig. 6. Variation of grating line error with waist radius of interference field
2.3 光斑尺寸对曝光对比度的影响
由(11)、(12)式可知,当存在周期误差时,

图 7. 一定周期误差下曝光对比度随(a)步进间隔和(b)干涉场束腰半径的变化
Fig. 7. Variation of exposure contrast with (a) step interval and (b) waist radius of interference field at certain period error
由
综上所述,存在一定的装调误差时,小尺寸曝光光斑的非线性误差优于大尺寸光斑,或者说小尺寸曝光光斑更利于获取更大非线性误差的干涉场。此外,存在周期测量误差时,小尺寸曝光光斑可以降低拼接后的刻线误差,有利于控制光栅鬼线强度、增大扫描拼接后的曝光对比度并改善光栅表面的均匀性。根据以上分析,综合考虑各方面因素,曝光光斑半径应当设计在1 mm左右。
3 系统光学透镜布局
采用高斯激光束作为曝光光束,系统中的透镜是唯一能改变光束特性的光学元件,其设计与布局直接影响到系统的整体性能。在设计时需要考虑以下因素:1) 控制光束发散角;2) 传输过程中避免因光斑发散过大而引入波前误差;3) 调整光束束腰位置及尺寸,使其满足光学元件布局的长度需要及系统曝光精度的要求;4) 透镜结合针孔光阑组成空间滤波器,滤去光束中的高频噪声,以保证光斑能量的均匀性。系统光源为Spectra-Physics公司生产的BeamLok 2080型Kr离子激光器,波长为413.1 nm,出射光束的束腰半径为0.8 mm,束腰位于激光器后端。系统欲制作的光栅周期为1800 lp/mm (555.6 nm),即曝光光束与光栅基底的夹角为21.8°。
3.1 理论计算
基于以上要求对曝光光路中的透镜进行了设计。系统共采用5个透镜,其中位于主光路上的中继透镜起到调制激光光束的作用,可确保光束传播10 m后不显著扩大;另外4个透镜位于两侧的空间滤波器中,起到聚焦和准直的作用。根据高斯光束在透镜中的传输规律,计算得到中继透镜的焦距为3286 mm,聚焦镜的焦距为130 mm,准直透镜的焦距为192 mm,准直透镜到光栅基底的距离为452 mm。透镜分布距离如
3.2 优化设计
以上计算基于理想薄透镜,未考虑光学材料及加工精度的影响,为此系统利用Code V对光路透镜设计布局进行优化,系统透镜采用JGS1光学石英玻璃。
利用Code V中的高斯光束分析功能,对高斯光束的传输进行追迹优化。最终优化结果显示,高斯光束传播至接收面(干涉场)时,
4 干涉场参数测量
4.1 光斑形貌测量
采用Ophir-Spiricon公司生产的光束质量探测器BeamGage对光斑形貌进行测量。将光束质量探测器放置于干涉场中,挡住其中一路光束,并对另一路光束进行采样测量;保持探测器固定不变,采用相同的方法对另一路光束进行采样测量。
测试过程中需经过衰减片把功率减小到饱和功率以下,测量结果如
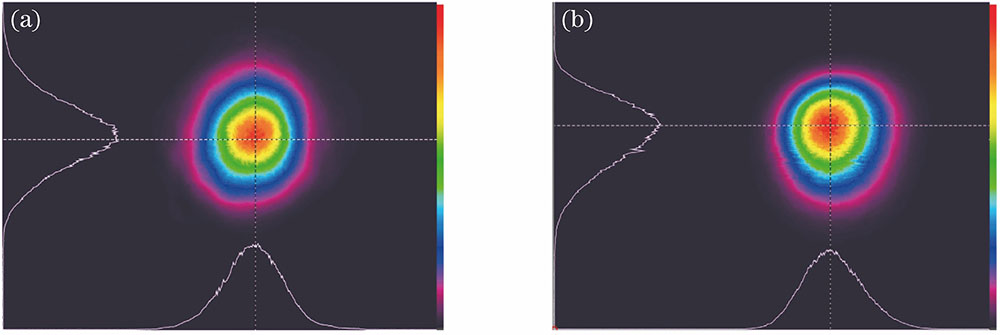
图 9. 左右曝光光斑形貌图。(a)左侧;(b)右侧
Fig. 9. Morphologies of left and right exposure spots. (a) Left side; (b) right side
4.2 干涉条纹相位的非线性误差测量
用探测器难以直接测量干涉场相位,此系统采用简单实用的哈里哈兰[15]五步相移算法对相位差进行测量,如
根据以上原理,在系统中搭建了干涉条纹相位测量系统,利用相位锁定技术使光束相位产生0,π/2,π,3π/2,2π的变化,CCD采集得到的五步相移图像如

图 11. 五步相移干涉图像。(a) 0;(b) π/2;(c) π;(d) 3π/2;(e) 2π
Fig. 11. Interference patterns of five-step phase shifting. (a) 0; (b) π/2; (c) π; (d) 3π/2; (e) 2π

图 12. 干涉条纹相位的非线性误差分布。(a)二维图;(b)三维图
Fig. 12. Nonlinear error distributions of interference fringe phase. (a) Two-dimensional figure; (b) three-dimensional figure
计算得到的干涉条纹相位非线性误差峰谷(PV)值为21.8 nm,可见实际测量得到的干涉条纹相位与设计值之间有一定的误差,主要由于光学元件存在一定的加工与装调误差,光路中存在的表面缺陷及空气中悬浮的灰尘也会对光束产生一定调制。但整体而言,相位非线性误差较大的区域分布在边缘,光束边缘的能量较弱,因此对系统产生的影响有限。扫描和拼接的均化作用减小了曝光刻线误差。目前测量得到的相位非线性误差完全满足系统使用要求。
5 结论
针对SBIL系统曝光光路,分析了曝光光斑尺寸对条纹非线性误差、刻线误差和曝光对比度的影响。结果表明:存在一定的装调误差时,小尺寸光斑的非线性误差优于大尺寸光斑;由于存在周期测量误差,小尺寸光斑可以降低拼接后的刻线误差,有利于控制光栅鬼线强度、增大扫描拼接后的曝光对比度并改善光栅表面的均匀性。结合系统对测量、调整的要求,计算、设计并优化了系统的光学布局。利用光束质量探测器测量了曝光光束形貌,通过哈里哈兰五步相移法测量了干涉条纹的非线性误差,结果表明:曝光光斑能量较为均匀,左右光斑形貌较为一致,光束的束腰半径为0.9 mm左右,干涉条纹的相位非线性误差PV值为21.8 nm,以上结果均满足系统要求,达到了预期设计目的。
[1] MontoyaJ. Towardnano-accuracy in scanning beam interference lithography[D]. Boston: Massachusetts Institute of Technology, 2006.
[2] Paul TK. Design andanalysis of a scanning beam interference lithography system for patterning gratings with nanometer-level distortions[D]. Boston: Massachusetts Institute of Technology, 2005.
[3] 程伟林, 朱菁, 张运波, 等. 扫描干涉场曝光中关键技术的现状与发展趋势[J]. 激光与光电子学进展, 2015, 52(10): 100001.
[4] 韩建. 全息光栅曝光光学系统优化及光栅掩模参数控制方法研究[D]. 长春: 中国科学院长春光学机密机械与物理研究所, 2012.
HanJian. The research on the lithography system optimization and the grating mask profile parameters controlling in the fabrication of the holographic grating[D]. Changchun: Changchun Institute of Optics, Fine Mechanics and Physics,Chinese Academy of Sciences, 2012.
[6] 李晓天. 巴音贺希格, 齐向东, 等. 机械刻划光栅的刻线弯曲与位置误差对平面光栅性能影响及其修正方法[J]. 中国激光, 2013, 40(3): 0308009.
[7] 蔡锦达, 王英, 颜廷萌, 等. 衍射光栅刻划机的闭环控制系统[J]. 光学精密工程, 2012, 20(11): 2417-2423.
[8] 宋楠, 冯树龙, 于海利, 等. 大光栅刻划机气浮刀架导轨设计与分析[J]. 中国激光, 2015, 42(4): 0408007.
[9] Chen GC. Beam alignment and image metrology for scanning beam interference lithography: Fabricating gratings with nanometer phase accuracy[D]. Boston: Massachusetts Institute of Technology, 2003.
[10] 姜珊. 巴音贺希格, 李文昊, 等. 扫描干涉场曝光系统中周期设定对曝光刻线相位的影响[J]. 光学学报, 2014, 34(9): 0905003.
[11] 周炳琨, 高以智, 陈倜荣, 等. 激光原理[M]. 第6版. 北京: 国防工业出版社, 2009: 70- 78.
ZhouBingkun, GaoYizhi, ChenTirong, et al.Laser principle[M]. 6th ed. Beijing: Nation Defense Industry Press, 2009: 70- 78.
[12] 姜珊. 巴音贺希格, 宋莹, 等. 扫描干涉场曝光系统中干涉条纹周期测量误差对光栅掩模槽形的影响[J]. 光学学报, 2014, 34(4): 0405003.
[13] 于海利. 基于双频激光干涉测量的大行程纳米定位技术及其应用研究[D]. 长春: 中国科学院长春光学精密机械与物理研究所, 2011.
YuHaili. Research on larger stroke nan-positioning technology and application based on dual-frequency laser interferometer[D]. Changchun: Changchun Institute of Optics, Fine Mechanics and Physics,Chinese Academy of Sciences, 2011.
[14] 祝绍萁, 邹海兴, 包兴诚, 等. 衍射光栅[M]. 北京: 机械工业出版社, 1986: 112.
ZhuShaoqi, ZouHaixing, BaoXingcheng, et al.Diffraction grating[M]. Beijing: China Machine Press, 1986: 112.
[16] Chen GC. Beam alignment and image metrology for scanning beam interference lithography: Fabricating gratings with nanometer phase accuracy[D]. Boston: Massachusetts Institute of Technology, 2003.
[17] 姜珊. 扫描干涉场曝光系统干涉条纹测量与调整方法研究[D]. 长春: 中国科学院长春光学机密机械与物理研究所, 2015.
JiangShan. Study on measurement and adjustment of interference fringes for scanning beam interference lithography system[D]. Changchun: Changchun Institute of Optics, Fine Mechanics and Physics,Chinese Academy of Sciences, 2015.
Article Outline
王玮, 姜珊, 宋莹, 巴音贺希格. 扫描干涉场曝光系统光斑尺寸与光路设计[J]. 中国激光, 2017, 44(9): 0905002. Wang Wei, Jiang Shan, Song Ying, Bayanheshig. Design of Spot Size and Optical Path in Scanning Beam Interference Lithography System[J]. Chinese Journal of Lasers, 2017, 44(9): 0905002.