高分辨率主动驱动型氮化镓基Micro-LED芯片的制备
1 引言
近年来,AR/VR(Augmented Reality/Virtual Reality)技术和“元宇宙”等新兴技术和概念得到了迅猛发展,这些技术和概念的近距离观看的特点对显示技术提出了更高的要求[1],例如高分辨率、长寿命、高亮度、快速响应、高亮度、高对比度、低功耗等。其中最重要的是需要实现高分辨率来保证近距离观看下的显示效果,而高分辨率意味着更小的像素尺寸。目前主流的有机发光二极管(Organic Light-Emitting Diode,OLED)技术和液晶显示(Liquid Crystal Display,LCD)技术[2]很难达到更小尺寸的像素,OLED技术受限于制备中用到的精细金属掩膜版(Fine Metal Mask,FMM)技术瓶颈,LCD技术受限于背光板分辨率。并且这两种技术还有其他缺点,例如OLED屏幕寿命短,LCD屏幕亮度低、对比度低,使得它们很难应用于近距离观看的场景中,所以需要寻找一种新的显示技术。基于第三代半导体材料氮化镓的Micro-LED技术自出现以来便得到了许多研究人员的关注和研究[3-11],其不仅可以实现OLED和LCD无法企及的超小像素尺寸,而且还有寿命长、亮度高、响应速度快、低功耗等优点[12-13],可以满足所有近距离观看场景下的需求,有望成为下一代主流技术。自2000年Jin等人[14]制成Micro-LED以来,制备而成的显示器件分辨率便不断在提高。2004年,Jeon等人[15]制备出分辨率为64×64的显示器件,像素直径为20 μm。2014年,Chong等人[16]制得的器件分辨率为256×192。2019年,Chen等人[17]制备的显示器件分辨率达960×540,像素直径为8 μm。这些文献对Micro-LED做了许多测试与表征,但是产业界关注的具体制备工艺优化却较少提及。本文从结构调整与工艺优化入手展示了一款1 920×1 080的Micro-LED芯片的制备。
氮化镓基Micro-LED所用晶圆通常是通过MOCVD(Metal-organic Chemical Vapor Deposition)技术逐层外延U型氮化镓、N型氮化镓、量子阱、P型氮化镓来制备得到的[18]。为了将整面的晶圆加工为Micro-LED芯片,要将晶圆上的外延材料分割为数百万个极小的发光区域,这一过程通常是通过ICP刻蚀去除部分外延材料来实现[19],我们将这一过程中ICP刻蚀形成的凹陷称为沟道,而留下完整外延层的发光岛状结构即业界所称的台面。目前业界对Micro-LED还没有统一的定义,人们通常以台面的大小作为评价标准,将台面在50 μm以下的LED芯片称为Micro-LED,但对于AR/VR等近距离观看场景来说,要求更为严格,通常要求台面大小在20 μm甚至更小,才保证优良的显示效果。
Micro-LED台面刻蚀效果的好坏既直接决定了发光单元的大小形貌,又关系到最终芯片的良率,所以刻蚀时如何保证数百万个台面的一致性和完整性既是制备过程中的重点,也是制备工艺中的难点。我们发现在小尺寸台面刻蚀中,在芯片的一些区域里作为刻蚀掩膜的光刻胶出现了偏移,甚至缺失,这势必会导致刻蚀后台面的偏移、缺失,进而导致最终显示芯片的坏点。为此,我们在制备过程中增加了HMDS处理步骤,提高光刻胶的附着力。实验结果表明,这一措施明显改善了台面刻蚀一致性。同时,在完成ITO(Indium Tin Oxide)图案化的过程中,我们发现传统工艺中湿法腐蚀后的ITO由于侧蚀严重,尺寸小于设计值,所以改为利用干法刻蚀完成ITO图案化,并同时完成了台面刻蚀。这一方法得到了图案化效果较好的ITO,而且实现了ITO和台面的自对准。在完成显示芯片的制备后,还要实现显示芯片与驱动芯片的键合。为了保证数百万个像素能有良好的电气连接,对于待键合界面的平整度有着极高的要求。考虑到这一问题,我们在设计中通过在刻蚀时预留一个台阶结构来垫高N型电极,从而解决了传统显示芯片中P型电极和N型电极不等高的问题。
本文展示了分辨率为1 920×1 080、台面尺寸为6 μm、像素间距为8 μm、密度为3 129、开启电压为3.5 V的Micro-LED芯片的制备工艺,通过单次ICP刻蚀完成了ITO的图案化和台面刻蚀,实现了ITO对台面的完全覆盖,同时利用HMDS处理增加刻蚀掩膜附着力改善了台面刻蚀的一致性和完整性。此外,还优化了P型电极和N型电极不等高的问题,以便于显示芯片与驱动芯片的键合。Micro-LED关键制备工艺的突破将对其产业化进程起到推动作用。
2 实验
采用在蓝宝石衬底上外延而成的蓝色LED晶圆作为实验材料,主要包括730 nm的P型氮化镓、9对量子阱、2 μm的N型氮化镓和1.8 μm的U型氮化镓。
3 结果与讨论
3.1 小尺寸的ITO图案化
在制备芯片时,为了增强芯片的电流扩展能力和光电性能,在晶圆上利用磁控溅射的方法沉积了一层ITO作为电流扩展层,并对其进行退火处理。为了只保留覆盖台面区域的ITO,还需要对其进行图案化处理,在传统工艺中通常是用湿法腐蚀的方法来完成这一步骤,但我们发现湿法腐蚀仅适用于大尺寸的ITO图案化中,当ITO尺寸为20 μm或更小时,湿法腐蚀中横向腐蚀所带来的影响变得十分严重,甚至直接将ITO腐蚀至远小于掩膜的尺寸。
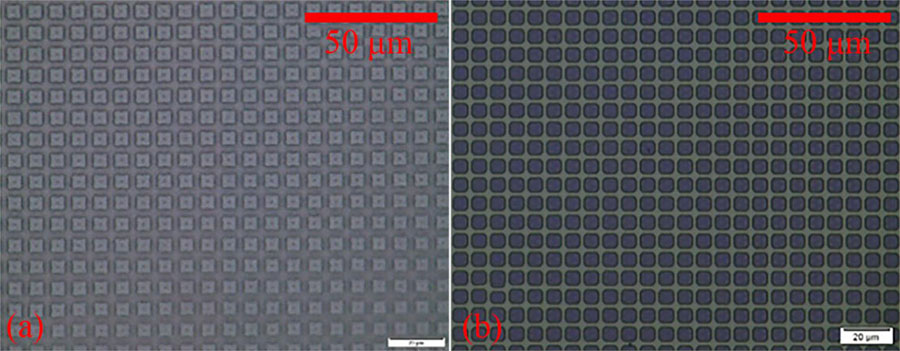
图 3. (a)湿法腐蚀后的ITO(已完成台面刻蚀);(b)干法腐蚀后的ITO(已完成台面刻蚀)。
Fig. 3. (a)Mesa with ITO after wet etching;(b)Mesa with ITO after ICP.
我们的单次刻蚀相较于传统工艺减少了湿法腐蚀的步骤,不仅图案化效果明显得到优化,而且节省了成本。不过,虽然ICP刻蚀是一种能更好地实现小尺寸ITO图案化的方法,但是仅适用于ITO厚度较薄的情况,因为较厚的ITO在刻蚀过程中产生的废料可能会二次沉积在沟道中导致短路。
3.2 小尺寸的台面刻蚀
在完成上述ITO图案化和台面刻蚀后,发现芯片某些区域的台面出现了移位甚至缺失的现象,如
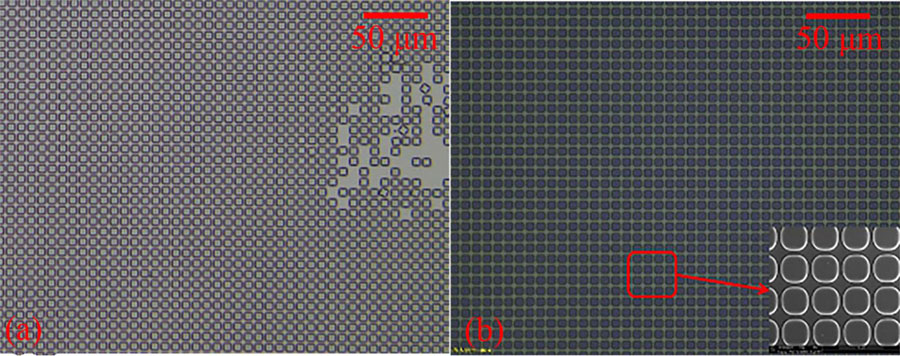
图 4. (a)无HMDS处理的台面刻蚀结果;(b)有HMDS处理的台面刻蚀结果。
Fig. 4. (a)Mesa etching without HMDS;(b)Mesa etching with HMDS.
基于上述实验结果,在正式的芯片制备中,我们采用单次ICP刻蚀来完成ITO图案化和台面刻蚀,实现了ITO和台面自对准。在光刻前增加了HMDS处理步骤,这一措施改善了小尺寸光刻胶移位、缺失的问题,提高了台面刻蚀的一致性和完整性。
3.3 Micro-LED芯片结构优化
显示芯片还需与驱动芯片进行键合才能作为完整显示器件。芯片中央的大量台面上的金属电极是每个像素点的阳极(P型电极),而阴极(N型电极)则与作为公共互联层的N型氮化镓相连接,分布在芯片的四周。输入电流从台面上的金属电极流经P型氮化镓、量子阱、N型氮化镓,再从阴极流出至驱动芯片,从而实现芯片的点亮。为了提高显示芯片与驱动芯片键合的成功率,需要解决显示芯片P型电极和N型电极不等高的问题,我们通过在芯片四周预留了一个台阶结构来垫高N型电极,N型电极从台阶下的N型氮化镓“爬升”到台阶上,使N型电极与P型电极保持等高。值得一提的是,这一台阶结构是在台面刻蚀步骤中同步完成的,这使得金属电极的起始高度是一样的,并且为了保证最终高度的一致,P型电极和N型电极的制备也在同一步光刻和金属蒸镀中完成。单次同步完成P型电极和N型电极的制备不仅保证了金属电极的厚度一致,而且实现了P型电极和N型电极的相对自对准,避免了传统设计中两种电极分开制备所带来的套刻误差。
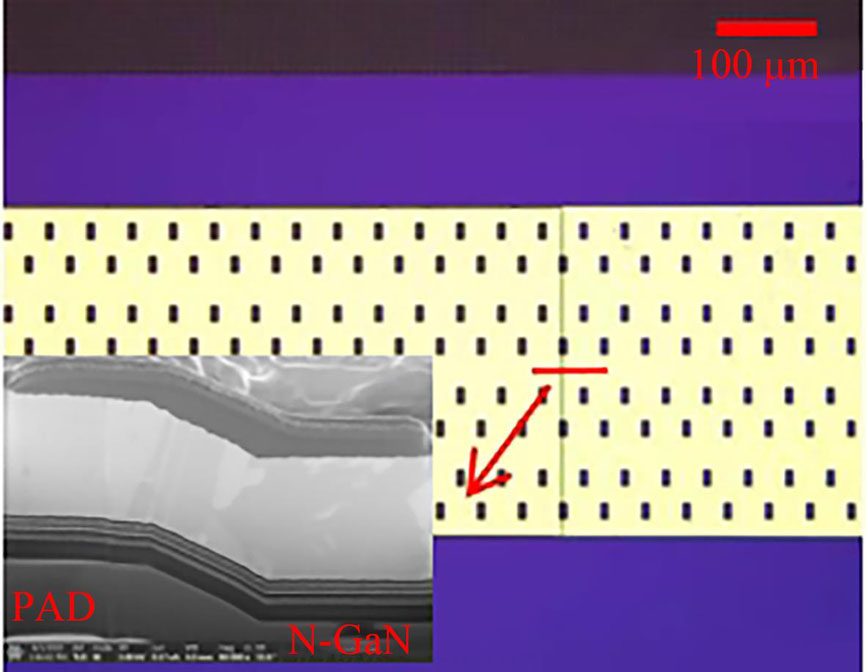
图 7. 公共阴极显微镜图片(插图:红线处剖面图)
Fig. 7. Picture of common cathode(Inset:Sectional view of the red line area)
4 结论
本文对芯片结构和制备工艺进行了优化,制成了一款高分辨率、开启电压为3.5 V的单片集成式倒装结构的8 μm周期Micro-LED芯片。通过单次ICP刻蚀得到了尺寸符合设计要求的ITO,并实现了ITO与台面的自对准。通过增加HMDS处理来提高刻蚀掩膜的附着力,从而改善台面刻蚀的一致性和完整性。并且通过在台面刻蚀时预留台阶结构来垫高N型电极,解决了倒装芯片中P型电极与N型电极不等高的问题,从而提高该芯片与驱动芯片键合的成功率。本文对未来超小尺寸发光单元的Micro-LED的技术和产业发展将有一定的参考作用。
[3] 季洪雷, 张萍萍, 陈乃军, 等. Micro-LED显示的发展现状与技术挑战[J]. 液晶与显示, 2021, 36(8): 1101-1112.
[4] 周自平, 黎垚, 严银菓, 等. Micro-LED应用于近眼显示的现状与趋势[J]. 液晶与显示, 2022, 37(6): 661-679.
[5] 韩洪松, 齐爱想, 刘俊国, 等. Micro-LED在机载上的应用[J]. 液晶与显示, 2021, 36(3): 439-447.
[6] 严子雯, 严群, 李典伦, 等. 高度集成的μLED显示技术研究进展[J]. 发光学报, 2020, 41(10): 1309-1317.
[8] 李继军, 聂晓梦, 李根生, 等. 平板显示技术比较及研究进展[J]. 中国光学, 2018, 11(5): 695-710.
[19] 潘岭峰, 李琪, 伊晓燕, 等. 低损伤ICP刻蚀技术提高GaN LED出光效率[J]. 微纳电子技术, 2011, 48(5): 333-337.
[21] 安晖, 操彬彬, 栗芳芳, 等. ITO退火工艺对HADS型TFT-LCD透过率的影响[J]. 液晶与显示, 2019, 34(5): 482-488.
[23] 方瑢. Ⅲ-Ⅴ族化合物半导体材料和ITO薄膜的ICP刻蚀研究[D]. 北京: 北京工业大学, 2010.
FANGR. ICP etching study of Ⅲ-Ⅴ semiconductor materials and ITO films[D]. Beijing: Beijing University of Technology, 2010. (in Chinese)
[24] 宋颖娉, 郭霞, 艾伟伟, 等. Cl2/BCl3 ICP刻蚀GaN基LED的规律研究[J]. 微纳电子技术, 2006, 43(3): 125-129.
黄铭水, 聂君扬, 刘明洋, 李洋, 潘魁, 邓俐颖, 杨天溪, 黄忠航, 孙捷, 严群, 郭太良. 高分辨率主动驱动型氮化镓基Micro-LED芯片的制备[J]. 液晶与显示, 2022, 37(12): 1553. Ming-shui HUANG, Jun-yang NIE, Ming-yang LIU, Yang LI, Kui PAN, Li-ying DENG, Tian-xi YANG, Zhong-hang HUANG, Jie SUN, Qun YAN, Tai-liang GUO. Fabrication of high-resolution active matrix driven GaN-based Micro-LED chips[J]. Chinese Journal of Liquid Crystals and Displays, 2022, 37(12): 1553.