1160 nm光泵垂直外腔面发射激光器设计及制备  下载: 1333次特邀研究论文
下载: 1333次特邀研究论文
1 引言
光泵浦垂直外腔面发射半导体激光器(VECSEL)可以同时实现高光束质量与高功率的激光输出。由于VECSEL的外腔振荡特性,在其外置腔内置入非线性光学晶体可以实现输出波长的转换[1],极大地扩大了半导体激光器的波长覆盖范围。半导体激光器本就具有体积小、质量轻、光电转换效率高等优点[2],VECSEL技术又兼具光束质量高、功率高、波长变换等多种优势。
560~600 nm波段的橙黄色激光在生物医学[3]、食品药品检测、大气遥感[4]等方面有广泛的应用需求:人体血红蛋白对560~600 nm波段的激光吸收率很高,在治疗皮肤和视网膜病变[5]应用中前景广阔;高功率的橙黄色激光可用于**上空间目标的探测与识别。然而,目前尚无基于560~600 nm波段直接激光输出的高性能半导体材料,因此将长波长1120~1200 nm的VECSEL作为基频光源,在其外腔内插入倍频晶体实现橙黄激光输出的技术方案获得广泛关注[6],是近年来研究的热点之一[7-9]。VECSEL分为电泵浦与光泵浦两种工作方式。目前关于瓦级功率输出的电泵浦1160 nm VECSEL结构鲜有报道,这是因为电泵浦VECSEL的输出功率非常依赖于发光区量子阱(QW)的材料性能。电泵浦VECSEL的发光区一般只包括3~4个量子阱,这是因为过多的量子阱会使输运到各个量子阱的载流子数量差距很大,影响复合效率。1160 nm波段的InGaAs量子阱材料需要极高的In组分。高In组分的InGaAs量子阱与AlGaAs分布式布拉格反射镜(DBR)材料之间具有大的材料应变,直接生长InGaAs量子阱会产生晶格缺陷,导致量子阱增益下降;同时缺陷会带来大的光学损失,使得输出激光难以实现高功率水平。如果通过外加应变补偿层的方法来削弱量子阱应变,则会降低量子阱的光学限制因子,导致激光振荡时得到的有效增益进一步降低,更加限制了VECSEL功率。而在光泵浦1160 nm VECSEL结构中,不需要考虑电注入带来的量子阱数量限制,可以通过周期性地排布近10个量子阱,是电泵浦VECSEL量子阱数量的3倍,可以保证腔内振荡的激光能获得足够高的增益水平,实现瓦级高功率输出。
560~600 nm波段激光对应的基频光波长在1120~1200 nm,获得高性能的VECSEL基频光的关键在于其增益芯片的设计和制备。1120~1200 nm发光波段位于GaAs基材料的长临界波长处,需要采用高应变的量子阱发光材料作为VECSEL的发光层。VECSEL一般需要采用近10层左右的发光层来实现高的发光效率[10],因此,发光波长位于1120~1200 nm的高应变发光层在外延生长过程中极易产生应变积累效应,导致增益芯片发光区产生大量晶格缺陷,限制器件的工作性能,严重时甚至无法正常激射。基于GaAs衬底的近红外波段(760~1060 nm)半导体激光器发展最为成熟[11],InGaAs是该波段应用最广泛的量子阱发光材料,相应的腔内倍频技术也较为完善[12-13]。然而当出光波长大于1100 nm时,InGaAs的材料应变已接近临界厚度[14]。最初,Thränhardt等[15]采用应变较小的InGaNAs作为发光层材料来缓解高应变效应,减少由高应变效应引起的内部材料缺陷,然而难于控制掺N的InGaAs量子阱的生长过程[16],仅有少数几家单位有相关报道。德国乌尔姆大学等单位为解决上述问题,提出了采用应变补偿方式[17]制备VECSEL发光区的方案:量子阱发光层仍然采用高应变的InGaAs,但是势垒层采用具有反向应变效应的GaAsP材料,这样就可以抵消InGaAs带来的应变效应。由于InGaAs和GaAsP的制备工艺均较为成熟,该方案也成为近年来1120~1200 nm VECSEL发光区普遍采用的材料结构方案之一。
采用GaAsP的反向应变效应可以有效缓解InGaAs带来的应力效应,但是由于GaAsP能带较宽,直接将其置于InGaAs量子阱两侧将会降低吸收区产生的光生载流子向InGaAs量子阱的注入效率,因此一般在GaAsP应变补偿层与InGaAs量子阱之间隔一个光吸收层[18]。上述方案中,GaAsP层并不能直接补偿InGaAs的应变效应,因此InGaAs产生的应变会直接作用于两者之间的光吸收层,使得吸收层的材料质量受到一定影响。
本文报道1160 nm波段VECSEL的研制结果,提出先在InGaAs两侧采用仅有5 nm厚的薄层GaAsP对量子阱应变进行初步补偿的方案,再在光吸收层之间插入具有GaAsP应变补偿层的发光区结构。吸收区产生的光生载流子很容易穿过仅有5 nm厚的GaAsP材料层并注入到InGaAs量子阱中,因此该结构不会使InGaAs中光生载流子的注入效率降低。另外,由于对高应变的InGaAs进行了初步补偿,在其上生长的光吸收层的材料质量也会得到有效提高。
2 VECSEL器件结构
所用VECSEL系统结构示意图如
1160 nm波段的增益芯片结构采用高应变的InGaAs量子阱作为发光层。由于InGaAs应变量很大,为避免InGaAs应变效应影响其上下部分光吸收层材料的质量,在InGaAs两侧采用5 nm厚的GaAsP势垒层,对InGaAs产生的应变进行初步补偿;然后在光学吸收层中间插入更高P组分的GaAsP应变补偿层,完成对InGaAs量子阱的完全应变补偿。VECSEL系统工作时,增益芯片内部光学振荡情况如
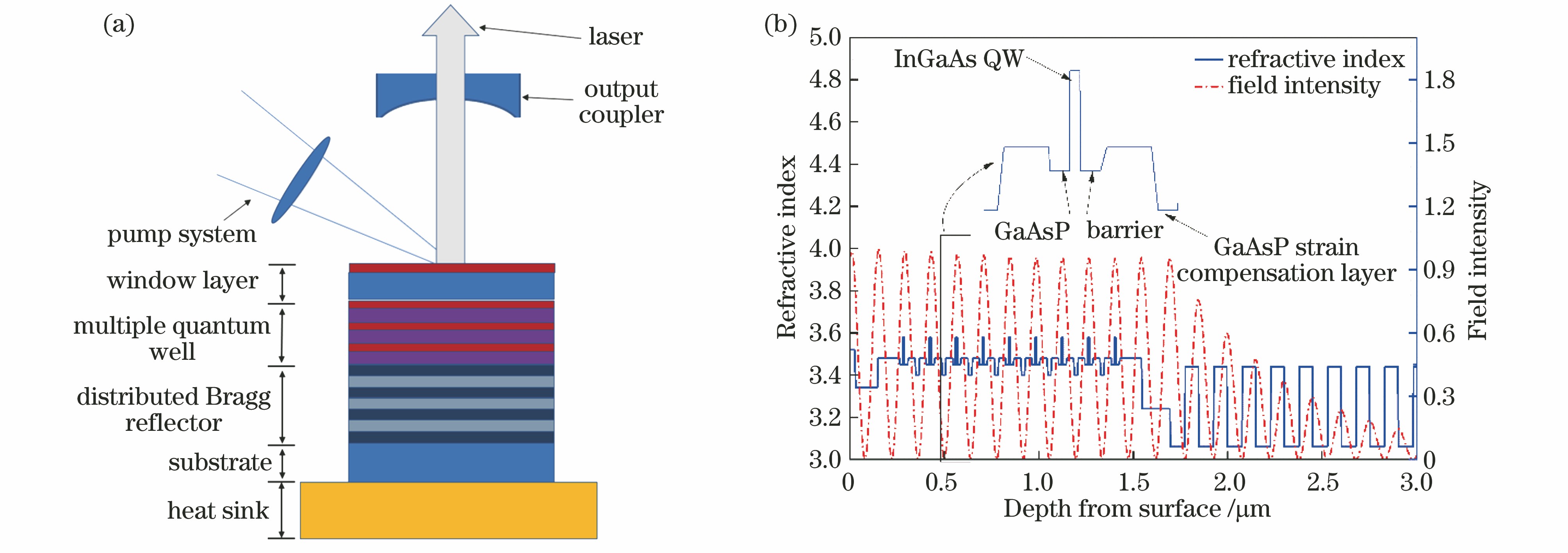
图 1. VECSEL结构与芯片内部光场分布。(a) VECSEL系统示意图;(b)增益芯片内层光场分布
Fig. 1. VECSEL structure and light field distribution inside the chip. (a) Diagram of VECSEL system; (b) optical field distribution in inner layer of gain chip
3 理论设计
InGaAs量子阱引起的应变效应可以使基于价带的轻空穴(LH)、重空穴(HH)带有效分离,实现低的透明载流子密度和高的材料增益[19],具有优越的材料性能,在920~1100 nm波段应用广泛。在InGaAs材料中,In组分越高,材料对应的激射波长越长[20]。InxGa1-xAs量子阱需要x>35%的In含量,才能将带隙能量降低至输出1160 nm波段所需能量。InGaAs中少量的In原子的体积较大,可以很好地牵制位错的移动,有效地阻止暗点和暗线缺陷的密度,提高材料的生长质量[21];但是In组分过高会使晶格应变加剧,形成位错,位错会严重限制芯片的运行和降低使用寿命[22],而且由于应变积累效应,具有高In组分的InGaAs在生长过程中很容易产生位错等晶格缺陷[23]。本文使用具有适量的P组分的GaAsP作为势垒层,对高In组分的InGaAs量子阱引起的压应变进行初步补偿,提高晶格质量[24],从而获得具有高增益、高晶格质量的发光区材料结构。
增益芯片的核心材料层为内部发光层量子阱结构,首先对采用GaAsP势垒的发光区量子阱能带分立情况及其增益特性进行分析。采用K-P能带理论计算量子阱的空穴能级分立情况,如
发光区量子阱的增益参数是决定VECSEL阈值、输出功率、效率特性的关键参数。随着量子阱内部注入的载流子浓度增加,即光泵浦能量不断增大,需要量子阱具备稳定的增益增长速度,这样VECSEL的输出功率不易饱和。

图 3. 不同光生载流子浓度下InGaAs量子阱的增益光谱
Fig. 3. Gain spectra of InGaAs quantum wells at different carrier concentrations
量子阱的增益谱的峰值随着温度的增加会出现往长波方向漂移的现象。由于VECSEL工作时发光区会出现强的热效应,量子阱增益峰值对应的波长将会红移。InGaAs量子阱的增益峰值处波长红移速度为0.3 nm/℃,因此,为保证1160 nm的VECSEL在工作时可以获得足够高的光增益,需要将InGaAs的量子阱增益峰值处波长设计的比VECSEL的实际发光波长短。由于激光泵浦的热效应,发光区温度与环境温度相比大约高30 ℃[25],所对应的波长偏差约为10 nm,因此将量子阱增益峰值处波长设置在1150 nm附近。
VECSEL工作时,由发光层两侧的吸收层材料吸收泵浦激光,并产生电子与空穴光生载流子,电子与空穴光生载流子分别注入到发光区的量子阱导带与价带能级,然后复合发光。目前在常见的报道中,1160 nm波段多采用GaAs材料作为吸收层材料[26]。在本研究中,由于采用GaAsP材料作为势垒层,GaAsP势垒具有比GaAs更高的导带及价带能级位置,因此,为了保证顺利注入光生载流子,采用AlGaAs材料作为增益芯片内部的光吸收层材料。为评估InGaAs/GaAsP发光区材料结构对VECSEL内部光生载流子注入效应的影响,分析实际泵浦过程中电子与空穴光生载流子的分布情况,如
4 实验结果
采用MOCVD设备对设计的VECSEL增益芯片结构进行外延生长,生长顺序依次为刻蚀阻挡层、窗口层、增益芯片发光区、DBR。其中DBR采用GaAs/AlAs材料以减小DBR对数,同时还可以增加热导率。刻蚀阻挡层采用GaInP材料,用于实现衬底剥离时的选择性刻蚀工艺。然后,将外延片切成3 mm×3 mm大小的芯片,并在芯片的DBR上蒸镀Ti-Pt-Au金属合金层。随后通过In焊料将芯片焊接到铜热沉上。采用机械减薄的方式去除大部分的衬底后,再使用具有选择性腐蚀的溶液去除剩下的衬底。最后,将制备完整的器件固定在装有TEC的铜支架上进行有效的散热。
为验证VECSEL增益芯片表面发光波长是否满足使用要求,采用椭偏仪测试去除衬底后的增益芯片的反射谱特性,如
将已焊接增益芯片的铜热沉固定在装有TEC控温装置的铜支架上,采用中心波长为808 nm、光斑直径为200 μm的半导体激光模块作为泵浦源,光源以大约45°角度照射到增益芯片的表面,调节光纤前端的准直聚焦透镜系统,使得增益芯片上的泵浦光斑尺寸最小,此时泵浦光斑直径约为200 μm。
表 1. 不同VECSELs在相近波长处的参数对比
Table 1. Comparison of parameters at similar wavelength of different VECSELs
|

图 6. 不同增益芯片温度下,VECSEL输出功率随泵浦功率的变化曲线
Fig. 6. Output power curve of VECSEL with pump power at different gain chip temperatures
VECSEL的独特优势在于既可以实现高的功率输出,还可以实现圆形对称的光斑形貌。

图 7. VECSEL系统输出光束强度的远场分布,插图为输出光斑的二维彩图
Fig. 7. Far field distribution of output beam intensity of VECSEL system, and the inset is 2D color map of output spot
5 结论
设计和制备了一种输出波长在1160 nm波段的光泵浦VECSEL。为缓解高应变InGaAs引起的材料生长应力,提出了二次应变补偿的设计方案。先用较低应变量的GaAsP势垒进行应力初步补偿,再采用吸收层中的GaAsP应变补偿层进行全应变补偿,这种方案可以提高吸收层材料的生长质量。从理论上证实这种结构的能带、增益特性及光生载流子注入情况均可以满足应用需求。采用MOCVD制备了增益芯片结构,在增益芯片温度为-20 ℃时,实现VECSEL系统最大激光功率1.02 W。VECSEL输出激光光斑在两个正交方向上的发散角分别为10.5°和11.9°,光斑形貌为圆对称结构,均匀性较好。
[1] 王立军, 宁永强, 秦莉, 等. 大功率半导体激光器研究进展[J]. 发光学报, 2015, 36(1): 1-19.
[2] 乔闯, 苏瑞巩, 李翔, 等. 980 nm高功率DBR半导体激光器的设计及工艺[J]. 中国激光, 2019, 46(7): 0701002.
[3] Kantola E, Rantamaki A, Leino I, et al. VECSEL-based 590-nm laser system with 8 W of output power for the treatment of vascular lesions[J]. IEEE Journal of Selected Topics in Quantum Electronics, 2019, 25(1): 1-8.
[4] Hackett S, Albrecht A R, Yang Z, et al. Vertical external cavity surface emitting lasers for sodium guidestar applications and improvement of current guidestar systems[J]. Proceedings of SPIE, 2016, 9734: 97340Y.
[5] 李玉娇, 宗楠, 彭钦军. 垂直腔面发射半导体激光器的特性及其研究现状[J]. 激光与光电子学进展, 2018, 55(5): 050006.
[7] Fan L, Hessenius C, Fallahi M, et al. Highly strained InGaAs/GaAs vertical-external-cavity surface-emitting laser for the generation of coherent yellow-orange light[J]. Proceedings of SPIE, 2008, 6871: 687119.
[8] Kantola E, Leinonen T, Ranta S, et al. Pulsed high-power yellow-orange VECSEL[J]. Proceedings of SPIE, 2014, 9134: 91340Z.
[9] d'Orgeville C, Fetzer G J, Floyd S, et al. Semiconductor guidestar laser for astronomy, space, and laser communications: prototype design and expected performance[J]. Proceedings of SPIE, 2018, 10703: 107030T.
[10] Ekins-Daukes N J, Kawaguchi K, Zhang J. Strain-balanced criteria for multiple quantum well structures and its signature in X-ray rocking curves[J]. Crystal Growth & Design, 2002, 2(4): 287-292.
[11] 袁庆贺, 井红旗, 张秋月, 等. 砷化镓基近红外大功率半导体激光器的发展及应用[J]. 激光与光电子学进展, 2019, 56(4): 040003.
[12] 刘冬梅, 李五一, 付秀华, 等. 基于腔内倍频的457 nm激光器高反射腔镜的研制[J]. 中国激光, 2018, 45(11): 1103001.
[13] 邱小浪, 陈雪花, 朱仁江, 等. 小型化可调谐外腔面发射绿光激光器[J]. 中国激光, 2019, 46(4): 0401002.
[14] Li F, Chris H, Mahmoud F, et al. Highly strained InGaAs/GaAs multiwatt vertical-external-cavity surface-emitting laser emitting around 1170 nm[J]. Applied Physics Letters, 2007, 91(13): 131114.
[15] Thränhardt A, Kuznetsova I, Schlichenmaier C, et al. Nitrogen incorporation effects on gain properties of GaInNAs lasers: experiment and theory[J]. Applied Physics Letters, 2005, 86(20): 201117.
[16] LeinonenT, HärkönenA, Korpijärvi VM, et al. 589 nm multi-Watt narrow linewidth optically pumped semiconductor laser for laser guide stars[C]∥Advanced Solid-State Photonics 2010, January 31- February 3, 2010, San Diego, California. Washington, DC: OSA, 2010: ATuA10.
[17] Kantola E, Penttinen J, Ranta S N, et al. 72-W vertical-external-cavity surface-emitting laser with 1180-nm emission for laser guide star adaptive optics[J]. Electronics Letters, 2018, 54(19): 1135-1137.
[18] 王青, 曹玉莲, 何国荣, 等. 高功率VCSEL中应变补偿量子阱的理论设计[J]. 光电子·激光, 2008, 19(3): 304-307.
Wang Q, Cao Y L, He G R, et al. Theoretical design method of strain compensated quantum well in high power VCSELs[J]. Journal of Optoelectronics·Laser, 2008, 19(3): 304-307.
[19] 梁雪梅, 吕金锴, 程立文, 等. 920 nm光抽运垂直外腔面发射半导体激光器结构设计[J]. 发光学报, 2010, 31(1): 79-85.
[20] 王菲, 王晓华. 光泵浦垂直外腔面发射半导体激光技术[M]. 北京: 国防工业出版社, 2016.
WangF, Wang XH. Optically pumped vertical-external-cavity surface emitting semiconductor laser technology[M]. Beijing: National Defense Industry Press, 2016.
[21] 汤瑜, 曹春芳, 赵旭熠, 等. InGaAs/GaAs/InGaP量子阱激光器的激光单模特性研究[J]. 激光与光电子学进展, 2019, 56(13): 131402.
[23] Leinonen T, Korpijärvi V M, Härkönen A, et al. Recent advances in the development of yellow-orange GaInNAs-based semiconductor disk lasers[J]. Proceedings of SPIE, 2012, 8242: 824208.
[24] Kantola E, Leinonen T, Ranta S, et al. High-efficiency tunable yellow-orange VECSEL with an output power of 20 W[J]. Proceedings of SPIE, 2014, 8966: 89660D.
[25] Yu SF. Analysis and design of vertical cavity surface emitting lasers[M]. Hoboken: John Wiley & Sons, 2003, 194- 197.
[26] Brandon Morioka S. High-power optically pumped semiconductor laser apllications[J]. Proceedings of SPIE, 2011, 7919: 791913.
[27] Ahirwar P, Rotter T J, Shima D, et al. Growth and optimization of 2-μm InGaSb/AlGaSb quantum-well-based VECSELs on GaAs/AlGaAs DBRs[J]. IEEE Journal of Selected Topics in Quantum Electronics, 2013, 19(4): 1700611.
[28] 袁庆贺, 井红旗, 仲莉, 等. 大功率半导体激光器封装热应力研究[J]. 中国激光, 2019, 46(10): 1001009.
[29] Wang T B, Hsu W C, Chen I L, et al. Single-mode InGaAs photonic crystal vertical-cavity surface-emitting lasers emitting at 1170 nm[J]. Journal of the Electrochemical Society, 2007, 154(5): H351.
[30] Yang H D, Lu C, Hsiao R S, et al. Characteristics of MOCVD- and MBE-grown InGa(N)As VCSELs[J]. Semiconductor Science and Technology, 2005, 20(8): 834-839.
[31] CalvezS. GaInNAs (Sb) for solid-state laser engineering[C]∥2011 13th International Conference on Transparent Optical Networks, June 26-30, 2011, Stockholm, Sweden. New York: IEEE, 2011: 1- 4.
[32] Tokranov V, Yakimov M, Oktyabrsky S. QD VCSELs with InAs/InGaAs short period superlattice QW injector[J]. Proceedings of SPIE, 2009, 7224: 72240T.
[33] YangZ, Albrecht AR, Cederberg JG, et al. DBR-free semiconductor disk lasers[C]∥CLEO: Science and Innovations 2015, May 10-15, 2015, San Jose, California. Washington, DC: OSA, 2015: SM3F. 7.
[34] Yang Z, Albrecht A R, Cederberg J G, et al. Broadly tunable DBR-free semiconductor disk laser[J]. Proceedings of SPIE, 2016, 9734: 97340I.
Article Outline
张卓, 宁永强, 张建伟, 张继业, 曾玉刚, 张俊, 张星, 周寅利, 黄佑文, 秦莉, 刘云, 王立军. 1160 nm光泵垂直外腔面发射激光器设计及制备[J]. 中国激光, 2020, 47(7): 0701020. Zhang Zhuo, Ning Yongqiang, Zhang Jianwei, Zhang Jiye, Zeng Yugang, Zhang Jun, Zhang Xing, Zhou Yinli, Huang Youwen, Qin Li, Liu Yun, Wang Lijun. Design and Fabrication of 1160-nm Optically-Pumped Vertical-External-Cavity Surface-Emitting Laser[J]. Chinese Journal of Lasers, 2020, 47(7): 0701020.









