激光与光电子学进展, 2022, 59 (9): 0922019, 网络出版: 2022-05-10
面向光刻机晶圆台的超精密光栅定位技术  下载: 3401次特邀综述
下载: 3401次特邀综述
Ultraprecision Grating Positioning Technology for Wafer Stage of Lithography Machine
图 & 表
图 1. 光刻机晶圆台及六自由度定位示意图。(a)光刻机系统示意图;(b)光刻机晶圆台;(c)晶圆台精密位移部件误差源;(d)六自由度运动误差示意图
Fig. 1. Schematic diagrams of wafer stage and six-degree-of-freedom positioning in lithography machine. (a) Schematic diagram of lithography system; (b) photo of worktable of lithography machine; (c) error sources of precision displacement parts of worktable; (d) schematic diagram of six-degree-of-freedom motion error

图 2. 荷兰ASML光刻机所用的激光干涉仪与光栅干涉仪测量系统对比。(a)激光干涉仪测量系统;(b)光栅干涉仪测量系统
Fig. 2. Comparison of laser interferometer and grating interferometer measurement system used by ASML lithography machine in the Netherlands. (a) Laser interferometer measurement system; (b) grating interferometer measurement system
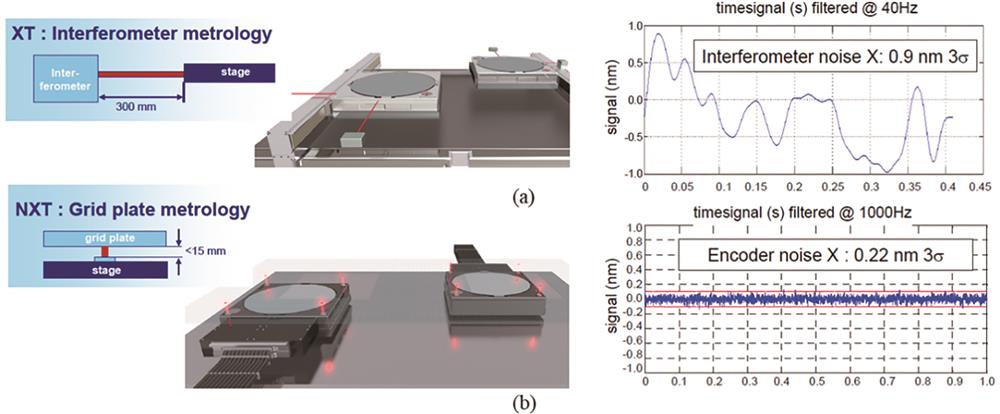
图 3. 高精度光栅干涉仪基本原理和亚纳米测量方案。(a)一维衍射光栅位移测量原理;(b)Magnescale光栅干涉仪;(c)自准直结构光栅干涉仪
Fig. 3. Basic principle of high precision grating interferometer and sub-nano measurement scheme. (a) Principle of one dimensional diffraction grating displacement measurement; (b) Magnescale grating interferometer; (c) self-collimating grating interferometer

图 5. Heidenhain公司开发的KGM 282二自由度光栅干涉仪[37]
Fig. 5. KGM 282 two-degree-of-freedom grating interferometer developed by Heidenhain company[37]

图 7. 基于二维光栅的面内XY二自由度光栅干涉仪
Fig. 7. XY two-degree-of-freedom grating interferometer based on two-dimensional grating
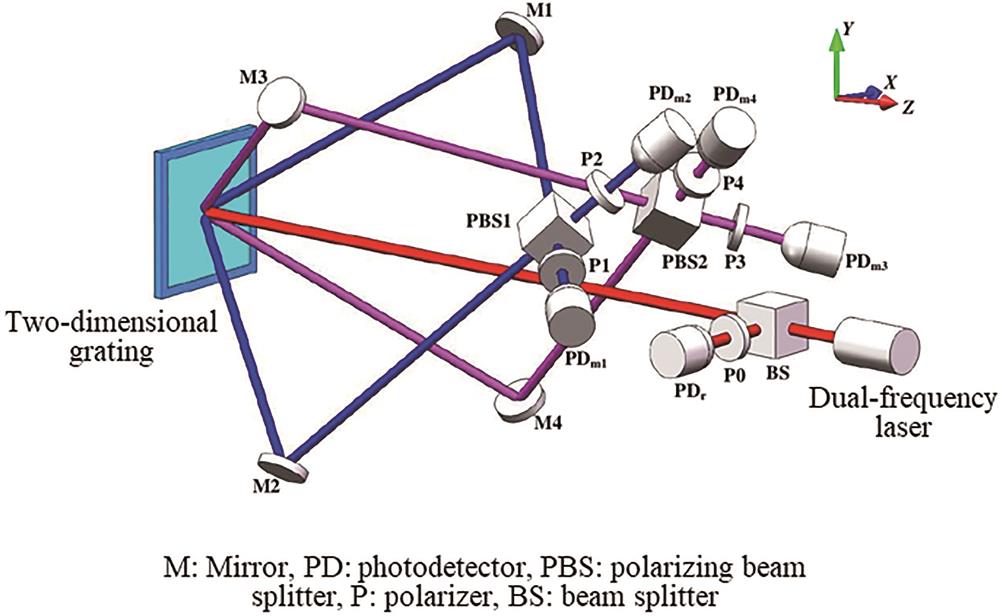
图 8. 基于二维光栅的具有面外测量能力的XYZ三自由度光栅干涉仪。(a)三自由度光栅干涉仪;(b)自准直结构三自由度光栅干涉仪
Fig. 8. XYZ three-degree-of-freedom grating interferometer with out of plane measurement capability based on two-dimensional grating. (a) Three-DOF grating interferometer; (b) three-DOF grating interferometer with self-collimating structure

图 9. 基于双光栅的外差三自由度光栅干涉仪
Fig. 9. Heterodyne three-degree-of-freedom grating interferometer based on two gratings

图 10. 基于单光栅共光路的外差三自由度光栅干涉仪
Fig. 10. Heterodyne three-degree-of-freedom grating interferometer with single grating and common optical path
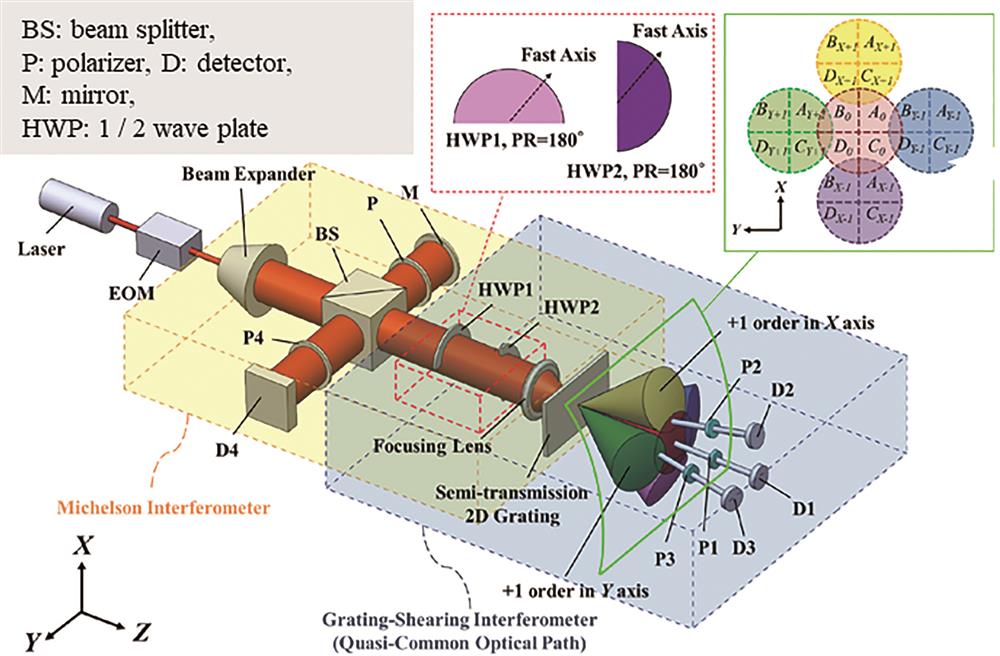
图 12. 多测量点六自由度测量系统。(a)基于二维光栅的三光束-六自由度测量系统;(b)两测点-三测量单元的六自由度测量系统
Fig. 12. Multi-measuring-point six-degree-of-freedom measuring system. (a) Three-beam six-DOF measurement system based on two-dimensional grating; (b) six-DOF measurement system based on two measuring points and three measuring units

图 13. 外差式三测点六自由度测量系统
Fig. 13. Heterodyne three measuring points and six-degree-of-freedom measuring system
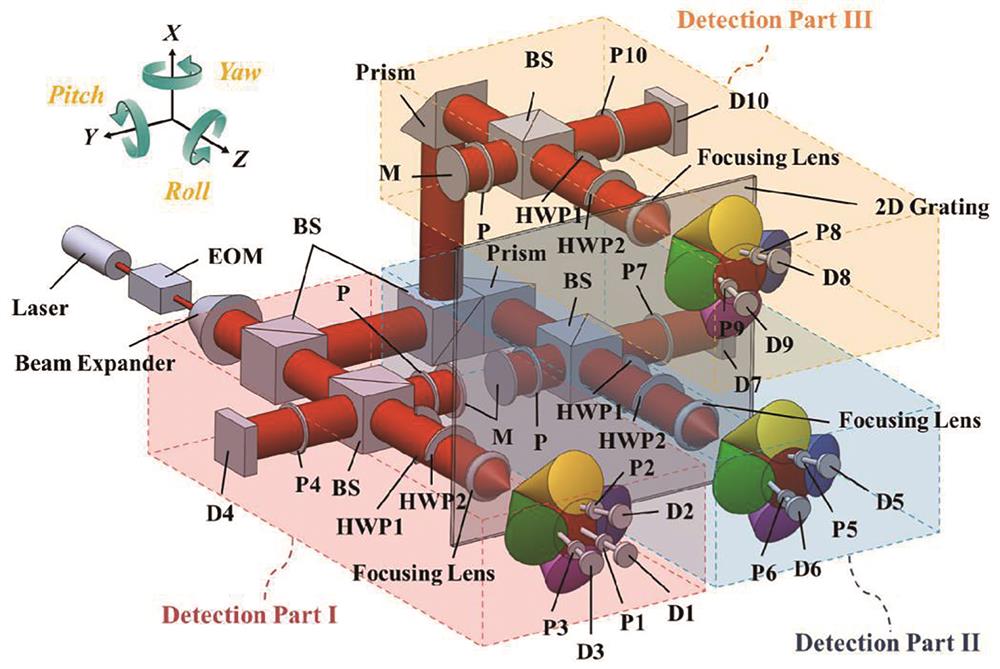
图 14. 大面积、高分辨率投影光刻技术
Fig. 14. Illustration of large-area, high-resolution projection lithography technology
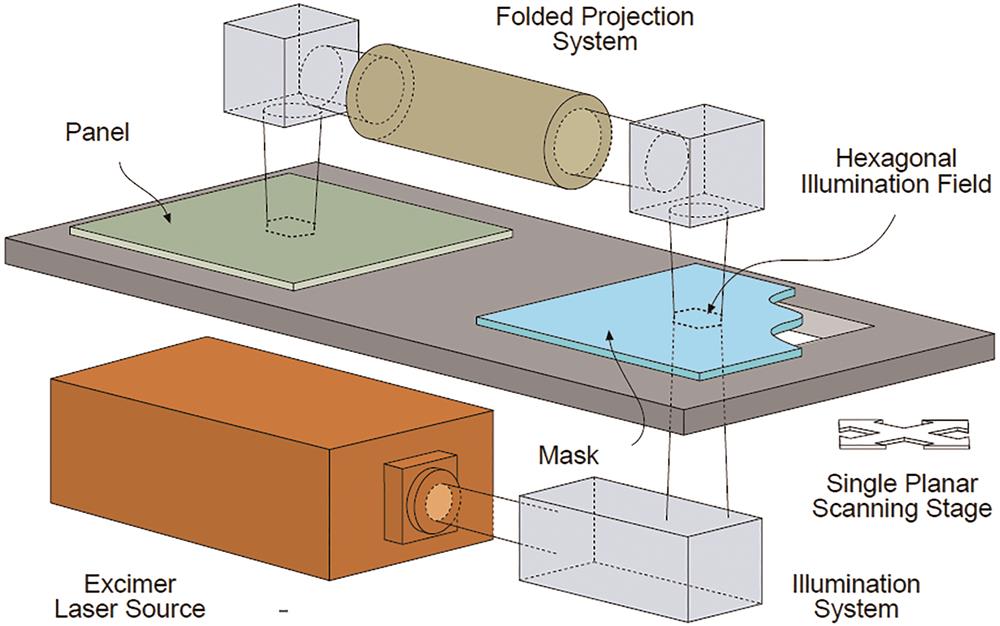
图 15. 基于正交双洛埃镜干涉单元的干涉曝光系统
Fig. 15. Interference exposure system based on the orthogonal two-axis Lloyd’s mirror interference unit
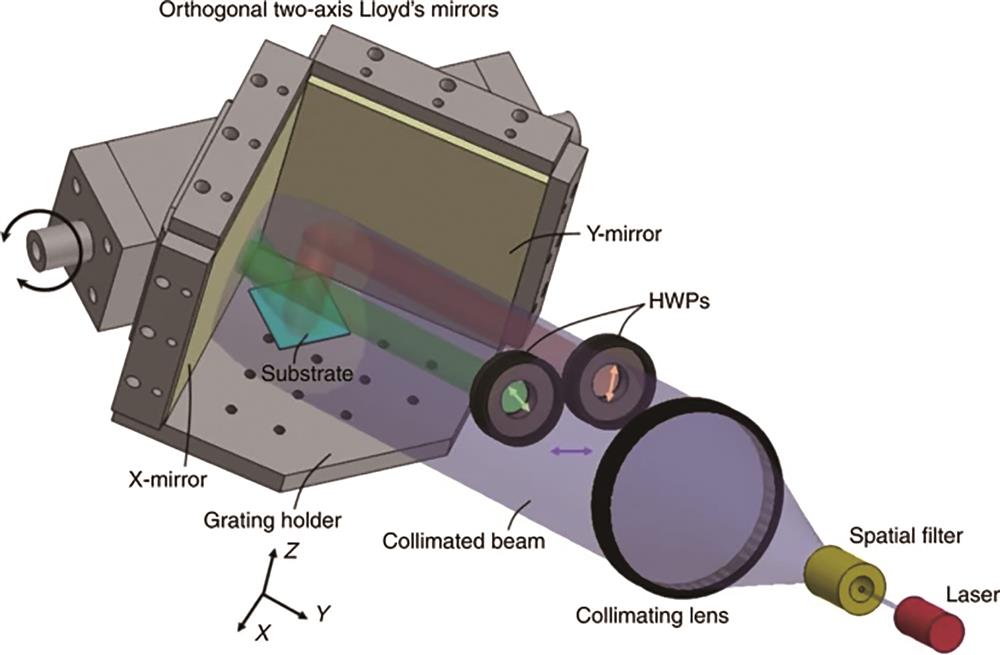
图 16. ASML公司采用的“四光栅-四读数头”技术路线
Fig. 16. Technical route of “four gratings-four reading heads” adopted by ASML company
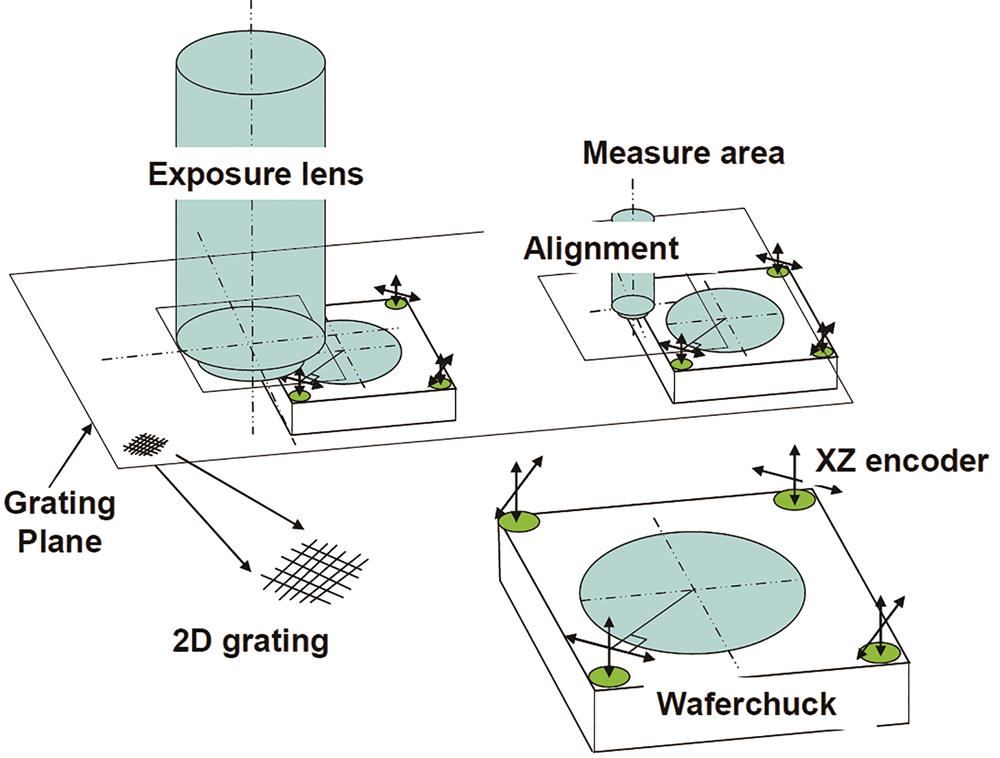
图 17. 多光栅-多读数头坐标系几何关系运算及二自由度光栅干涉仪测试
Fig. 17. Geometric relation calculation of multi grating multi reading head coordinate system and test of two-degree-of-freedom grating interferometer

图 18. 基于大面积波前干涉获取的光栅面型误差与周期偏差及其比对结果
Fig. 18. Grating profile error and periodic deviation obtained based on large-area wavefront interference and their comparison results

表 1先进节点14 nm光刻机晶圆台需满足的性能要求
Table1. Performance requirements for advanced node 14 nm lithography machine workpiece stage
|
表 2光栅干涉仪性能对照表
Table2. Performance comparison of grating interferometer
|
朱俊豪, 汪盛通, 李星辉. 面向光刻机晶圆台的超精密光栅定位技术[J]. 激光与光电子学进展, 2022, 59(9): 0922019. Junhao Zhu, Shengtong Wang, Xinghui Li. Ultraprecision Grating Positioning Technology for Wafer Stage of Lithography Machine[J]. Laser & Optoelectronics Progress, 2022, 59(9): 0922019.