面向光刻机晶圆台的超精密光栅定位技术  下载: 3392次特邀综述
下载: 3392次特邀综述
光栅干涉仪凭借高精度和高鲁棒性,成为先进节点光刻机中的重要定位装置。针对14 nm及以下节点光刻机晶圆台的定位需求,综述了多自由度纳米/亚纳米测量精度的零差式和外差式光栅干涉仪的发展,并介绍了“四光栅-四读数头”的光刻机六自由度位移测量系统布局。为了获得更高的精度和可溯源性,综合分析了光栅干涉仪中的环境误差、安装误差和仪器内在误差,并提出了光栅干涉仪实现亚纳米测量精度的关键问题,期望为光栅干涉仪精度提升和系统搭建提供初步指导。
Grating interferometers are becoming important positioning instruments in advanced node lithography machines owing to their high precision and robustness. To meet ultrahighly accurate positioning demands in the worktable of ≤14-nm node lithography machines, homodyne and heterodyne grating interferometry technologies and core systems with multidegree-of-freedom (multi-DOF) and nano/subnanometer metric accuracy were reviewed. Furthermore, a six-DOF positioning system in a current lithography machine enabled by an optimal configuration of “four gratings-four reading heads” was illustrated. Finally, errors in grating interferometers, including environmental error, installation error, and instrument inherent error were briefly discussed, and key challenges in error modeling, separation, and compensation were reviewed for achieving subnanometric accuracy and long-term accuracy stability. Hopefully, this study can provide preliminary guidelines for improving the accuracy and constructing various systems of grating interferometers.
1 引言
集成电路(IC)产业作为支撑国家经济发展和保障****的战略性、基础性和先导性产业之一,是新一代信息技术产业的核心。2021年,我国集成电路进口总额为2.7万亿元,规模远超原油进口总额(1.6万亿元),集成电路装备的国产化迫在眉睫[1]。光刻是集成电路制造中最复杂、最关键的工艺步骤,光刻机作为关键设备,研发的技术门槛和资金门槛高,最先进的5~3 nm光刻机仅有荷兰ASML可以生产。国内技术领先的上海微电子装备有限公司已量产的光刻机中性能最优的是90 nm光刻机,28 nm光刻机仍在研制中,与国际高端光刻机在节点上有非常大的差距。全行程大于300 mm的晶圆台是光刻机的三大核心部件之一,针对全行程晶圆台的超精密定位技术是光刻机中的关键核心技术。
激光干涉仪和光栅干涉仪是当前光刻机晶圆台精密定位的两条重要技术路线。激光干涉仪以激光波长为基准,具有高精度和可溯源性,是超精密定位常用的装置。为了测量晶圆台多自由度位移,需采用多台激光干涉仪搭建多自由度测量系统。由于激光干涉仪的光路较长,即使采取环境补偿,激光干涉仪仍存在纳米级的死程误差[2-4]。此外,多台激光干涉仪的光路难以保证对准到空间中同一个点,会产生阿贝误差和余弦误差,不利于测量精度[5-8]。因此在光刻机晶圆台中,激光干涉仪被光栅干涉仪部分替代[9-10]。另一方面,光栅干涉仪以光栅栅距为基准,利用光栅的衍射效应易于实现单点多自由度测量。由于光栅干涉仪的光路较短,具备更高的环境鲁棒性,适合光刻机六自由度超精密定位的需求。
本文首先介绍14 nm及以下节点光刻机晶圆台的定位需求,之后根据光栅干涉仪的研究现状,综述多自由度纳米/亚纳米精度光栅干涉测量系统的发展,并对面向光刻机需求的光栅干涉仪布局进行介绍,最后详述了光栅干涉仪精度和误差分析的关键问题。
2 先进节点光刻机晶圆台的定位需求
套刻误差是光刻机的重要性能指标之一。14 nm节点光刻机(“节点”术语在28 nm后,代指一代半导体技术工艺)的套刻误差要求小于5.7 nm[11]。从IEEE 2021年版的国际设备和系统蓝图中可以得到,“7 nm”节点的套刻误差最大为3.5 nm,“5 nm”节点为3 nm,“3 nm”节点为2.4 nm,“2.1 nm”节点为2 nm,“1.5 nm”节点为1.6 nm[12]。由于光刻机中的光源系统十分庞大,由曝光台和测量台组成的晶圆台承载硅片完成进给运动,如[

图 1. 光刻机晶圆台及六自由度定位示意图。(a)光刻机系统示意图;(b)光刻机晶圆台;(c)晶圆台精密位移部件误差源;(d)六自由度运动误差示意图
Fig. 1. Schematic diagrams of wafer stage and six-degree-of-freedom positioning in lithography machine. (a) Schematic diagram of lithography system; (b) photo of worktable of lithography machine; (c) error sources of precision displacement parts of worktable; (d) schematic diagram of six-degree-of-freedom motion error
表 1. 先进节点14 nm光刻机晶圆台需满足的性能要求
Table 1. Performance requirements for advanced node 14 nm lithography machine workpiece stage
|
光刻机晶圆台的定位需求如
当前,光刻机晶圆台通常采用多轴双频激光干涉仪测量其六自由度位移。[
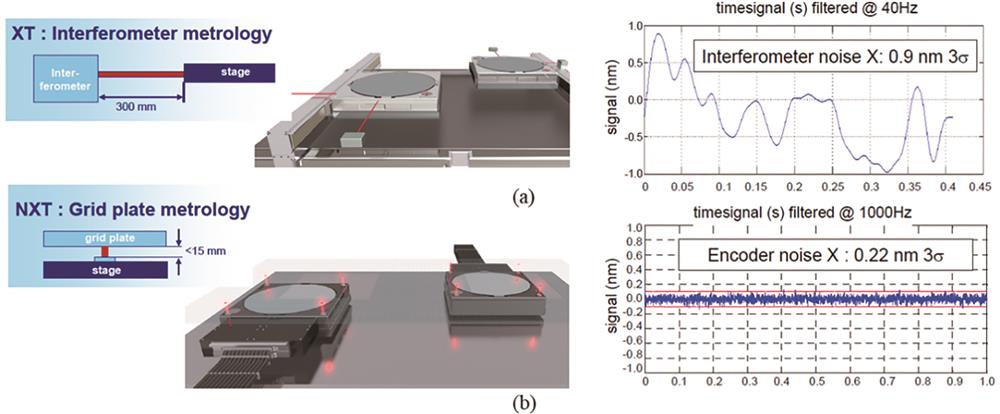
图 2. 荷兰ASML光刻机所用的激光干涉仪与光栅干涉仪测量系统对比。(a)激光干涉仪测量系统;(b)光栅干涉仪测量系统
Fig. 2. Comparison of laser interferometer and grating interferometer measurement system used by ASML lithography machine in the Netherlands. (a) Laser interferometer measurement system; (b) grating interferometer measurement system
综上所述,发展先进的光栅干涉测量技术,解决测量范围、精度、动态性之间的固有矛盾,进而实现光刻机晶圆台的超精密定位测量,解决光刻机的核心瓶颈,对于实现光刻机的全面国产化,促进电子信息产业的良性发展,具有重大的意义。
3 超精密光栅定位技术
光栅干涉仪属于光栅编码器的一种,其使用的是栅距小于20 μm的衍射光栅。光栅干涉仪基于光栅衍射光多普勒频移产生的干涉条纹变化,对干涉信号解耦实现位移测量[18-21]。根据测量自由度分类,光栅干涉仪可以分为单自由度光栅干涉仪、二自由度光栅干涉仪和多自由度光栅干涉仪。当前单自由度光栅干涉仪和二自由度面内光栅干涉仪的技术较为成熟,已有商用产品,例如Magnescale的激光尺和Heidenhain KGM系列等,而多自由度光栅干涉仪,包括三自由度和六自由度的光栅干涉仪仍处于研发中,未实现小型化和集成化。根据测量原理,光栅干涉仪可以分为零差干涉测量和外差干涉测量。零差干涉使用单频激光,其干涉信号是一个强度随着位移而变化的信号,但是容易受到光功率变化、环境波动等影响造成信号强度变化,从而产生误差,此外单个零差干涉信号无法辨别运动方向,因此需要通过移相光路产生90°相移以实现辨向[22-26],增大了干涉仪体积。外差干涉仪使用双频激光,其信号是一个相位随着位移变化的拍频信号,利用拍频信号解耦相位得到位移信息,拍频信号抗干扰能力较强,有利于超高精度测量[27-28]。但是,外差干涉测量的频差会影响到测量速度[29-30],高频差的声光/电光调制器会提高成本,此外由于光学器件的非理想化,会造成频率混叠引起误差[31-32]。
3.1 高精度光栅干涉仪及面内XY二自由度测量的发展
光栅干涉仪从最初的基于一维衍射光栅发展而来,基本原理如[

图 3. 高精度光栅干涉仪基本原理和亚纳米测量方案。(a)一维衍射光栅位移测量原理;(b)Magnescale光栅干涉仪;(c)自准直结构光栅干涉仪
Fig. 3. Basic principle of high precision grating interferometer and sub-nano measurement scheme. (a) Principle of one dimensional diffraction grating displacement measurement; (b) Magnescale grating interferometer; (c) self-collimating grating interferometer
虽然单自由度光栅干涉仪能够达到亚纳米的精度,但是需在采用层叠式的运动台上使用,不适用于光刻机等需要多自由度定位的场合。为解决多自由度测量的难题,能同时测量两个位移自由度上的运动量的二自由度光栅干涉仪被开发出来。夏豪杰[36]提出的二自由度光栅干涉仪采用两个直交方向上槽型一致的二维衍射光栅,基于单频激光零差干涉的原理,在两个衍射方向上分别获取多普勒频移产生的相位变化,从而解算出两个方向上的位移,如
![Heidenhain公司开发的KGM 282二自由度光栅干涉仪[37]](/richHtml/lop/2022/59/9/0922019/img_05.jpg)
图 5. Heidenhain公司开发的KGM 282二自由度光栅干涉仪[37]
Fig. 5. KGM 282 two-degree-of-freedom grating interferometer developed by Heidenhain company[37]
为了实现绝对测量,Li等[38-40]对二维平面光栅进行绝对编码,通过结合增量码道和绝对码道的方法实现了平面二自由度的准绝对式测量,如
同时,为了进一步提升干涉信号的质量,提升对环境波动的抵抗能力,基于外差干涉的原理的二自由度光栅尺也陆续被提出来,其基本原理如
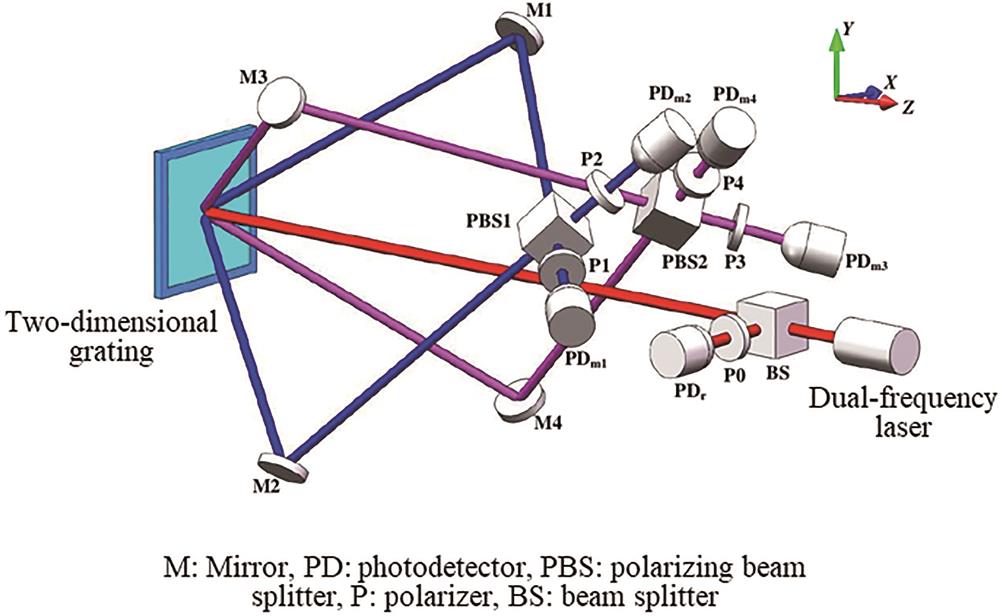
图 7. 基于二维光栅的面内XY二自由度光栅干涉仪
Fig. 7. XY two-degree-of-freedom grating interferometer based on two-dimensional grating
平面二自由度光栅干涉仪在实现二自由度测量中,对于解决阿贝误差、降低测量系统尺寸等方面都有很好的作用,但是由于无法实现面外自由度Z的测量,其仍然无法满足当前光刻机晶圆台六自由度的定位要求。不过,值得注意的是,其为多自由度测量的光栅干涉仪研发提供了有益的借鉴。
3.2 具有面外位移测量能力的XYZ三自由度光栅干涉仪
根据上文所述,基于二维平面光栅搭建平面位移测量系统可以有效克服阿贝误差,实现多自由度测量,利于结构紧凑化。在上述的结构上加以丰富和改进,基于二维平面光栅可以搭建三自由度和六自由度测量系统,实现面内位移XY和面外位移Z的测量及三个角位移的测量。因此,基于二维光栅的干涉测量系统有能力满足光刻机高精度多自由度的测量需求。
3.2.1 零差干涉
零差干涉式光栅干涉仪基于单频激光干涉原理,其产生的信号是直流信号,通过信号的幅值周期性变化解算得到位移。基于零差干涉技术可以构造多自由度光栅测量系统。为了实现面外位移的测量,日本东北大学的Kimura等[23]提出了一种新型的三自由度位移测量方法,该方法能够同时测量XYZ三个方向的位移,如[

图 8. 基于二维光栅的具有面外测量能力的XYZ三自由度光栅干涉仪。(a)三自由度光栅干涉仪;(b)自准直结构三自由度光栅干涉仪
Fig. 8. XYZ three-degree-of-freedom grating interferometer with out of plane measurement capability based on two-dimensional grating. (a) Three-DOF grating interferometer; (b) three-DOF grating interferometer with self-collimating structure
该方法采用双光栅结构,来自参考光栅和测量光栅的衍射光干涉,测量光栅的三自由度移动会使得干涉信号发生变化,通过解析干涉信号,获取三自由度位移。合理设计光栅参数和电路细分,可以得到亚纳米的分辨率。其优势在于仅有一个测量点,容易扩展到多读数头分布式布置。但需指出,该系统在Z向的位移测量,有一定限制,过大的Z位移会导致探测器上的光斑移动,测量信号减弱,Z向测量范围一般在1 mm以内。这对于平面运动中微小的Z向误差运动是足够的。随后,国内哈尔滨工业大学Lin等[43]于2017年提出了能够拓展Z向位移的XYZ三自由度光栅干涉仪,如[
3.2.2 外差干涉
外差三自由度光栅干涉仪目前主要有两个技术路线,一种是哈尔滨工业大学林杰等[44]提出的方法,该方法采用了与[

图 9. 基于双光栅的外差三自由度光栅干涉仪
Fig. 9. Heterodyne three-degree-of-freedom grating interferometer based on two gratings
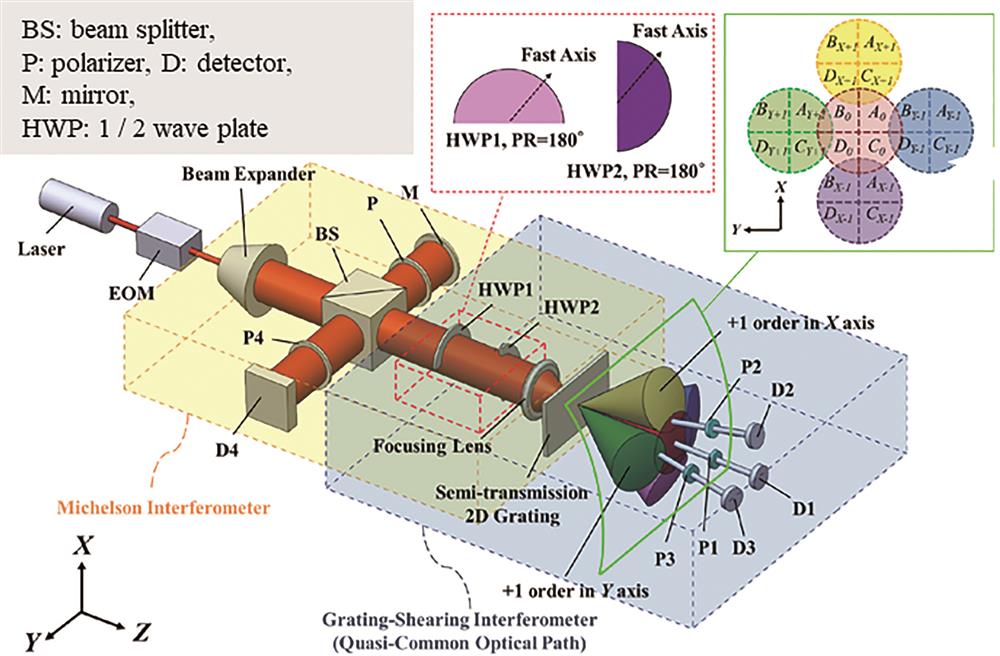
图 10. 基于单光栅共光路的外差三自由度光栅干涉仪
Fig. 10. Heterodyne three-degree-of-freedom grating interferometer with single grating and common optical path
3.3 六自由度光栅干涉仪
如何实现六自由度高精度测量,是精密测量领域国际公认的一个难题。无论是基于零差干涉原理,还是基于外差干涉原理,六自由度测量系统结构往往复杂。当前的六自由度测量方案可以分为单测量点六自由度测量系统和多测量点六自由度测量系统。
3.3.1 单测量点六自由度测量系统
研究人员在[
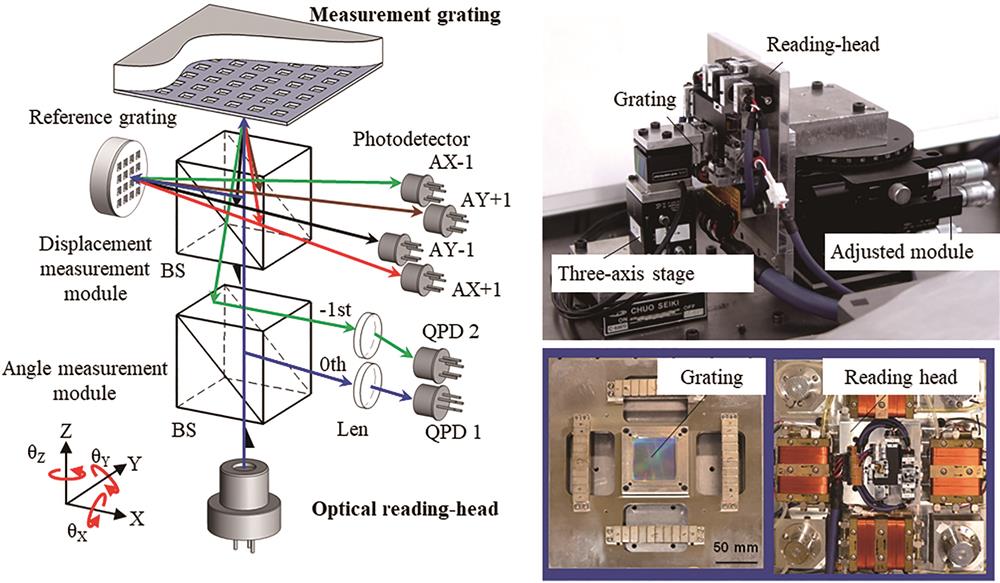
图 11. 单测量点六自由度测量系统
Fig. 11. Single-measuring-point six-degree-of-freedom measuring system
3.3.2 多测量点六自由度测量系统
在多测量点冗余合成六自由度方面,研究人员提出的三光束-六自由度测量系统如[

图 12. 多测量点六自由度测量系统。(a)基于二维光栅的三光束-六自由度测量系统;(b)两测点-三测量单元的六自由度测量系统
Fig. 12. Multi-measuring-point six-degree-of-freedom measuring system. (a) Three-beam six-DOF measurement system based on two-dimensional grating; (b) six-DOF measurement system based on two measuring points and three measuring units
基于上述基本原理,韩国光州科技大学[49]、台湾科技大学[50]、清华大学[51]前后提出了几种不同的六自由度同步测量原理。韩国光州科技大学Lee等[49]提出的基于一维光栅的六自由度测量系统包含两个测量点和三个测量单元,如[
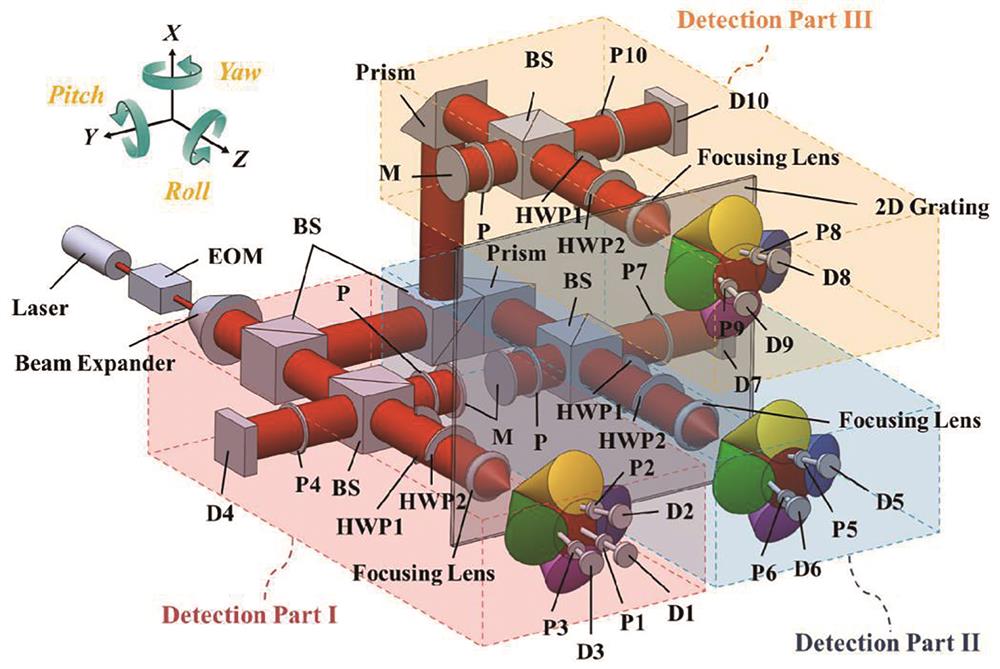
图 13. 外差式三测点六自由度测量系统
Fig. 13. Heterodyne three measuring points and six-degree-of-freedom measuring system
上文所述光栅干涉仪的性能对比如
表 2. 光栅干涉仪性能对照表
Table 2. Performance comparison of grating interferometer
|
3.4 光栅加工技术
在光栅干涉仪中,计量光栅是核心光学元件,在多自由度测量系统中,二维光栅的加工精度会直接影响到光栅干涉仪的测量精度。传统上,二维光栅的加工方法主要有三种:机械划刻、投影光刻和激光干涉光刻,其中激光干涉光刻又被称为全息光刻法[53]。机械划刻方法加工二维光栅需要用到光栅刻划机,光栅的栅线和槽型由精密运动台控制金刚石刀具运动实现,Wei[54]提出了一种基于快速刀具伺服系统的金刚石逐点切削方法来加工二维光栅,实验结果表明,光栅周期在0.1 mm左右。机械划刻由于刀头尺寸限制,在二维光栅加工中,其最小周期为10
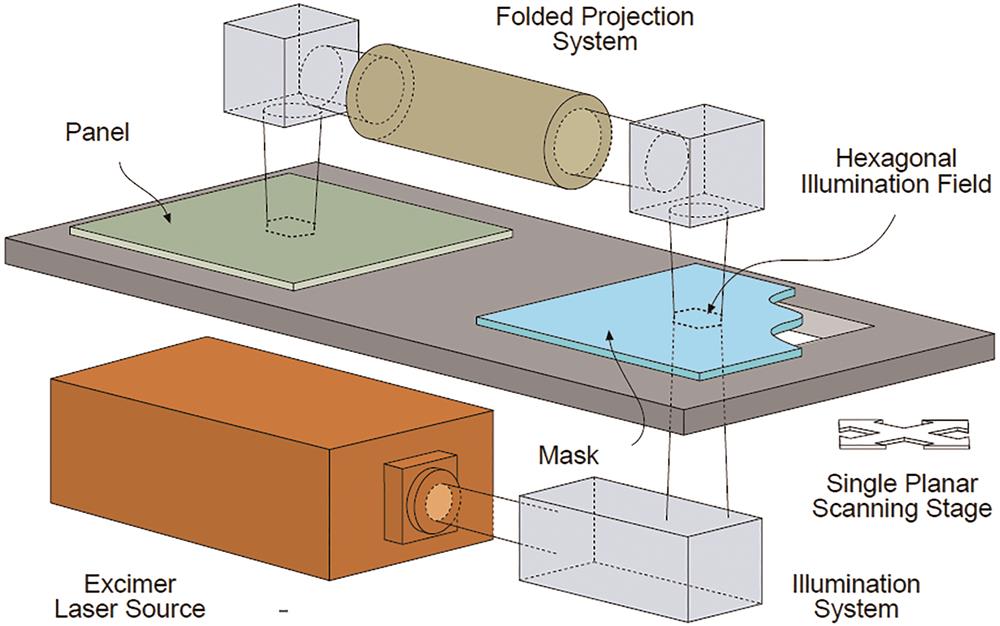
图 14. 大面积、高分辨率投影光刻技术
Fig. 14. Illustration of large-area, high-resolution projection lithography technology
激光干涉光刻法使用一系列的光学元件,将激光束分束、滤波、扩束、准直,并将分束的准直光束在空间中干涉,形成干涉条纹,分布在预先甩胶的光学基片上实现曝光,后续通过显影即可获得浮雕状的光刻胶掩膜。激光干涉光刻法具有大面积同时加工的特点,效率极高且成本低廉,是光栅加工的重要工艺[56]。在光栅的激光干涉加工工艺方面,研究人员开展了大量研究。清华大学曾理江团队Ma等[57-58]提出了一种宽光束扫描曝光方法,用于制作低杂散光光栅和大尺寸光栅,Shi等[59-60]使用红光双光束干涉的方法制造一维拼接光栅,并通过自参考对准的方法有效增大了光栅的面积,Zhou等[61]基于双洛埃镜干涉仪和两个主周期方向信息,通过单次曝光实现了二维光栅的曝光拼接和垂直度控制。Li等[62]面向光栅光谱仪应用,基于双光束干涉方法实现了凹面光栅的制造方法。此外,Li等[63-66]提出了面向双读数头的一维阵列光栅加工方法和基于双洛埃镜全息光刻工艺的二维光栅加工方法。Xue等[67]在此基础上加以改进,基于单光束单曝光方案和非正交系统分析的正交双洛埃镜干涉系统,实现了可在大面积上制备具有高均匀性的1 µm级交叉光栅图案。之后,开发的三光束单次曝光的双洛埃镜全息光刻工艺如
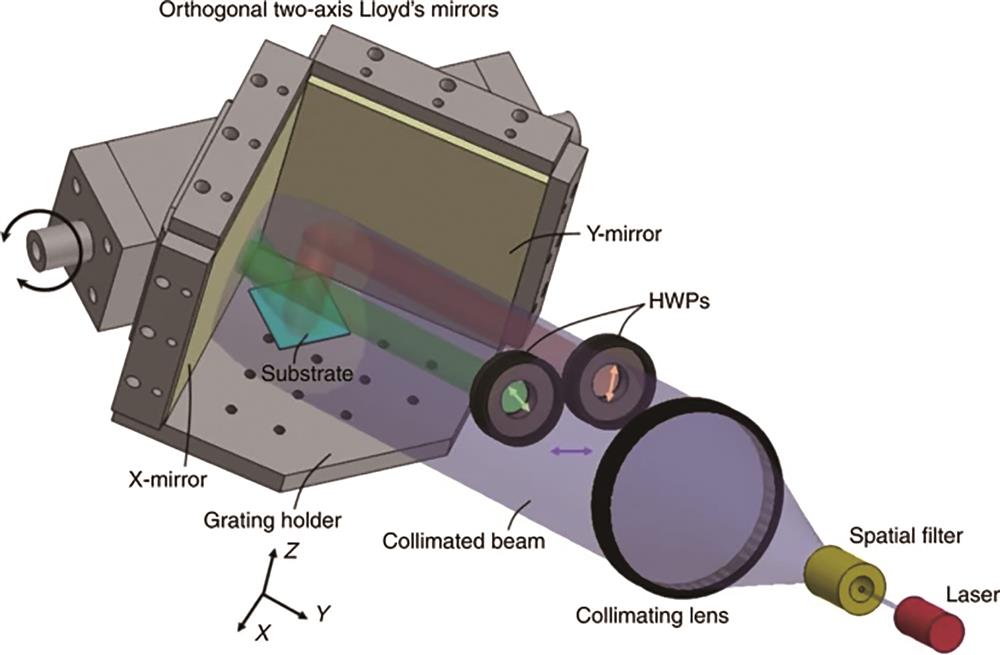
图 15. 基于正交双洛埃镜干涉单元的干涉曝光系统
Fig. 15. Interference exposure system based on the orthogonal two-axis Lloyd’s mirror interference unit
4 面向光刻机晶圆台应用的光栅干涉仪布局
如前文所述,三自由度和六自由度光栅干涉仪的原理样机陆续被提出,但将多自由度光栅干涉仪应用于光刻机晶圆台,首先要解决的是多自由度光栅干涉仪的亚纳米测量误差理论研究,包括误差建模机制、高精度校准和动态补偿。同时为了保证光刻机晶圆台的稳定性和动态性能,六自由度测量系统应当满足读数头小型化的要求。
当前,ASML公司率先采用了“四光栅-四读数头”的技术路线,该技术基于四个二自由度的光栅干涉仪和四块二维光栅,每个读数头可以实现一个面内自由度X和一个面外自由度Z的测量,通过四个测量点解算冗余数据可获得晶圆台的六自由度位移,如
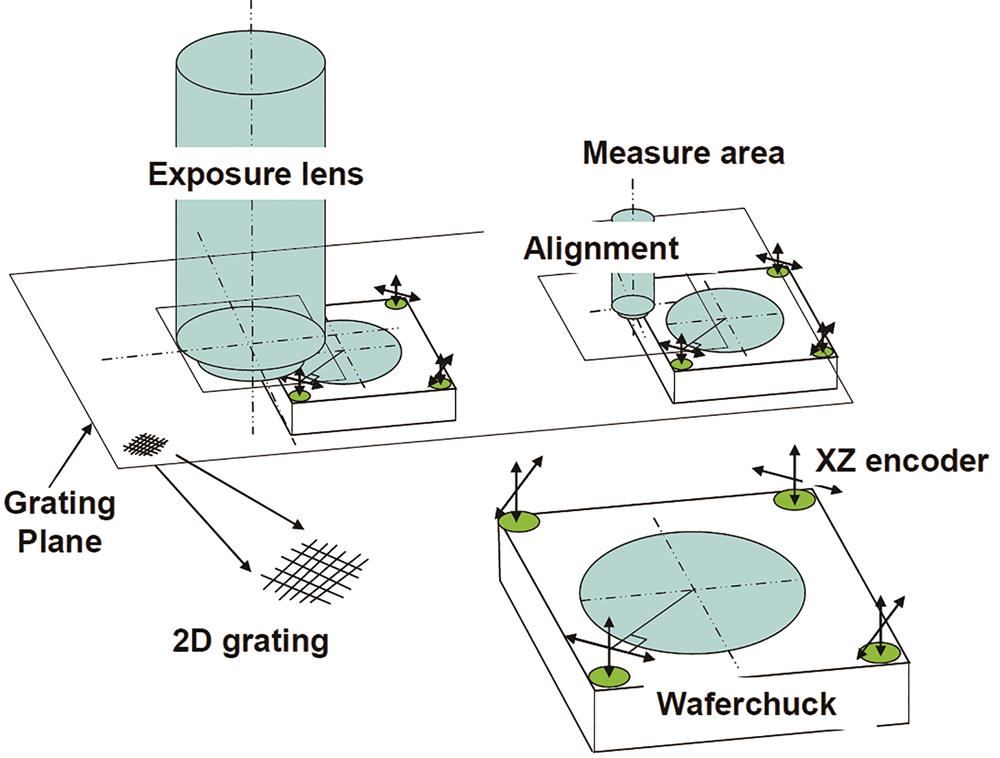
图 16. ASML公司采用的“四光栅-四读数头”技术路线
Fig. 16. Technical route of “four gratings-four reading heads” adopted by ASML company
清华大学朱煜教授团队Ye等[4,70]针对目前ASML公司采用的海德汉“四光栅-四读数头”技术路线,开展了多读数头与晶圆台坐标系之间的几何关系计算与仿真,并初步搭建测试了该技术路线中的二自由度光栅干涉仪,如

图 17. 多光栅-多读数头坐标系几何关系运算及二自由度光栅干涉仪测试
Fig. 17. Geometric relation calculation of multi grating multi reading head coordinate system and test of two-degree-of-freedom grating interferometer
5 光栅干涉仪的精度和误差分析
在前文中,光栅干涉仪根据原理可以分为零差式和外差式,无论是哪一种光栅干涉仪,误差分析和量值溯源都是其实现亚纳米精度测量的关键。根据误差源,光栅干涉仪的测量误差可以分为环境误差、安装误差和仪器内在误差。在环境误差方面,由温度、振动导致的空气折射率误差和光学热漂移误差在几十纳米的量级,通常可以通过测量多点环境温度,进行拟合和标定实现折射率补偿[71-72]。安装误差可以分为阿贝误差、多轴串扰误差和余弦误差,可以通过建立误差几何模型实现补偿[73-74]。以上两种误差的补偿方法较为成熟,而仪器内在误差的产生原因更为复杂。
仪器内在误差包括光栅面型误差[75]、激光源频率/功率稳定性[76]及周期非线性误差[77]。光栅面型误差的影响与光栅的制造精度有关,由于激光光斑的直径远大于计量光栅的周期,因此面型误差实际会被数千条栅线所平均,例如对于5 mm的光斑直径和1 μm的光栅周期,即一个光斑覆盖5000条栅线,那么1 μm的光栅型面误差将对测量结果产生级别在0.2 nm左右的误差。为解决大面积光栅面型误差与周期偏差引入的测量误差,日本东北大学Gao等[78-80]基于斐索干涉仪原理的波前干涉方式获取并分离面型误差和周期偏差,如

图 18. 基于大面积波前干涉获取的光栅面型误差与周期偏差及其比对结果
Fig. 18. Grating profile error and periodic deviation obtained based on large-area wavefront interference and their comparison results
周期非线性误差主要由干涉仪中光学元件虚反射引起[82]。虚反射是指激光在通过透射或吸收元件时,除了发生向前的透射外,还有一小部分光在元件的各个界面上产生向后的反射,也被称为鬼反射现象。由于光栅在运动过程中,激光会产生多普勒频移,若是激光在光栅和光学元件表面发生多次虚反射,则多普勒频率产生的相位差会加倍,即产生了不同阶次的多普勒频移。Fu等[83]对基于反射镜的单自由度激光干涉仪的虚反射现象进行了分析,得到了如

图 19. 不同多普勒频移阶次的虚反射现象
Fig. 19. Virtual reflection phenomenon of different Doppler shift orders
对于外差干涉仪,双频激光偏振混叠和频率混叠也会引起周期非线性误差。通常外差干涉仪是以共光路形式搭建的,即空间中两个偏振方向正交的频率分量以同一束激光的形式射入测量光路,但是由于光源输出光非完全圆偏化、偏振器件的非理想化和安装误差等原因,造成激光的偏振混叠,两个分量会产生频率混叠,引起测量信号存在上下非对称的幅值包络,并导致位移测量产生周期性的非线性波动[84-86]。为了解决共光路外差干涉仪的偏振混叠和频率混叠现象,非共光路外差干涉仪被提出了,例如台湾工业技术研究院Wu等[87]早在1999年提出的一款非共光路外差激光干涉仪,清华大学Zhao等[88]提出的非线性误差在亚纳米级别的外差激光干涉仪,哈尔滨工业大学Hu等[89]提出的非共光路外差激光干涉仪,非共光路单自由度[90]、二自由度[91-92]和三自由度外差光栅干涉仪[93]等。非共光路外差干涉仪将两个频率分量分开,以两束激光的形式射入光路,最终在探测器上进行45°偏振合光,由于在整个测量光路中,两个频率分量未产生耦合,避免了偏振混叠和频率混叠。
当前,多自由度光栅干涉仪的误差模型仍是复杂且难以溯源的,需要建立完备的误差模型和误差分配机制。首先,对于外差式光栅干涉仪,光栅对激光的偏振态存在调制作用,且光栅对不同方向上的衍射光的偏振调制作用不相同,因此在周期非线性误差分析上,不能简单地以反射镜模型进行分析,多光学元件间的虚反射和频率混叠现象造成的周期非线性误差是外差式光栅干涉仪的关键问题。此外,无论是外差式还是零差式光栅干涉仪,都以光栅栅距为基准,保证大面积光栅加工中计量光栅本身的面型精度和可溯源性是关键研究问题。最后,对于光刻机中高速高动态的测量需求,如何实现高速高动态下的亚纳米精度测量也是一个关键问题。
6 总结
光刻机晶圆台的定位精度对光刻机的制程有重要影响。针对14 nm及以下先进节点光刻机中晶圆台的超精密定位问题,总结了多自由度零差式和外差式光栅干涉测量方案及光栅制造工艺,并对当前“四光栅-四读数头”的读数头布局进行了介绍。最后讨论了光栅干涉仪中精度分析和量值溯源的关键问题,提出了影响光栅干涉仪测量精度的关键问题,为解决光刻机晶圆台六自由度亚纳米定位需求提供参考。
[1] National Bureau of Statistics. Statistical bulletin of the people’s Republic of China on national economic and social development in 2021[N]. China Information News, 2022-03-01(1).
国家统计局. 中华人民共和国2021年国民经济和社会发展统计公报[N]. 中国信息报, 2022-03-01(1). 10.1177/000944550103700211
[2] 池峰, 朱煜, 张志平, 等. 双频激光干涉测量中的环境补偿技术[J]. 中国激光, 2014, 41(4): 0408004.
[17] 陈本永, 穆瑞珍, 周砚江, 等. 激光合成波长纳米测量干涉仪的非线性误差分析[J]. 中国激光, 2008, 35(2): 240-244.
[19] Shimizu Y, Chen L C, Kim D W, et al. An insight on optical metrology in manufacturing[J]. Measurement Science and Technology, 2020, 32(4): 042003.
[35] 王磊杰, 张鸣, 朱煜, 等. 超精密外差利特罗式光栅干涉仪位移测量系统[J]. 光学 精密工程, 2017, 25(12): 2975-2985.
[36] 夏豪杰. 高精度二维平面光栅测量系统及关键技术研究[D]. 合肥: 合肥工业大学, 2006: 51-76.
XiaH J. Research on precise 2-D plane grating measurement system and key technology[D]. Hefei: Hefei University of Technology, 2006: 51-76.
[42] Zhu Z B, Wu G H. Dual-comb ranging[J]. Engineering, 2018, 4(6): 772-778.
[44] 林杰, 关健, 金鹏, 等. 一种使用双频激光的三维光栅位移测量系统: CN103644848A[P]. 2014-03-19.
LinJ, GuanJ, JinP, et al. Three-dimensional grating displacement measuring system with dual-frequency laser: CN103644848A[P]. 2014-03-19.
[54] WeiG. Precision nanometrology[M]. London: Springer, 2010. 10.1007/978-1-84996-254-4
[75] 吴新朴, 韦怀坤, 刘正坤, 等. 用于检测光栅线密度的长程面形仪系统[J]. 光学学报, 2021, 41(6): 0612002.
[76] 高静, 焦东东, 刘杰, 等. 基于短光纤循环自外差法的激光线宽测量[J]. 光学学报, 2021, 41(7): 0712002.
[77] 张博, 严利平, 刁晓飞. 波片阵列对准误差对激光干涉非线性误差的影响[J]. 中国激光, 2022, 49(9): 0904003.
[84] 郝义伟, 孔新新, 才啟胜, 等. 环形器噪声对激光干涉测量系统影响分析[J]. 光学学报, 2021, 41(9): 0912003.
[91] 邢旭, 常笛, 胡鹏程, 等. 空间分离式外差二自由度平面光栅干涉仪[J]. 光学 精密工程, 2019, 27(8): 1727-1736.
[93] 胡鹏程, 谭久彬, 陈朋. 抗光学混叠的双频激光光栅干涉三维测量方法及系统: CN103604376B[P]. 2017-02-01.
HuP C, TanJ B, ChenP. Double frequency laser grating interference three-dimensional measurement method and system with optical aliasing resistance: CN103604376B[P]. 2017-02-01.
Article Outline
朱俊豪, 汪盛通, 李星辉. 面向光刻机晶圆台的超精密光栅定位技术[J]. 激光与光电子学进展, 2022, 59(9): 0922019. Junhao Zhu, Shengtong Wang, Xinghui Li. Ultraprecision Grating Positioning Technology for Wafer Stage of Lithography Machine[J]. Laser & Optoelectronics Progress, 2022, 59(9): 0922019.