1 中国电子科技集团公司第十三研究所, 河北石家庄 050051
2 固态微波器件与电路全国重点实验室, 河北石家庄 050051
介绍了一款基于 GaAs肖特基二极管单片工艺的 220 GHz倍频器的设计过程以及测试结果。为提高输出功率, 倍频器采用多阳极结构, 8个二极管在波导呈镜像对称排列, 形成平衡式倍频器结构。采用差异式结电容设计解决了多阳极结构端口散射参数不一致问题, 提高了倍频器的转换效率和工作带宽。对设计的倍频器进行流片、装配和测试, 测试结果显示: 倍频器在 204~ 234 GHz频率范围内, 转化效率大于 15%; 226 GHz峰值频率下实现最大输出功率为 90.5 mW, 转换效率为 22.6%。设计的 220 GHz倍频器输出功率高, 转化效率高, 工作带宽大。
倍频器 太赫兹 肖特基二极管 结电容 单片 frequency doubler tearhertz Schottky barrier diode junction capacitance Microwave Monolithic Integrated Circuit 太赫兹科学与电子信息学报
2023, 21(9): 1080
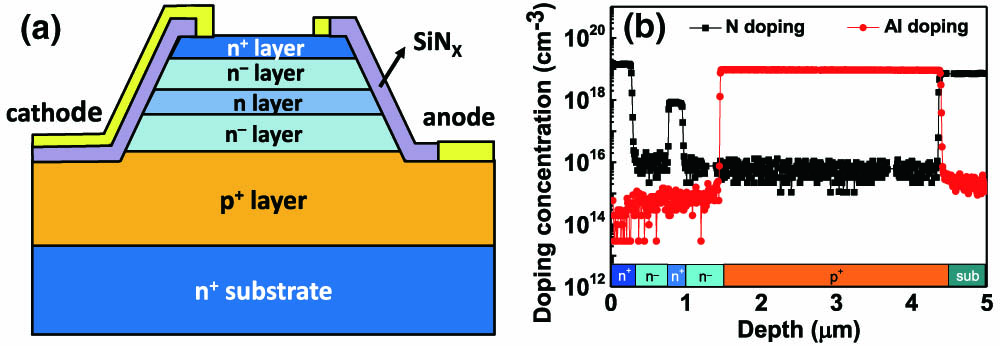
Author Affiliations
Abstract
National Key Laboratory of ASIC, Hebei Semiconductor Research Institute, Shijiazhuang 050051, China
In this work, high-stability 4H-SiC avalanche photodiodes (APDs) for ultraviolet (UV) detection at high temperatures are fabricated and investigated. With the temperature increasing from room temperature to 150°C, a very small temperature coefficient of 7.4 mV/°C is achieved for the avalanche breakdown voltage of devices. For the first time, the stability of 4H-SiC APDs is verified based on an accelerated aging test with harsh stress conditions. Three different stress conditions are selected with the temperatures and reverse currents of 175°C/100 µA, 200°C/100 µA, and 200°C/500 µA, respectively. The results show that our 4H-SiC APD exhibits robust high-temperature performance and can even endure more than 120 hours at the harsh aging condition of 200°C/500 µA, which indicates that 4H-SiC APDs are very stable and reliable for applications at high temperatures.
silicon carbide photodiode UV detector high temperature avalanche Geiger mode Chinese Optics Letters
2023, 21(3): 032502
1 西安交通大学 信息与通信工程学院,陕西 西安 710049
2 中国电子科技集团 第十三研究所,河北 石家庄 050051
提出了一种基于片上集成电容工艺和带阻滤波结构的高功率三倍频器设计方法。在倍频器输入端,首先对倍频器二极管的直流偏置馈电部分进行改进,在梁式引线结构基础上结合二氧化硅(SiO2)工艺实现了片上集成电容,同时解决了三倍频器的直流馈电和射频接地问题,实现电路功能集成的同时也提高了模型仿真精度。此外,在二极管的输入端采用带阻滤波器结构替代传统的低通滤波结构,在保证倍频器性能的同时进一步简化倍频器结构复杂度和尺寸。为进行验证,设计并加工测试了两款中心频率分别为110 GHz和220 GHz的双路功率合成三倍频器。实际测试结果表明,在输入功率500 mW条件下,110 GHz三倍频器的输出峰值功率达到了140 mW,峰值效率接近30%,带宽超过15 GHz;在输入功率300 mW条件下,220 GHz三倍频器的输出峰值功率达到了45 mW,峰值效率达到15%,带宽为15 GHz。两款倍频的测试结果均有优秀表现,验证了设计方法的有效性。
倍频器 片上集成电容 带阻滤波器 波导匹配网络 tripler on-chip integrated capacitors bandstop filter waveguide matching network 
Author Affiliations
Abstract
National Key Laboratory of ASIC, Hebei Semiconductor Research Institute, Shijiazhuang 050051, China
Ultraviolet (UV) detectors with large photosensitive areas are more advantageous in low-level UV detection applications. In this Letter, high-performance 4H-SiC p-i-n avalanche photodiodes (APDs) with large active area (800 μm diameter) are reported. With the optimized epitaxial structure and device fabrication process, a high multiplication gain of 1.4 × 106 is obtained for the devices at room temperature, and the dark current is as low as ~10 pA at low reverse voltages. In addition, record external quantum efficiency of 85.5% at 274 nm is achieved, which is the highest value for the reported SiC APDs. Furthermore, the rejection ratio of UV to visible light reaches about 104. The excellent performance of our devices indicates a tremendous improvement for large-area SiC APD-based UV detectors. Finally, the UV imaging performance of our fabricated 4H-SiC p-i-n APDs is also demonstrated for system-level applications.
040.1345 Avalanche photodiodes (APDs) 040.7190 Ultraviolet 040.6070 Solid state detectors 230.5160 Photodetectors Chinese Optics Letters
2019, 17(9): 090401
1 中国电子科技集团公司第十三研究所,河北 石家庄 050051
2 专用集成电路重点实验室,河北 石家庄 050051
基于反向串联型砷化镓平面肖特基容性二极管,采用平衡式二倍频结构,研制出了一种190 GHz大功率输出二倍频器。使用三维电磁场与非线性谐波平衡联合的方法进行了仿真,并根据仿真结果完成了倍频器的加工、装配和测试。倍频器在182~196 GHz输出频率范围内的倍频效率可达8%以上;当输出频率为187 GHz时,倍频效率和输出功率可分别达到15.4%和85 mW。
太赫兹 二倍频 肖特基二极管 大功率
Author Affiliations
Abstract
National Key Laboratory of ASIC, Hebei Semiconductor Research Institute, Shijiazhuang 050051, China
In this Letter, we report large-area (600 μm diameter) 4H-SiC avalanche photodiodes (APDs) with high gain and low dark current for visible-blind ultraviolet detection. Based on the separate absorption and multiplication structure, 4H-SiC APDs passivated with SiNx instead of SiO2 are demonstrated for the first time, to the best of our knowledge. Benefitting from the SiNx passivation, the surface leakage current is effectively suppressed. At room temperature, high multiplication gain of 6.5×105 and low dark current density of 0.88 μA/cm2 at the gain of 1000 are achieved for our devices, which are comparable to the previously reported small-area SiC APDs.
040.1345 Avalanche photodiodes (APDs) 040.7190 Ultraviolet 040.6070 Solid state detectors Chinese Optics Letters
2018, 16(6): 060401
1 信息显示与可视化国际合作联合实验室,电子科学与工程学院,东南大学,江苏 南京 210096
2 河北半导体研究所,河北 石家庄 050051
3 专用集成电路国家级重点实验室,河北 石家庄 050051
采用再生长n+ GaN非合金欧姆接触工艺研制了具有高电流增益截止频率(fT)的InAlN/GaN异质结场效应晶体管 (HFETs),器件尺寸得到有效缩小,源漏间距减小至600 nm.通过优化干法刻蚀和n+ GaN外延工艺,欧姆接触总电阻值达到0.16 Ω·mm,该值为目前金属有机化学气相沉积(MOCVD)方法制备的最低值.采用自对准电子束曝光工艺实现34 nm直栅.器件尺寸的缩小以及欧姆接触的改善,器件电学特性,尤其是射频特性得到大幅提升.器件的开态电阻(Ron)仅为0.41 Ω·mm,栅压1 V下,漏源饱和电流达到2.14 A/mm.此外,器件的电流增益截止频率(fT)达到350 GHz,该值为目前GaN基HFET器件国内报道最高值.
铟铝氮氮化镓异质结 异质结场效应晶体管 电流增益截止频率 非合金欧姆接触工艺 纳米栅 InAlN/GaN HFET current gain cut-off frequency nonalloyed Ohmic contacts nano-gate
河北半导体研究所 专用集成电路国家级重点实验室, 河北 石家庄 050051
在蓝宝石衬底上研制了具有高电流增益截止频率(fT)的InAlN/GaN异质结场效应晶体管 (HFETs).基于MOCVD外延n+-GaN欧姆接触工艺实现了器件尺寸的缩小, 有效源漏间距(Lsd)缩小至600 nm.此外, 采用自对准工艺制备了50 nm直栅.由于器件尺寸的缩小, Vgs= 1 V下器件最大饱和电流(Ids)达到2.11 A/mm, 峰值跨导达到609 mS/mm.根据小信号测试结果, 外推得到器件的fT和最大振荡频率(fmax)分别为220 GHz和48 GHz.据我们所知, 该fT值是目前国内InAlN/GaN HFETs器件报道的最高结果.
再生长n+-GaN欧姆接触 InAlN/GaN InAlN/GaN HFET HFET fT fT regrown n+-GaN ohmic contacts
河北半导体研究所 专用集成电路国家级重点实验室, 河北 石家庄 050051
基于蓝宝石衬底InAlN/GaN异质结材料研制具有高电流增益截止频率(fT)和最大振荡频率(fmax)的InAlN/GaN异质结场效应晶体管 (HFETs).基于再生长n+ GaN欧姆接触工艺实现了器件尺寸的缩小, 有效源漏间距(Lsd)缩小至600 nm.此外, 采用自对准栅工艺制备60 nm T型栅.由于器件尺寸的缩小, 在Vgs= 1 V时, 器件最大饱和电流(Ids)达到1.89 A/mm, 峰值跨导达到462 mS/mm.根据小信号测试结果, 外推得到器件的fT和fmax分别为170 GHz和210 GHz, 该频率特性为国内InAlN/GaN HFETs器件频率的最高值.
异质结场效应晶体管(HFETs) 电流增益截止频率(fT) 最大振荡频率(fmax) InAlN/GaN InAlN/GaN heterostructure field-effect transistors(HFET) unity current gain cut-off frequency(fT) maximum oscillation frequency(fmax)
河北半导体研究所 专用集成电路国家级重点实验室, 河北 石家庄 050051
基于SiC衬底AlGaN/GaN异质结材料研制具有高电流增益截止频率(fT)和最大振荡频率(fmax)的AlGaN/GaN异质结场效应晶体管(HFETs).基于MOCVD外延n+ GaN 欧姆接触工艺实现了器件尺寸的缩小, 有效源漏间距(Lsd)缩小至600 nm.此外, 采用自对准工艺制备了60 nm T型栅.由于器件尺寸的缩小, 在Vgs=2 V下, 器件最大饱和电流(Ids)达到2.0 A/mm, 该值为AlGaN/GaN HFETs器件直流测试下的最高值, 器件峰值跨导达到608 mS/mm.小信号测试表明, 器件fT和fmax最高值分别达到152 GHz和219 GHz.
异质结场效应晶体管 电流增益截止频率 最大振荡频率 再生长欧姆接触 AlGaN/GaN AlGaN/GaN HFET fT fmax regrown Ohmic contacts





