基于白光干涉频域分析的高精度表面形貌测量  下载: 992次
下载: 992次
1 引言
干涉测量具有非接触性、高效率、高精度等优点,被广泛应用于光学元件面型测量[1]、微弱目标探测[2]、微小位移测量[3]等领域。传统的相移干涉算法[4-6]虽然能够达到亚纳米级精度,但其有效测量范围不能超过波长的1/4,因此应用领域受限。相比较而言,白光干涉测量由于其相干长度较短,测量范围通常可以达到数百微米。将白光干涉与相移算法相结合可以同时满足大量程和高精度的测量需求,是一种非常有应用前景的微纳结构检测手段[7-12]。
目前,白光干涉形貌测量算法主要分为两大类:基于干涉光强信号分析的时域调制度算法[13-16]和基于频谱相位分析的空间频域算法[17-20]。其中,时域调制度算法是通过提取干涉信号的包络曲线来寻找光强极大值点(即零光程差点),进而确定零级干涉条纹位置并进行表面形貌恢复。然而,光强调制度的计算面临许多挑战,如计算量大、易受背景噪声干扰以及对采样间距要求较高等,这些都会对测量效率以及精度造成不良影响。空间频域算法由de Groot等[21]提出并成功应用于白光干涉测量。该方法通过分析干涉信号的频谱相位信息来恢复被测结构的表面形貌。与时域调制度算法相比,空间频域算法不仅计算效率高,而且只需要合适的采样即可获得可靠的频谱成分,同时对背景噪声也有一定的抑制作用。在实际空间频域分析中,利用离散傅里叶变换提取到的实际相位只能介于±π范围内,其与理论相位之间必然会存在整数级次的2π误差,也就是所谓的2π相位模糊问题[22-24]。此外,由于背景噪声、光源扰动以及其他外界干扰因素的影响,在消除2π模糊的过程中还可能会引入局部2π相位突变,这些都会对最终测量结果产生不利影响。王军等[25]曾采用白光干涉空间频域算法对压电陶瓷的微小位移进行了高精度测量。谢元安等[26]也曾利用空间频域分析来消除中心波长相位中的2π模糊,从而实现零光程差的精准定位。虽然上述方法最终都实现了准确测量,但是只适用于一些相对比较理想的采样情况,并未考虑外界干扰或者背景噪声可能引起的局部2π相位突变。de Groot等[27]虽然提出了频域相位差分析的方法来解决2π模糊问题,但是该方法涉及复杂的拟合计算,并且也未考虑背景噪声可能引起的局部相位突变。
为了实现高效、稳定的2π模糊消除,本文提出了一种基于空间频域分析的白光干涉测量算法,通过相干信息与相位信息相结合的方式来消除相位信息中的2π模糊。同时,针对测量过程中出现的局部相位突变现象,提出了相邻像素点差分分析方法,通过分析正常像素点与异常点之间的相位变化,消除由背景噪声及其他外界干扰因素造成的局部相位突变。分别从理论仿真和实验两方面进行分析,以验证所提方法的有效性和稳定性。
2 基本原理
2.1 频域分析
在白光干涉测量中,CCD采集到的光强信号通常包含背景光强与干涉光强两部分,可以表示为
式中:
式中:
式中参数
根据(2)式,可以通过两种方式来评估被测物体的表面形貌。一种是微分法,表示为
式中
式中:
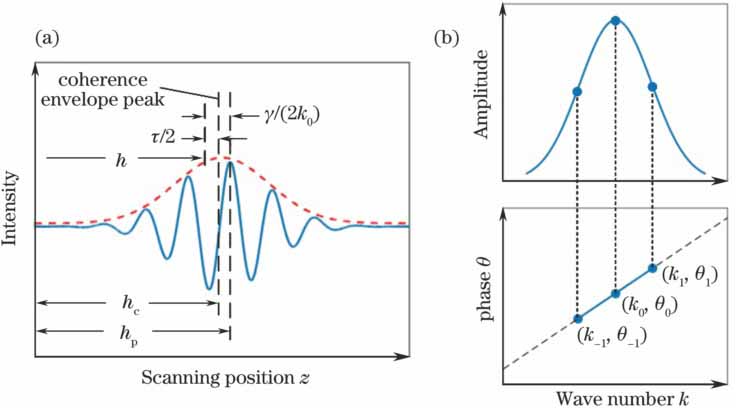
图 1. (a)白光干涉时域光强以及各参数示意;(b)频域空间中相位与波数之间的线性关系
Fig. 1. (a) Time-domain intensity of white-light interference pattern and the meaning of the parameters; (b) linear relationship between the phase and the wave number in frequency domain

图 2. 仿真结果。(a)待测样品形貌;(b)含有误差τ的相干形貌;(c)含有局部2π相位突变的相位形貌;(d)不含2π模糊的最终形貌
Fig. 2. Simulation results. (a) Surface profile of the sample to be measured; (b) coherence surface profile with error τ; (c) phase surface profile with local 2π phase jump; (d) final surface profile without any 2π ambiguity
位
考虑到相干形貌
式中函数Round表示对计算结果取整。由于参数
则可正确计算得到
2.2 仿真分析
为了验证上述方法的有效性,在高斯噪声环境下进行相关仿真测试,结果如
为了解决这一问题,本文提出了相邻像素点差分分析方法。以单行元素为例,首先提取相邻像素点的高度差值并确定相邻像素点之间的2π相位突变,依据的公式为
式中:
式中:
接下来只要消除由反射引起的相位偏移
此处采用平均反射相位

图 3. 局部2π相位突变消除。(a)带有2π突变的截面轮廓;(b)相邻像素点间的2π跳变级数;(c)消除局部相位突变后的最终轮廓
Fig. 3. Elimination of local 2π phase jump. (a) Cross-sectional profile with 2π phase jump; (b) 2π phase-jump order between adjacent pixels; (c) final profile after removing local phase jump
3 实验结果
(10)式消除局部相位突变后得到的最终形貌,可以看出,测量结果已经不受2π模糊的影响,而且精度也有了极大提升。在
4 分析与讨论
为了评估表面形貌测试结果,首先提取微球面结构的截面曲线,如
式中

图 5. 微球面结构表面形貌测量结果。(a)相干形貌;(b)带有局部2π相位突变的相位形貌;(c)不含相位模糊的最终形貌
Fig. 5. Surface profile measurement results of micro-spherical structure. (a) Coherence surface profile; (b) phase surface profile with local 2π phase jump; (c) final surface profile without phase ambiguity

图 6. 光栅结构表面形貌测量结果。(a)相干形貌;(b)带有局部2π相位突变的相位形貌;(c)不含相位模糊的最终形貌
Fig. 6. Surface profile measurement results of grating structure. (a) Coherence surface profile; (b) phase surface profile with local 2π phase jump; (c) final surface profile without phase ambiguity

图 7. 微球面结构的截面图。(a)相干形貌截面图及其残差曲线;(b)消除2π模糊后的相位形貌截面图及其残差曲线
Fig. 7. Cross-sectional profile of micro-spherical structure. (a) Cross-sectional profile of the coherence surface and the residual curve; (b) cross-sectional profile of the phase surface and the residual curve after removing 2π phase ambiguity

图 8. 光栅结构截面图。(a)白光干涉测量结果;(b)台阶仪测量结果(1 ?=0.1 nm)
Fig. 8. Cross-sectional profile of grating structure. (a) Measurement result by white light interferometry; (b) step height measured by the stylus profiler (1 ?=0.1 nm)
干信息所得的表面形貌相比,利用相位信息确实能够获得更高的测量精度,尤其是在台阶边缘处,相位信息能够提供更加清晰准确的边缘形貌特征。
5 结论
提出了一种高效、稳定的白光干涉空间频域分析算法,通过相干信息与相位信息相结合的方式,成功消除了相位信息中普遍存在的2π相位模糊,并实现了表面形貌的高精度测量。此外,针对形貌恢复过程中出现的局部2π相位突变现象,提出了相邻像素点差分分析方法,有效抑制了由背景噪声、外界干扰以及复杂表面反射引起的局部相位突变,提升了算法的稳定性和有效性。根据实验结果,通过中心波数相位信息恢复的形貌其均方根粗糙度不超过2 nm。后续工作将分析表面反射现象对测量精度的影响,从而进一步提升测量精度。
[1] 师途, 臧仲明, 刘东, 等. 光学非球面面形非零位检测的回程误差校正[J]. 光学学报, 2016, 36(8): 0812006.
师途, 臧仲明, 刘东, 等. 光学非球面面形非零位检测的回程误差校正[J]. 光学学报, 2016, 36(8): 0812006.
[2] 董磊, 王斌, 刘欣悦. 基于光学相干和微弱信号检测的干涉探测技术[J]. 光学学报, 2017, 37(2): 0212001.
董磊, 王斌, 刘欣悦. 基于光学相干和微弱信号检测的干涉探测技术[J]. 光学学报, 2017, 37(2): 0212001.
[3] 高金磊, 宗明成. 一种对称式双光栅干涉位移测量系统的研制[J]. 中国激光, 2016, 43(9): 0904003.
高金磊, 宗明成. 一种对称式双光栅干涉位移测量系统的研制[J]. 中国激光, 2016, 43(9): 0904003.
[6] Villalobos-Mendoza B. Granados-Agustín F S, Aguirre-Aguirre D, et al. Phase shifting interferometry using a spatial light modulator to measure optical thin films[J]. Applied Optics, 2015, 54(26): 7997-8003.
Villalobos-Mendoza B. Granados-Agustín F S, Aguirre-Aguirre D, et al. Phase shifting interferometry using a spatial light modulator to measure optical thin films[J]. Applied Optics, 2015, 54(26): 7997-8003.
[7] LehmannP. Systematic effects in coherence peak and phase evaluation of signals obtained with a vertical scanning white-light Mirau interferometer[C]. SPIE, 2006, 6188: 618811.
LehmannP. Systematic effects in coherence peak and phase evaluation of signals obtained with a vertical scanning white-light Mirau interferometer[C]. SPIE, 2006, 6188: 618811.
[11] 张红霞, 张以谟, 井文才, 等. 检测微表面形貌的Mirau相移干涉轮廓仪[J]. 天津大学学报(自然科学与工程技术版), 2005, 38(5): 377-380.
张红霞, 张以谟, 井文才, 等. 检测微表面形貌的Mirau相移干涉轮廓仪[J]. 天津大学学报(自然科学与工程技术版), 2005, 38(5): 377-380.
Zhang H X, Zhang Y M, Jing W C, et al. Mirau phase-shifting interferometer for microsurface topography measurement[J]. Journal of Tianjin University (Science and Technology), 2005, 38(5): 377-380.
[13] Harasaki A, Schmit J, Wyant J C. Improved vertical-scanning interferometry[J]. Applied Optics, 2000, 39(13): 2107-2115.
Harasaki A, Schmit J, Wyant J C. Improved vertical-scanning interferometry[J]. Applied Optics, 2000, 39(13): 2107-2115.
[14] 李其德, 卢荣胜. 白光扫描干涉测量算法[J]. 中国仪器仪表, 2008( 4): 78- 81.
李其德, 卢荣胜. 白光扫描干涉测量算法[J]. 中国仪器仪表, 2008( 4): 78- 81.
Li QD, Lu RS. The algorithms for white-light scanning interferometry[J]. China Instrumentation, 2008( 4): 78- 81.
Li QD, Lu RS. The algorithms for white-light scanning interferometry[J]. China Instrumentation, 2008( 4): 78- 81.
[25] 王军, 陈磊. 基于空间频域算法的白光干涉微位移测量法[J]. 红外与激光工程, 2008, 37(5): 874-877.
王军, 陈磊. 基于空间频域算法的白光干涉微位移测量法[J]. 红外与激光工程, 2008, 37(5): 874-877.
Wang J, Chen L. Measurement of micro-displacement using white-light interference based on a spatial frequency domain algorithm[J]. Infrared and Laser Engineering, 2008, 37(5): 874-877.
[26] 谢元安, 韩志刚. 基于白光干涉的空间频域算法研究[J]. 光电工程, 2011, 38(7): 81-85.
邓钦元, 唐燕, 周毅, 杨勇, 胡松. 基于白光干涉频域分析的高精度表面形貌测量[J]. 中国激光, 2018, 45(6): 0604001. Qinyuan Deng, Yan Tang, Yi Zhou, Yong Yang, Song Hu. High-Resolution Surface Topography Measurement Based on Frequency-Domain Analysis in White Light Interferometry[J]. Chinese Journal of Lasers, 2018, 45(6): 0604001.







