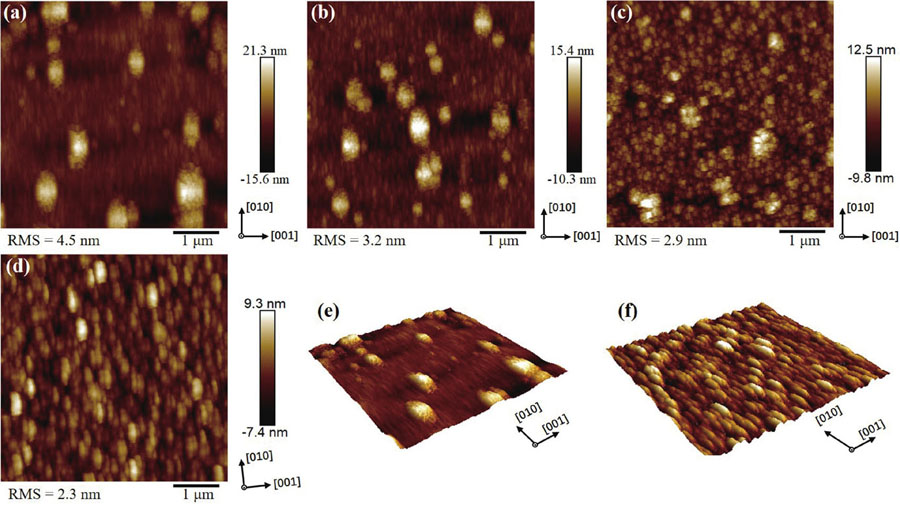
Author Affiliations
Abstract
1 School of Nano-Tech and Nano-Bionics, University of Science and Technology of China, Hefei 230026, China
2 Nanofabrication facility, Suzhou Institute of Nano-Tech and Nano-Bionics, Chinese Academy of Sciences, Suzhou 215123, China
3 Research Center of Laser Crystal, Shanghai Institute of Optics and Fine Mechanics, Chinese Academy of Sciences, Shanghai 201800, China
4 Hangzhou Institute of Optics and Fine Mechanics, Hangzhou 311421, China
Homoepitaxial growth of Si-doped β-Ga2O3 films on semi-insulating (100) β-Ga2O3 substrates by metalorganic chemical vapor deposition (MOCVD) is studied in this work. By appropriately optimizing the growth conditions, an increasing diffusion length of Ga adatoms is realized, suppressing 3D island growth patterns prevalent in (100) β-Ga2O3 films and optimizing the surface morphology with [010] oriented stripe features. The slightly Si-doped β-Ga2O3 film shows smooth and flat surface morphology with a root-mean-square roughness of 1.3 nm. Rocking curves of the (400) diffraction peak also demonstrate the high crystal quality of the Si-doped films. According to the capacitance–voltage characteristics, the effective net doping concentrations of the films are 5.41 × 1015 – 1.74 × 1020 cm−3. Hall measurements demonstrate a high electron mobility value of 51 cm2/(V·s), corresponding to a carrier concentration of 7.19 × 1018 cm−3 and a high activation efficiency of up to 61.5%. Transmission line model (TLM) measurement shows excellent Ohmic contacts and a low specific contact resistance of 1.29 × 10-4 Ω·cm2 for the Si-doped film, which is comparable to the Si-implanted film with a concentration of 5.0 × 1019 cm−3, confirming the effective Si doing in the MOCVD epitaxy.
homoepitaxial growth MOCVD Si-doping films high activation efficiency Ohmic contacts Journal of Semiconductors
2023, 44(6): 062801
实现电学性能优良的高Al组分AlGaN外延层是制备深紫外光电器件最重要的环节之一。本工作利用分子束外延(MBE)技术, 基于周期热脱附的生长方式, 通过改变Al源供应量调控Al组分, 并用Si进行n型掺杂, 在AlN/蓝宝石衬底上得到了系列高Al组分的Si-AlxGa1-xN外延层(x>0.60)。对外延层相关物理性质进行了表征测试, 结果表明, 外延层Al组分与生长过程中Al束流大小呈现线性关系, 这为制备精确Al组分的AlGaN外延层奠定了基础。AFM结果表明, 高Al组分AlGaN外延层的表面形貌强烈依赖于Ga的供应量, 在生长过程中提高Ga束流可以显著降低外延层的粗糙度。基于范德堡法测量Si-AlGaN外延层电学性能, 证实其载流子特性良好, 其中 Al组分为0.93的样品室温下自由电子浓度、电子迁移率和电阻率分别达到了8.9×1018 cm-3和3.8 cm2·V-1·s-1和0.18 Ω·cm。
高Al组分AlGaN 分子束外延 Si掺杂 载流子特性 周期热脱附 high Al-content AlGaN molecular beam epitaxy Si doping carrier property periodic thermal desorption
在InGaAs/GaAs表面量子点(SQDs)的GaAs势垒层中引入Si掺杂层,以研究Si掺杂对InGaAs/GaAs SQDs光学特性的影响。荧光发光谱(PL)测量结果显示,InGaAs/GaAs SQDs的发光强烈依赖于Si掺杂浓度。随着掺杂浓度的增加, SQDs的PL峰值位置先红移后蓝移; PL峰值能量与激光激发强度的立方根依赖关系由线性向非线性转变;通过组态交互作用方法发现SQDs的PL峰位蓝移减弱;时间分辨荧光光谱显示了从非线性衰减到线性衰减的转变。以上结果说明Si掺杂能够填充InGaAs SQDs的表面态,并且改变表面费米能级钉扎效应和SQDs的荧光辐射特性。本研究为深入理解与InGaAs SQDs的表面敏感特性关联的物理机制和载流子动力学过程,以及扩大InGaAs/GaAs SQDs传感器的应用提供了实验依据。
InGaAs量子点 Si掺杂 表面费米能级 荧光发光谱 间接跃迁辐射 时间分辨荧光光谱 InGaAs quantum dot Si doping surface Fermi level photoluminescence indirect-transition emission time-resolved photoluminescence
1 长春理工大学 高功率半导体激光国家重点实验室, 吉林 长春 130022
2 长春理工大学 理学院, 吉林 长春 130022
采用分子束外延技术(MBE)在Si(111)衬底上生长了非掺杂和Si掺杂砷化镓(GaAs)纳米线(NWs)。通过扫描电子显微镜(SEM)证实了生长样品的一维性; 通过X射线衍射(XRD)测试和拉曼光谱(Raman)证实了掺杂GaAs纳米线中Si的存在; 通过光致发光(PL)研究了非掺杂和Si掺杂GaAs纳米线的发光来源, 掺杂改变了GaAs纳米线的辐射复合机制。掺杂导致非掺杂纳米线中自由激子发光峰和纤锌矿/闪锌矿(WZ/ZB)混相结构引起的缺陷发光峰消失。
光谱学 GaAs纳米线 Si掺杂 光致发光 分子束外延 spectroscopy GaAs nanowires Si doping photoluminescence MBE
1 华南理工大学 发光材料与器件国家重点实验室, 广州 510640
2 江门奥伦德光电有限公司,广东 江门 529000
InGaN系绿光LED的量子阱结构具有较高的In含量, InN与GaN之间较大的晶格失配度使得绿光器件的量子限制Stark效应更显著。对内建电场的屏蔽可以有效提高载流子的辐射复合效率。论文探讨了绿光多量子阱中垒层的Si掺杂对绿光器件性能的影响。研究发现, 多量子阱中垒层适度Si掺杂(3.4×1016cm-3)可以改善多量子阱结构界面质量和In组分波动, 在外加正向电流的作用下更大程度地屏蔽极化电场; 同时, 还能够增强电流的横向扩展性, 提高活化区的有效发光面积。然而, 多量子阱中垒层的过度Si掺杂对于绿光LED器件的性能带来诸多的负面影响, 比如加剧阱垒晶格失配、漏电途径明显增加等, 致使器件光效大幅度降低。
绿光LED 多量子阱 Si掺杂 量子限制Stark效应 green LEDs InGaN InGaN MQWs Si-doping QCSE
曲阜师范大学 物理工程学院, 山东 曲阜273165
基于密度泛函理论第一性原理的平面波超软赝势法,研究了Si掺杂纤锌矿AlN的电子结构和光吸收性质。结果表明:杂质能级位于导带底附近,与Al 3p能级复合形成导带底,使系统发生Mott相变;Si掺杂后在2.02 eV附近出现新的吸收峰,从而改善系统在可见光区的吸收特性。
Si掺杂 电子结构 光吸收 AlN AlN Si doping electronic structure optical absorption
中国工程物理研究院,激光聚变研究中心,四川,绵阳,621900
靶丸内表面掺杂诊断元素可以为内爆压缩界面的研究提供必要的手段.以二甲基二乙氧基硅烷为原料,利用乳液微封装技术和界面聚合技术可以实现单一内表面掺硅的空心聚苯乙烯微球的制备.X光照相和X能谱分析表明:内表面掺硅量比外表面高出2~3个数量级.均匀内表面掺硅层的厚度小于0.3μm,掺杂层厚度越小,均匀性越好.
掺硅 聚苯乙烯 空心微球 Si-doping Polystyrene Capsule





