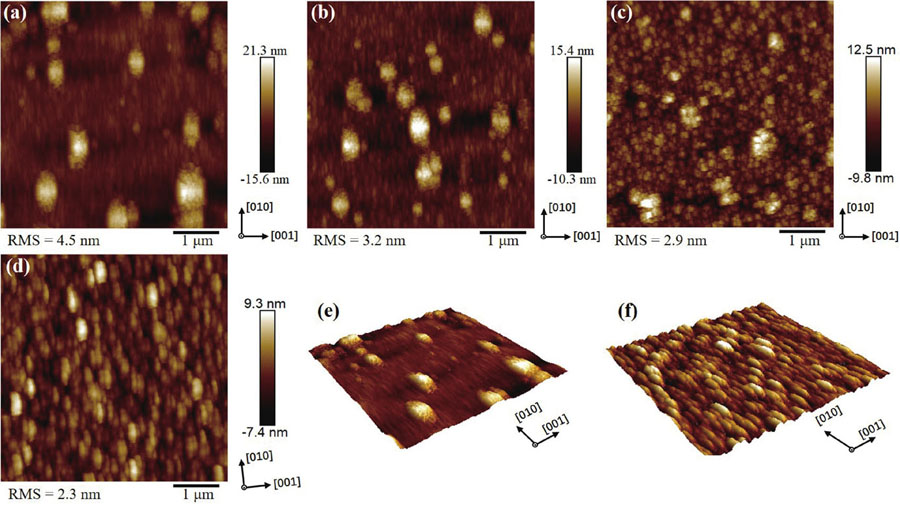
Author Affiliations
Abstract
1 School of Nano-Tech and Nano-Bionics, University of Science and Technology of China, Hefei 230026, China
2 Nanofabrication facility, Suzhou Institute of Nano-Tech and Nano-Bionics, Chinese Academy of Sciences, Suzhou 215123, China
3 Research Center of Laser Crystal, Shanghai Institute of Optics and Fine Mechanics, Chinese Academy of Sciences, Shanghai 201800, China
4 Hangzhou Institute of Optics and Fine Mechanics, Hangzhou 311421, China
Homoepitaxial growth of Si-doped β-Ga2O3 films on semi-insulating (100) β-Ga2O3 substrates by metalorganic chemical vapor deposition (MOCVD) is studied in this work. By appropriately optimizing the growth conditions, an increasing diffusion length of Ga adatoms is realized, suppressing 3D island growth patterns prevalent in (100) β-Ga2O3 films and optimizing the surface morphology with [010] oriented stripe features. The slightly Si-doped β-Ga2O3 film shows smooth and flat surface morphology with a root-mean-square roughness of 1.3 nm. Rocking curves of the (400) diffraction peak also demonstrate the high crystal quality of the Si-doped films. According to the capacitance–voltage characteristics, the effective net doping concentrations of the films are 5.41 × 1015 – 1.74 × 1020 cm−3. Hall measurements demonstrate a high electron mobility value of 51 cm2/(V·s), corresponding to a carrier concentration of 7.19 × 1018 cm−3 and a high activation efficiency of up to 61.5%. Transmission line model (TLM) measurement shows excellent Ohmic contacts and a low specific contact resistance of 1.29 × 10-4 Ω·cm2 for the Si-doped film, which is comparable to the Si-implanted film with a concentration of 5.0 × 1019 cm−3, confirming the effective Si doing in the MOCVD epitaxy.
homoepitaxial growth MOCVD Si-doping films high activation efficiency Ohmic contacts Journal of Semiconductors
2023, 44(6): 062801
1 西安电子科技大学 宽带隙半导体技术国家重点学科实验室, 陕西 西安 710071
2 中国科学院半导体研究所, 超晶格国家重点实验室, 北京 100083
为了得到较低的接触电阻, 研究了帽层未掺杂的InAs/AlSb 异质结的Pd/Ti/Pt/Au合金化欧姆接触.利用传输线模型(TLM)测量了接触电阻Rc.在最佳的快速热退火条件为275 °C和20 s时, InAs/AlSb 异质结的Pd/Ti/Pt/Au接触电阻值为0.128 Ω·mm.TEM观察发现经过快速热退火后Pd已经扩散到半导体中有利于高质量欧姆接触的形成.研究表明经过Pd/Ti/Pt/Au 合金化欧姆接触后Rc有明显减小, 适用于InAs / AlSb 异质结的应用.
欧姆接触 快速热退火 InAs/AlSb异质结 Ohmic contacts rapid thermal annealing InAs/AlSb heterostructures
1 信息显示与可视化国际合作联合实验室,电子科学与工程学院,东南大学,江苏 南京 210096
2 河北半导体研究所,河北 石家庄 050051
3 专用集成电路国家级重点实验室,河北 石家庄 050051
采用再生长n+ GaN非合金欧姆接触工艺研制了具有高电流增益截止频率(fT)的InAlN/GaN异质结场效应晶体管 (HFETs),器件尺寸得到有效缩小,源漏间距减小至600 nm.通过优化干法刻蚀和n+ GaN外延工艺,欧姆接触总电阻值达到0.16 Ω·mm,该值为目前金属有机化学气相沉积(MOCVD)方法制备的最低值.采用自对准电子束曝光工艺实现34 nm直栅.器件尺寸的缩小以及欧姆接触的改善,器件电学特性,尤其是射频特性得到大幅提升.器件的开态电阻(Ron)仅为0.41 Ω·mm,栅压1 V下,漏源饱和电流达到2.14 A/mm.此外,器件的电流增益截止频率(fT)达到350 GHz,该值为目前GaN基HFET器件国内报道最高值.
铟铝氮氮化镓异质结 异质结场效应晶体管 电流增益截止频率 非合金欧姆接触工艺 纳米栅 InAlN/GaN HFET current gain cut-off frequency nonalloyed Ohmic contacts nano-gate
河北半导体研究所 专用集成电路国家级重点实验室, 河北 石家庄 050051
在蓝宝石衬底上研制了具有高电流增益截止频率(fT)的InAlN/GaN异质结场效应晶体管 (HFETs).基于MOCVD外延n+-GaN欧姆接触工艺实现了器件尺寸的缩小, 有效源漏间距(Lsd)缩小至600 nm.此外, 采用自对准工艺制备了50 nm直栅.由于器件尺寸的缩小, Vgs= 1 V下器件最大饱和电流(Ids)达到2.11 A/mm, 峰值跨导达到609 mS/mm.根据小信号测试结果, 外推得到器件的fT和最大振荡频率(fmax)分别为220 GHz和48 GHz.据我们所知, 该fT值是目前国内InAlN/GaN HFETs器件报道的最高结果.
再生长n+-GaN欧姆接触 InAlN/GaN InAlN/GaN HFET HFET fT fT regrown n+-GaN ohmic contacts
河北半导体研究所 专用集成电路国家级重点实验室, 河北 石家庄 050051
基于SiC衬底AlGaN/GaN异质结材料研制具有高电流增益截止频率(fT)和最大振荡频率(fmax)的AlGaN/GaN异质结场效应晶体管(HFETs).基于MOCVD外延n+ GaN 欧姆接触工艺实现了器件尺寸的缩小, 有效源漏间距(Lsd)缩小至600 nm.此外, 采用自对准工艺制备了60 nm T型栅.由于器件尺寸的缩小, 在Vgs=2 V下, 器件最大饱和电流(Ids)达到2.0 A/mm, 该值为AlGaN/GaN HFETs器件直流测试下的最高值, 器件峰值跨导达到608 mS/mm.小信号测试表明, 器件fT和fmax最高值分别达到152 GHz和219 GHz.
异质结场效应晶体管 电流增益截止频率 最大振荡频率 再生长欧姆接触 AlGaN/GaN AlGaN/GaN HFET fT fmax regrown Ohmic contacts
1 石家庄学院 物理与电气信息工程学院, 石家庄 050000
2 河北工业大学 电子信息工程学院, 天津 300130
利用金属有机化合物化学气相淀积(MOCVD)在SiC衬底上外延生长了N-polar GaN材料, 采用传输线模型(TLM)分析了Ti/Al/Ni/Au金属体系在N-polar GaN上的欧姆接触特性。结果表明, Ti/Al/Ni/Au(20/60/10/50nm)在N-polar GaN上可形成比接触电阻率为2.2×10-3Ω·cm2的非合金欧姆接触, 当退火温度升至200℃, 比接触电阻率降为1.44×10-3Ω·cm2, 随着退火温度的进一步上升, Ga原子外逸导致欧姆接触退化为肖特基接触。
欧姆接触 氮极性 氮化镓 Ohmic contacts Ti/Al/Ni/Au Ti/Al/Ni/Au N-polar GaN
研究了AZO(ZnO∶Al)替代ITO透明导电膜在GaN基LED中的应用,通过脉冲激光沉积和磁控溅射法制作了AZO薄膜,分析了AZO与p型GaN不良的欧姆接触的物理机理,并利用插入ITO薄层来改善接触电阻,实验用ITO 20nm/AZO 500nm的复合导电薄膜做透明导电薄膜,成功得到了波长为525.74nm、亮度为380.88mcd、电压为3.35V的GaN基绿光LED芯片,相当于单一ITO透明导电膜的性能,整个试验工艺中减少了ITO的使用量,降低了LED芯片的制造成本。
AZO薄膜 透明导电薄膜 脉冲激光沉积 欧姆接触 AZO film GaN LED GaN LED transparent conductive layer pulsed laser deposition ohmic contacts
清华大学 电子工程系,清华信息科学与技术国家实验室(筹),北京100084
研究了溶液表面处理对AlGaN欧姆接触的影响及机理。用氟硝酸(HNO3+HF)、稀盐酸(HCl)和硫代乙酰胺(CS3CSNH2)溶液处理AlGaN表面后,Ti/Al/Ti/Au电极的比接触电阻率有显著的降低。样品表面Ga3d与O1s的X射线光电子能谱(XPS)测试结果显示:氧元素含量明显降低,表明这三种溶液可以有效地去除AlGaN表面氧化层,其中CS3CSNH2效果最佳;Ga3d峰位在表面处理后发生蓝移现象,相当于AlGaN表面处的费米能级向导带一侧移动,使电子在隧穿过程中的有效势垒高度降低。以上两个因素均对优化AlGaN/GaN欧姆接触有十分重要的意义。
AlGaN/GaN异质结 表面处理 欧姆接触 XPS能谱 AlGaN/GaN heterostructure surface treatment ohmic contacts XPS spectra
中国科学院上海技术物理所传感技术国家重点实验室, 上海 200083
台面铟镓砷(InGaAs)探测器制备工艺包括n型InP欧姆接触和较好可靠性的延伸电极。采用Cr/Au作为n型InP欧姆接触, 通过传输线模型和俄歇电子谱(AES)研究了Cr/Au与n型InP在不同退火条件下的欧姆接触和界面结构, 实验表明Cr/Au在未退火条件下与n型InP形成较好欧姆接触, 退火条件的引入导致Cr/Au与n型InP欧姆接触恶化, 其原因是离子束溅射沉积的Cr中含有的Cr2O3在退火过程中O扩散进入Au层。采用未退火的Cr/Au作为n型InP欧姆接触和延伸电极实现了台面InGaAs探测器制造工艺的简化。
遥感 台面InGaAs探测器 欧姆接触 俄歇电子谱
华南师范大学光电子材料与技术研究所,广东 广州 510631
在LED电极欧姆接触中,载流子在金属电极和半导体间有不同的传输机制。通过载流子在金属半导体界面传输机制的模拟,讨论了界面介质层及其势垒对器件串联电阻和漏电流的影响,发现介质层电阻比LED的串联电阻小得多,可以忽略不计;但是随着器件的老化,介质层及其所含的缺陷会产生相当大的漏电流,使器件的可靠性和稳定性下降,也为LED的失效机理提供了理论依据。
光电子学 发光二极管 介质层 欧姆接触 漏电流 optoelectronics light emitting diodes interfacial layer Ohmic contacts leakage current





